

具复合栅极和阶梯结构的新型GaN垂直晶体管研究
描述
GaN因其特性,作为高性能功率半导体 材料而备受关注,近年来其开发和市场导入不断加速。垂直型GaN功率器件比水平型更适合高电压和大电流,这使得垂直GaN能够为最苛刻的应用提供动力,但也存在成本等问题。
近日,第九届国际第三代半导体论坛(IFWS)&第二十届中国国际半导体照明论坛(SSLCHINA)于厦门召开。期间,“氮化镓功率电子器件技术分论坛”上,华南师范大学尹以安研究员做了“具复合栅极和阶梯结构的新型GaN垂直晶体管研究”的主题报,分享了最新研究成果。研究内容涉及复合栅极结构、能带调制技术路线、电场调制技术路线、低导通电阻的技术路线等。
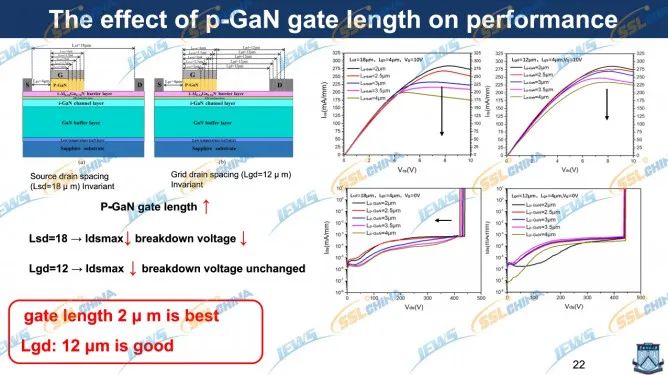
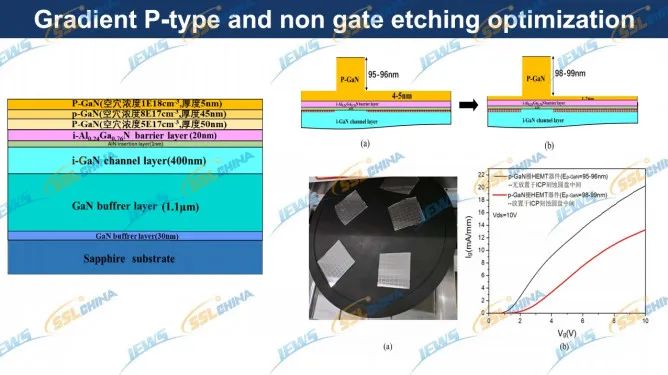
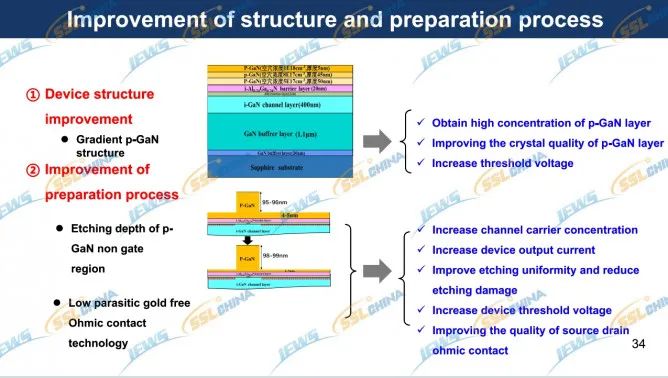
增强型p-GaN栅极HEMT器件研究涉及实验增强型p-GaN栅极HEMT、p-GaN栅极长度对性能的影响、渐变P型和非栅区刻蚀优化、源极-漏极刻蚀深度对器件性能的影响、无金欧姆接触的研制等。垂直HEMT器件的实现研究方面,涉及主流垂直器件基板的选择、EC直接剥离GaN的原理、垂直HEMT器件的实验验证等。
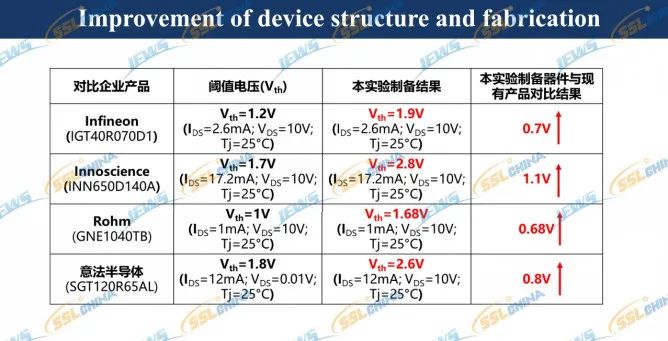
报告指出,结合 Mis结构、p栅极及阶梯式的P型埋层可获得:高Vth:4.14V,高BV:3065V 低RON:1.45mΩ·cm2, FOM :6.56GWcm-2。渐变p-GaN结构++优化非p栅区的蚀刻深度++优化源极-漏极蚀刻深度++最优化p栅极长度++无金欧姆接触:获得Emode,高Vth:2.6V,p栅极长度为2μm。栅极和漏极之间的间距为12μm是最佳的。源极-漏极蚀刻深度为8-10nm。实现垂直HEMT器件的低成本低缺陷:EC直接剥离蓝宝石衬底成为可能。
审核编辑:刘清
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
下一代高速芯片晶体管解制造问题解决了!2025-06-20 864
-
晶体管栅极结构形成2025-03-12 3662
-
GaN晶体管的命名、类型和结构2024-09-12 587
-
GaN晶体管的基本结构和性能优势2024-08-15 4102
-
氮化镓功率晶体管与Si SJMOS和SiC MOS晶体管对分分析哪个好?2023-02-27 14250
-
氮化镓晶体管电路的布局需要考虑哪些因素?2023-02-24 13154
-
用于大功率和频率应用的舍入 GaN 基晶体管2022-06-15 9285
-
电流旁路对GaN晶体管并联配置的影响2021-01-19 2099
-
什么是GaN透明晶体管?2020-11-27 2946
-
直接驱动GaN晶体管的优点2020-10-27 1776
-
IGBT绝缘栅双极晶体管2019-05-06 2184
-
IGBT绝缘栅双极晶体管的基本结构与特点2019-03-27 2465
-
晶体管的分类与特征2018-11-28 2725
-
松下研发出新型MIS结构的Si基GaN功率晶体管2018-03-15 7733
全部0条评论

快来发表一下你的评论吧 !

