

碳化硅功率半导体多芯片封装技术研究
描述
过去几十年里,半导体技术快速发展,芯片特性显著提升。大功率半导体器件是由多颗半导体裸芯片通过封装集成而形成,面临着封装特性提升较慢,无法匹配芯片特性等挑战。
近日,第九届国际第三代半导体论坛(IFWS)&第二十届中国国际半导体照明论坛(SSLCHINA)于厦门召开。期间,“碳化功率器件及其封装技术”分会上,西安交通大学绍兴市通越宽禁带半导体研究院院长王来利教授做了“碳化硅功率半导体多芯片封装技术”的主题报告,分享了最新研究进展。
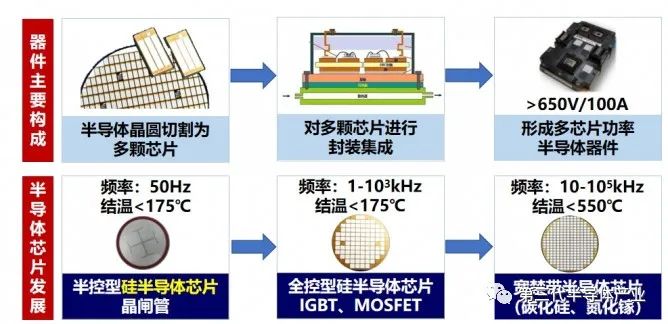

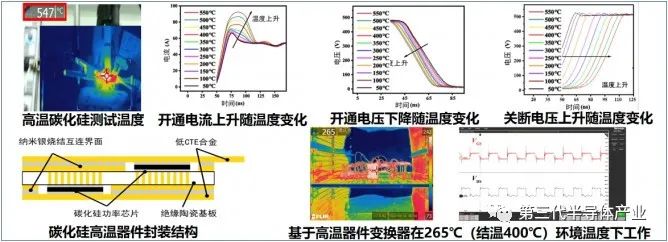
研究提出了磁耦合精确调控多芯片并联电热均衡方法,提出了控制磁场耦合度的多芯片电热应力调控方法,解决了多芯片不均衡性电热应力调控难题,为提高宽禁带器件容量与可靠性建立了基础。
首次获得了碳化硅半导体在550℃高温的动静态特性,掌握了碳化硅极宽温度范围内关键特征参数变化规律,并基于高温器件实现了环境温度265℃的高温变换器。
审核编辑:刘清
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
碳化硅的历史与应用介绍2019-07-02 0
-
碳化硅深层的特性2019-07-04 0
-
碳化硅二极管选型表2019-10-24 0
-
【罗姆BD7682FJ-EVK-402试用体验连载】基于碳化硅功率器件的永磁同步电机先进驱动技术研究2020-04-21 0
-
碳化硅半导体器件有哪些?2020-06-28 0
-
碳化硅基板——三代半导体的领军者2021-01-12 0
-
碳化硅陶瓷线路板,半导体功率器件的好帮手2021-03-25 0
-
被称为第三代半导体材料的碳化硅有着哪些特点2023-02-20 0
-
功率模块中的完整碳化硅性能怎么样?2023-02-20 0
-
归纳碳化硅功率器件封装的关键技术2023-02-22 0
-
应用于新能源汽车的碳化硅半桥MOSFET模块2023-02-27 0
-
浅谈硅IGBT与碳化硅MOSFET驱动的区别2023-02-27 0
-
TO-247封装碳化硅MOSFET引入辅助源极管脚的必要性2023-02-27 0
-
碳化硅功率器件可靠性之芯片研发及封装篇2023-02-28 0
-
上海碳化硅功率器件工程技术研究中心举行揭牌仪式顺利举行2020-10-10 3223
全部0条评论

快来发表一下你的评论吧 !

