

碳化硅功率器件封装的关键技术
电子说
描述
碳化硅(Silicon Carbide,SiC)功率器件因其宽禁带、耐高压、高温、低导通电阻和快速开关等优点备受瞩目。然而,如何充分发挥碳化硅器件的性能却给封装技术带来了新的挑战。传统封装技术在应对碳化硅器件的快速开关特性时面临诸多问题,例如杂散电感参数大、高温工作可靠性差以及多功能集成封装与高功率密度需求等。
1.低杂散电感封装技术
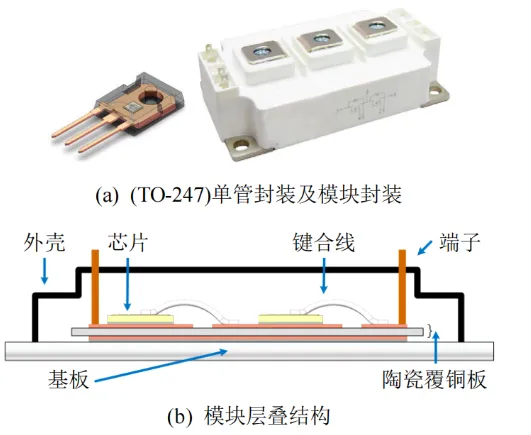
单管翻转贴片封装: 借鉴BGA封装技术,采用单管的翻转贴片封装,通过金属连接件将芯片背部电极翻转到正面电极相同平面位置,从而消除金属键合线,减小体积,提高导通电阻。
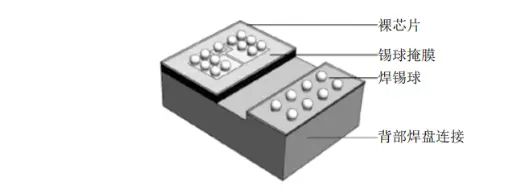
DBC+PCB混合封装: 结合DBC工艺和PCB板,利用金属键合线将芯片上表面连接到PCB板,控制换流回路在PCB层间,减小电流回路面积,有效降低杂散电感参数,提高性能。
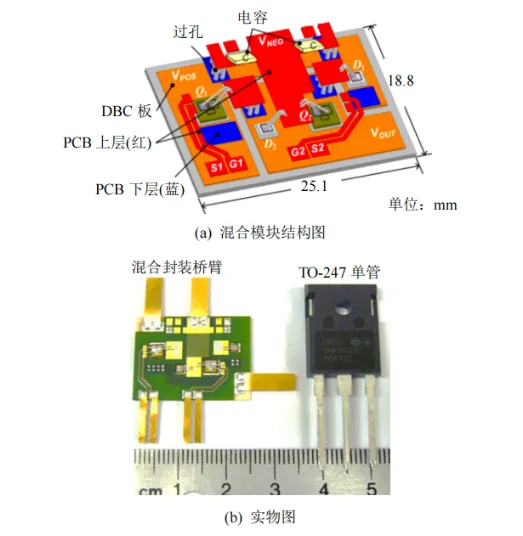
芯片正面平面互连封装: 采用平面互连的连接方式,如端子直连焊接方法,实现芯片正面的连接,减小电流回路,改善温度循环特性和可靠性。
2.高温封装技术
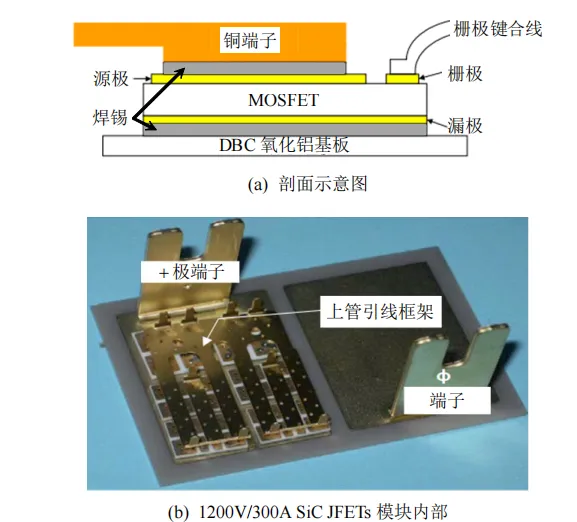
柔性PCB板结合烧结银工艺: 将柔性PCB板结合烧结银工艺用于封装,取代键合线,实现电气连接,有效降低杂散电感参数,减小体积,提高功率密度。
埋入式封装: 将芯片置于陶瓷定位槽中,采用绝缘介质填充缝隙,覆盖金属铜,实现电极连接,降低模块在高温时的层间热应力,提高正反向特性。
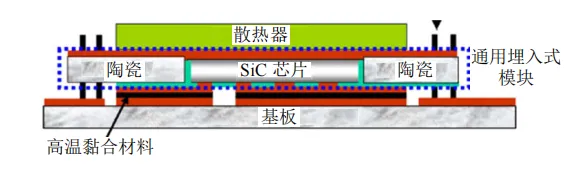
3.多功能集成封装技术
平面直连封装: 消除金属键合线,将电流回路从DBC板平面布局拓展到芯片上下平面的层间布局,减小回路面积,实现低杂散电感参数。
双面散热封装和三维封装: 通过改变封装方式,实现更好的散热效果,提高功率密度。
通过对这三个关键技术方向的分析,我们可以看到,碳化硅功率器件的封装技术正在不断创新和发展。这些技术的应用将在提高器件性能、可靠性和适应更广泛应用的同时,推动碳化硅功率器件在电力电子领域的更广泛应用。
审核编辑 黄宇
-
碳化硅深层的特性2019-07-04 0
-
【罗姆BD7682FJ-EVK-402试用体验连载】基于碳化硅功率器件的永磁同步电机先进驱动技术研究2020-04-21 0
-
碳化硅器件的特点是什么2021-03-16 0
-
功率模块中的完整碳化硅性能怎么样?2023-02-20 0
-
归纳碳化硅功率器件封装的关键技术2023-02-22 0
-
碳化硅功率器件的封装关键技术及所面临的挑战和机遇2022-11-08 1834
-
碳化硅功率器件封装关键技术2022-11-12 1553
-
碳化硅功率器件技术可靠性!2023-01-05 1525
-
碳化硅功率器件封装大揭秘:科技魔法师的绿色能源秘笈2023-04-14 993
-
碳化硅功率器件封装的关键技术有哪些呢?2023-08-03 510
-
碳化硅功率器件:革命性的封装技术揭秘2023-08-15 1119
-
碳化硅器件封装与模块化的关键技术2024-01-09 526
-
探究电驱动系统中碳化硅功率器件封装的三大核心技术2024-08-19 413
-
碳化硅功率器件的优点和应用2024-09-11 578
全部0条评论

快来发表一下你的评论吧 !

