

晶体管入门基础知识全面解析
模拟技术
描述
晶体管的类型
晶体管大致分为三种类型:双极型、场效应型和绝缘栅双极型。双极晶体管属于电流驱动器件。场效应晶体管(FET)和绝缘栅双极晶体管(IGBT)属于电压驱动器件。
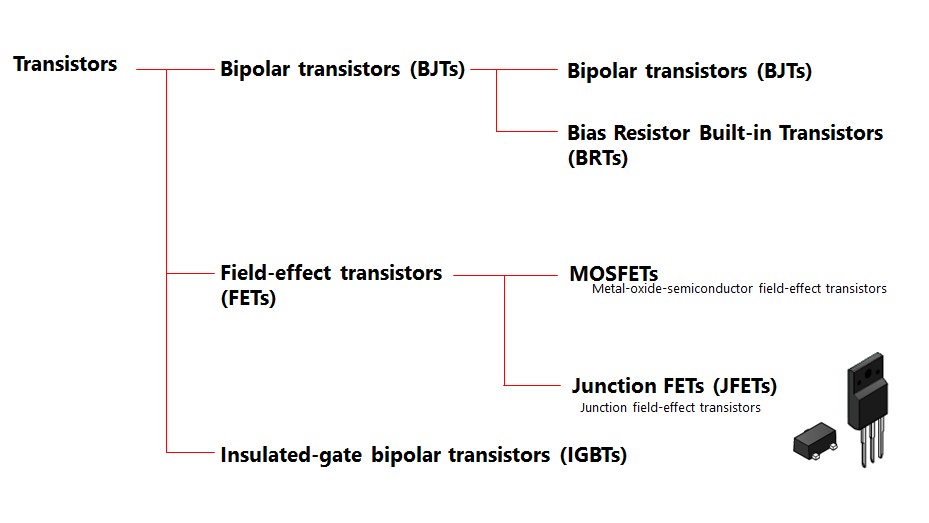
双极晶体管(BJT)
双极晶体管有两种类型:NPN型和PNP型。NPN型产品涵盖低耐受电压到高耐受电压产品。耐受电压为400V或以下的PNP型产品,特别是耐受电压为200V或以下的PNP型产品是主流产品。它们有放大功能,可以将小信号转换成大信号。集电极电流I(C)与基极电流I(B)(I(C)/I(B))之比称为直流电流增益,用h(FE)表示。当小电流(I(B))从基极流向发射极时,I(B)×h(FE)的电流I(C)从集电极流向发射极。

BJT是由基极电流驱动的电流驱动器件。
NPN晶体管的操作
基极电流:从基极到发射极的电流
集电极电流:从集电极到发射极的电流
PNP晶体管的操作
基极电流:从发射极到基极的电流
集电极电流:从发射极到集电极的电流
内置偏置电阻型晶体管(BRT)
BRT是指偏置电阻内置型晶体管。BJT通常配合电子设备中的电阻器使用。使用BRT(集成了晶体管和电阻器)可以减少安装面积。
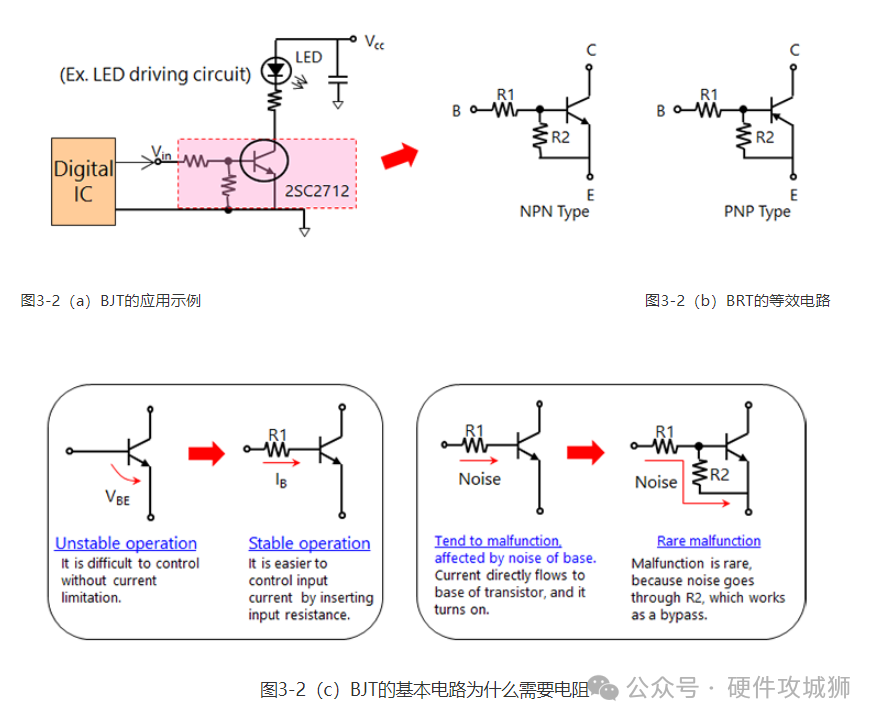
结型场效应晶体管(JFET)
JFET:结型场效应晶体管
(1)在N沟道结型场效应晶体管(图3-3(a))中,当在漏极和源极之间施加电压时,电子从源极流向漏极。
(2)当在栅极和源极之间施加反向偏压时,耗尽层扩大并抑制(1)中的电子流动。(使电子流动的路径变窄)
(3)如果栅极和源极之间的反向偏压进一步增加,耗尽层就会阻塞通道,电子流动停止。
如上所示,施加在栅极和源极之间的电压控制着漏极和源极之间的状态。所以场效应晶体管是电压驱动的器件。

金属氧化物半导体场效应晶体管(MOSFET)
金属氧化物半导体场效应晶体管(MOSFET)是目前最受关注的晶体管。MOSFET有两种类型:N沟道(参见下图3-4(a)N沟道)和P沟道(参见下图3-4(b)P沟道)。N沟道广泛用于AC/DC电源、DC/DC转换器、逆变器设备等,而P沟道则用于负载开关、高边开关等。双极晶体管和MOSFET之间的差异如表3-1所示。


BJT和MOSFET的差异
关于BJT和MOSFET开关操作差异的解释。
(1)基极电压升高时,BJT的基极电流开始流动,集电极电流与基极电流成正比。大约从0.7V开始发生电流流动。这个电压被称为基极-发射极阈值电压(VBE)。为了使集电极电流流动,需要提供基极电流,并且需要连续的驱动功率。(需要低驱动电压、连续驱动功率)(2)由于MOSFET根据栅极-源极电压形成一个沟道,这个电压必须是一定的或更高的电压。一旦沟道形成,导通状态继续,漏极电流继续流动,因此所需的驱动功率很小。通过释放积聚在栅极中的电荷并移除沟道,它将转变为关闭状态。(驱动电压高于BJT,驱动功率小)
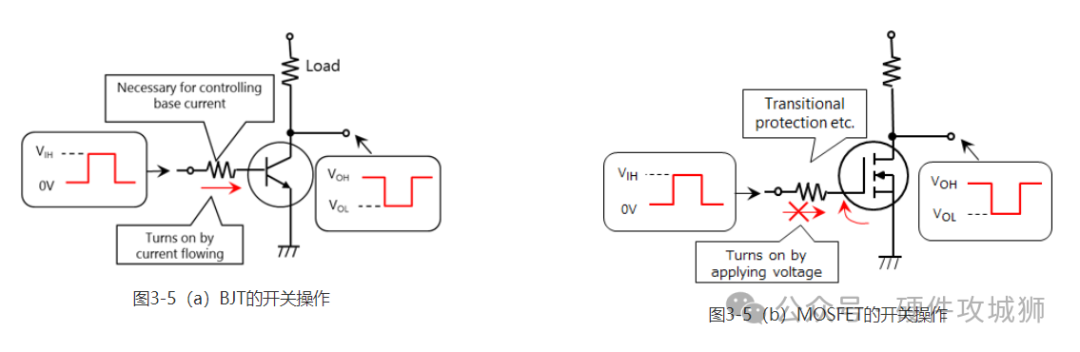
MOSFET的结构和工作原理
我们将参照图3-6(a)来解释MOSFET的工作原理。(1)在漏极为正极的漏极和源极之间施加电压。(漏极-源极电压:VDS)(2)在栅极为正极的栅极和源极之间施加电压。(栅极-源极电压:VGS)(3)其结果是,电子被吸引到栅极绝缘膜下面的p型层上,部分p型层转变为n型区(p型层中的n型区称为“反转层(沟道)”)。(4)当这个反转层完成时,MOSFET漏极到源极将形成n层路径。(n+⇔n-⇔ 反转层(n)⇔ n+)(5)因此MOSFET在低电阻下工作,漏极电流由外加VDS和负载流决定。
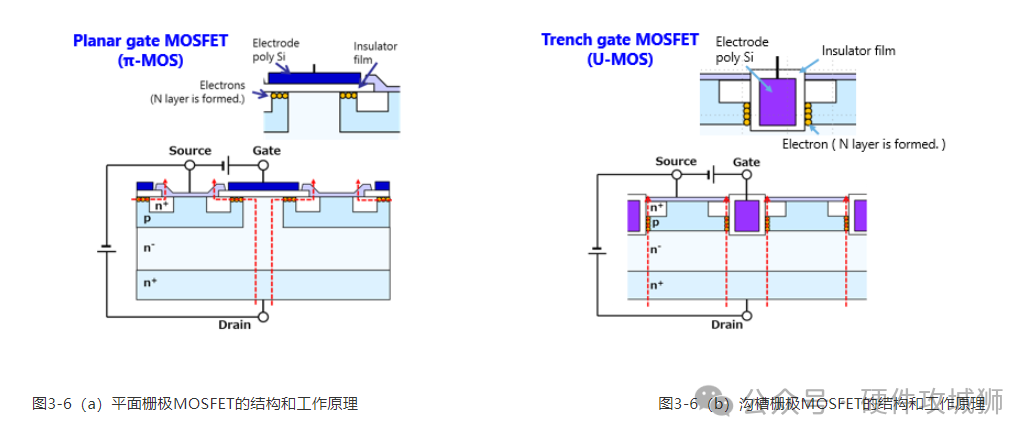
MOSFET性能改进:R(DS(ON))的决定因素
(1)MOSFET器件结构将根据要求的耐受电压来选择。确定导通电阻R(DS(ON))的因素如图3-7和方程式3-(1)所示。根据器件的结构,决定导通电阻的因素比例将发生变化。(2)例如,许多中高压MOSFET(250V及以上)具有平面MOS(π-MOS)结构,而小于200V的产品大多具有沟槽MOS(U-MOS)结构。因此,当耐受电压V(DSS)=600V时,Rdrift成为主导因素,当耐受电压是30V时,因素R(ch)的比例较高。
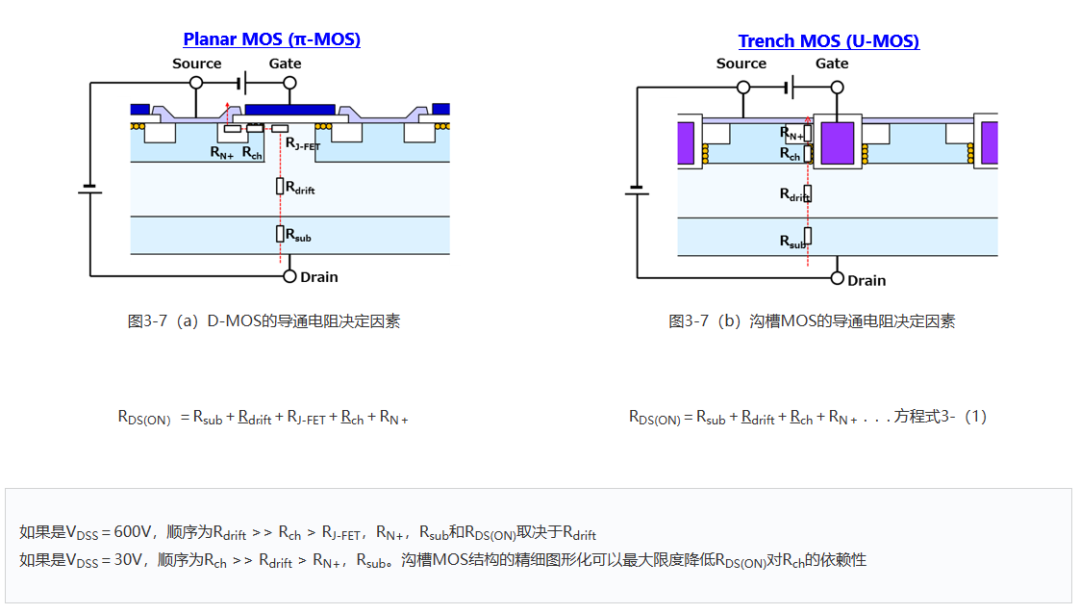
MOSFET性能改进:低R(DS(ON))的解决方案
针对MOSFET的最大问题,我们正采取以下对策:“如何有效利用元件面积以有效降低导通电阻”
(1)高电压:下一页将介绍通过先进的超结工艺降低Rdrift电阻。(2)低电压:通过对沟槽结构的精细图形化可最大限度降低Rch电阻,采用薄晶片降低Rsub电阻。
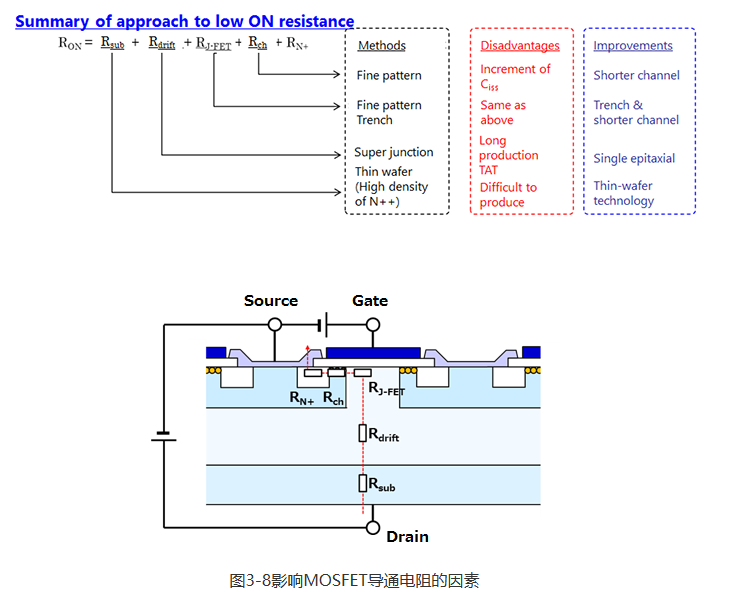
MOSFET性能改进:超级结MOSFET(SJ-MOS)
(1)SJ-MOS在N层具有柱状P层(P柱层)。P层和N层交替排列。(参见图3-9(b))
(2)通过施加VDS,耗尽层在N层中扩展,但其在SJ-MOS中的扩展方式与在一般D-MOS中不同。(关于电场强度,参见图3-9(a)/(b)。电场强度将表示耗尽层的状态。
(3)如果是D-MOS的情况,电场强度在P/N层接口处最强。当电场强度超过硅的极限时,会发生击穿现象,这就是电压极限。另一方面,如果是SJ-MOS的情况,电场强度在N层中是均匀的。
(4)所以,SJ-MOS可采用具有较低电阻的N层设计,以实现低导通电阻产品。
采用与DMOS相同尺寸的芯片,SJ-MOS可以实现更低的导通电阻。
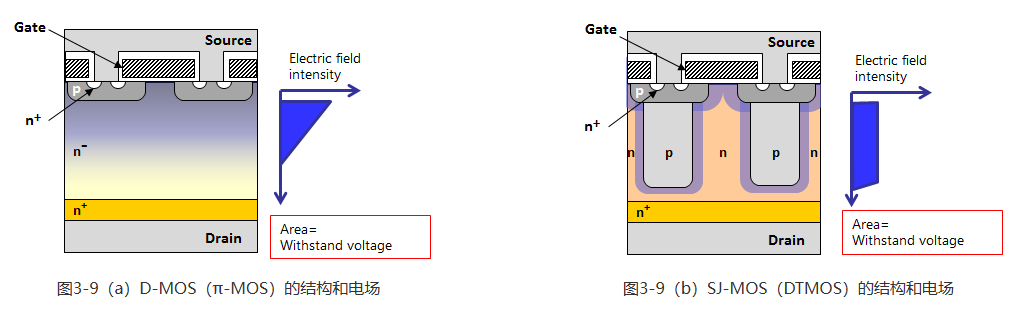
MOSFET的性能:漏极电流和功耗
允许损耗和漏极电流是MOSFET的典型最大额定值,计算如下。(有些产品采用了不同的电流表达式。)通过热阻和结温来计算功耗。漏极电流将采用欧姆定律,由计算得出的功耗和导通电阻进行计算。
(D):功耗⇒ 器件指定温度条件下允许的功耗

I(D):漏极电流
⇒直流额定值:正向流动的直流电流。(在室温下定义)

I(Dp):脉冲漏极电流
⇒指定脉宽下的最大漏极电流。一般是直流电流的4倍。

MOSFET的性能:雪崩能力
作为MOSFET的一个特性,如果它在一定的能量、漏极电流ID范围内,并且低于额定结温Tch,则即使超过了额定电压V(DSS),它也不会击穿损坏。这就是所谓的雪崩能力,允许能量被称为雪崩能量,电流被称为雪崩电流。
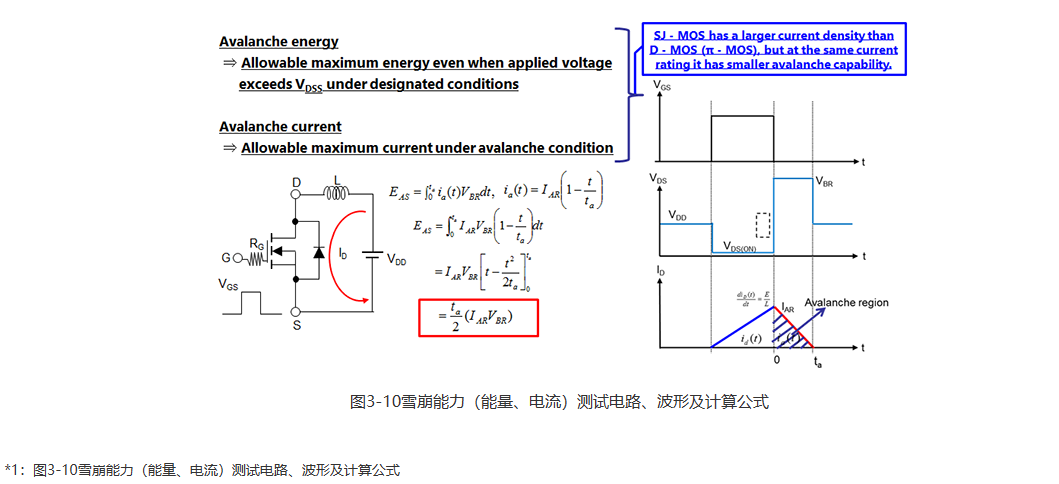
MOSFET的性能:电容的特性
C(iss)、C(rss)和C(oss)的电容特性是影响MOSFET开关特性的重要因素。
C(iss):输入电容(C(iss)=C(gd)+C(gs))
⇒栅极-漏极和栅极-源极电容之和:它影响延迟时间;C(iss)越大,延迟时间越长。
C(rss):反向传输电容(C(rss)=C(gd))
⇒栅极-漏极电容:C(rss)越大,漏极电流上升特性越差,这不利于MOSFET的损耗。高速驱动需要低电容。
C(oss):输出电容(C(oss)=C(gd)+C(ds))
⇒栅极-漏极和漏极-源极电容之和:它影响关断特性和轻载时的损耗。如果(Coss)较大,关断dv/dt减小,这有利于噪声。但轻载时的损耗增加。

MOSFET的性能:安全工作区域(或安全操作区域
)
安全工作区域(SOA)有两种模式。
(1)正向偏置SOA(F.B. SOA):电流和电压在导通状态下的可用面积。(2)反向偏压SOA(R.B. SOA):电流和电压在关断操作时的可用面积。
由于用于开关操作,施加的脉宽非常窄。
每种模式的定义如图3-12(a)所示。
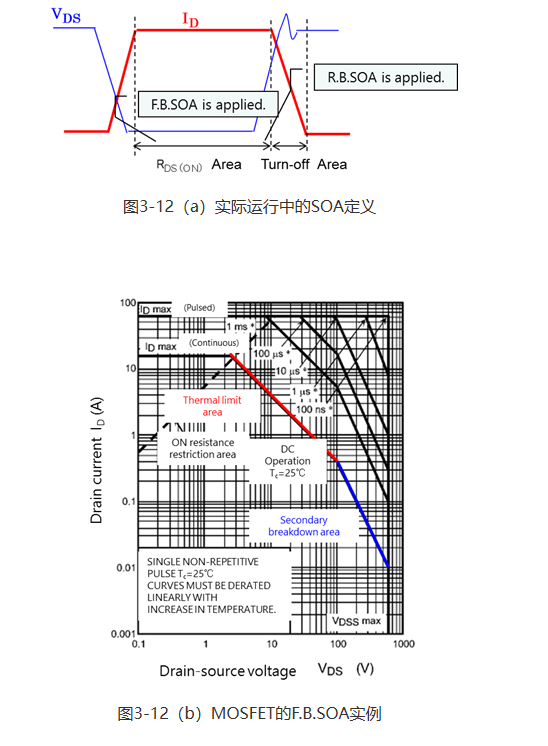
关于雪崩保证,通常保证MOSFET关断时的额定电压/电流操作(短时),但R.B. SOA尚未公布。
F.B. SOA由三个限制区域(额定电流、额定电压和热阻区)和二次击穿区域组成。
这三个限制区域由器件额定值限制或由热阻计算。但二次击穿区域是通过测量实际器件获得。
绝缘栅双极晶体管(IGBT)
IGBT是一种适合于大电流控制的器件,它的前级有电压驱动MOSFET,后级有允许大电流流动的晶体管。
IGBT:绝缘栅双极晶体管
[等效电路和操作细节]
IGBT的等效电路如图3-13(b)所示。设置RBE值使NPN Tr不会导通。
对N沟道MOSFET栅极施加导通信号,开启导通状态。
电流从发射极流向PNP Tr的基部。这种基极电流可以降低N沟道MOSFET。(电导率调制效应)
[与MOSFET比较]
栅极驱动操作与N沟道MOSFET相同。
在导通状态下,N沟道MOS的导通电阻降低可以实现大电流。
从PNP Tr发射极到基部的电压降发生在整个电流区域(加起来大约1.0V作为导通电压)。
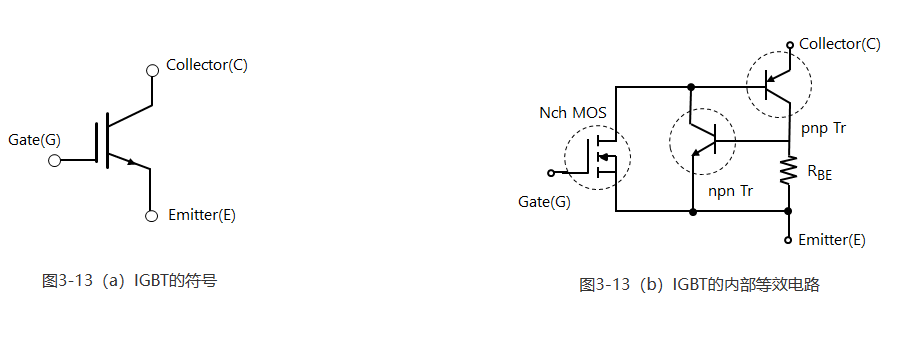
绝缘栅双极晶体管(IGBT)的工作原理
如图3-14(a)所示连接的IGBT的操作如下所示。
(1)对栅极施加正电压,将在栅极下面的P层中形成反转层。图3-14(b)中的N沟道MOSFET导通与常规N沟道MOSFET一样。
(2)当N沟道MOSFET处于导通状态时 ,集电极的电位为正。因此,空穴将从P+通过N+注入到N-,这种注入加速了发射极电子的注入。
(3)结果,载流子(电子和空穴)的增加降低了通常具有高电阻的N层电阻(电导调制效应)。
因此,如图3-14(b)所示,N沟道MOSFET的导通电阻变低。·

IGBT的性能改进:垂直设计的发展
如图3-15(a)所示,IGBT的垂直设计一直在发展。从PT结构开始,随着薄晶片的使用,薄型PT(通常称为“场截止”)结构正在成为主流。(栅极结构与MOSFET相同。)
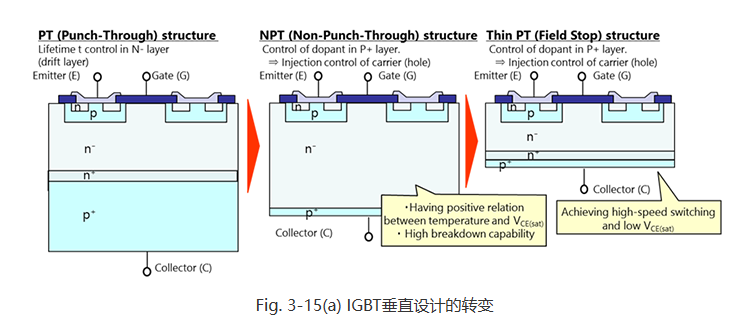
PT型的V(CE(sat))特性是具有高温和室温条件下交叉的电流值(称为“Q点”)。由于高温V(CE(sat))在NPT型(如MOSFET)中始终很高,因此即使在并联操作时也更容易平衡集电极电流。
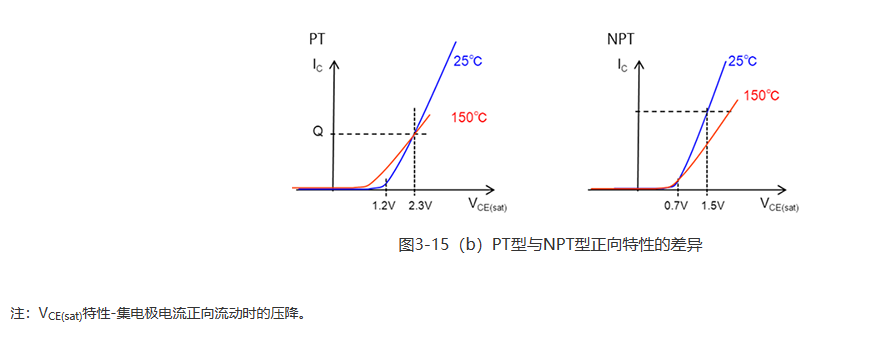
什么是RC-IGBT和IEGT?
反向导通IGBT:RC-IGBT
RC-IGBT的结构如图3-16(a)所示。二极管由一部分p型层构成,p型层作为IGBT的n型集电极。该二极管具有与FWD(*1)相同的功能,FWD(*1)通常插入IGBT中。
随着薄晶片技术的引入,这种结构的商业化也成为了可能。由于二极管和IGBT是一个芯片,所以很容易组装。因为很难单独控制二极管和IGBT的性能,所以RC-IGBT不适合某些应用。
*1:FWD—续流二极管。一般用于输送电抗器产生的回流电流。
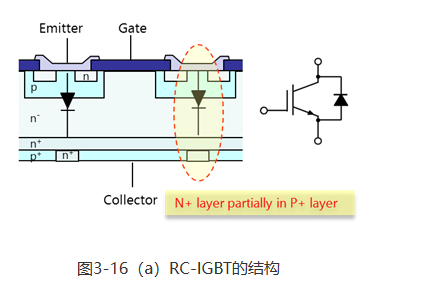
栅极注入增强型晶体管:IEGT
在高压IGBT中,由于发射极侧漂移层(n型层)载流子浓度较低,所以很难获得低V(CE(sat))特性。
IEGT开发用于获得高耐受电压(通常为1200V或更高)下的低V(CE(sat))性能
图3-16(b)显示了IEGT的结构和原理。
它有一个沟槽栅结构。拉出栅电极将变薄。结果使得载流子聚集在薄栅电极的正下方,这就增加了发射极侧的载流子浓度
高的载流子密度降低了漂移层的电阻,使V(CE(sat))降低
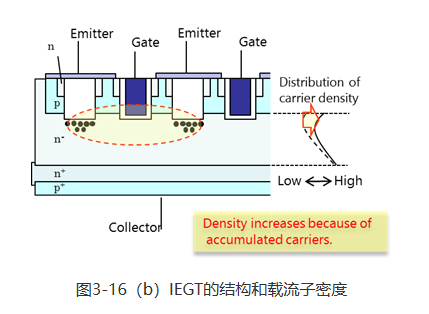
IGBT的应用
IGBT适用于驱动电路简单、电流大的应用。它们目前用于50kHz以下的软开关IH(感应加热)设备、家用电器、车辆和各种交流驱动应用。未来,它们的应用领域有望扩展到各种交流驱动应用。

注:由于双极操作的原因,IGBT相比于MOSFET而言不适合高速开关。
IGBT和MOSFET的正向特性比较
本文比较了MOSFET(D-MOS)和IGBT在500~600V电压下的正向特性,在低电流区,MOSFET压降小,这具有一定的优势。另一方面,IGBT在大电流区的正向电压特性优于MOSFET,如图3-17所示。由于MOSFET的正向特性对温度具有很强的正向依赖性,IGBT和MOSFET的性能差异随着温度的升高而增大。
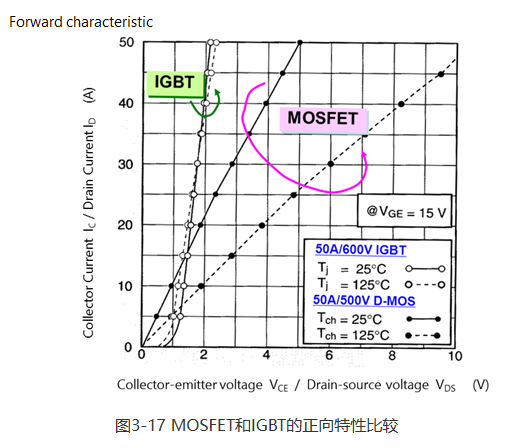
该图比较了中高压产品。在工作电流区域,低压MOSFET(如沟道MOSFET)的导通电阻远低于IGBT。
鉴于这些特性和开关性能:
MOSFET应用于低电流密度和大约100kHz的开关电源工作。
IGBT应用于高电流密度和20kHz以下的交流驱动工作。
晶体管的结构比较

MOSFET的数据表:最大额定值
<最大绝对额定值>
漏极-源极电压(V(DSS))可施加的最大漏极-源极电压
栅极-源极电压(V(GSS))可施加的最大栅极-源极电压设计电路时不得超过这个电压,包括浪涌电压。
漏极电流(I(D))最大漏极电流
漏极电流(脉冲)(I(DP))最大脉冲漏极电流通常,脉宽如安全工作区域中所述。
功耗(P(D))允许在器件中产生的功率损失Tc=25℃时的容许热容量。
单脉冲和连续雪崩能量(E(AS))在指定条件下的最大允许能量
雪崩电流(I(AR))雪崩操作时的最大电流
结温(T(ch))器件运行时的最高结温
存储温度(T(tsg))不使用MOSFET的存储温度范围

注1:确保结温不超过150℃。注2:V(DD)=90V,T(ch)=25℃(初始),L=4.36mH,R(G)=25Ω,I(AR)=3.0A注3:重复额定值:由最大结温限制的脉宽。该晶体管是静电敏感器件。请小心处理。
MOSFET的数据表:电气特性
<热特性>用于计算结温

<电气特性>
栅极泄漏电流(I(GSS))从栅极到源极的截断电流
漏极截止电流(I(DSS))从漏极到源极的截断电流
漏极-源极击穿电压(V((BR)DSS))漏极-源极击穿电压栅极和源极短路,以免形成通道
栅极阈值电压(V(th))能够发送指定漏极电流的栅极-源极电压
漏极-源极导通电阻(R(DS(ON)))它对应于双极晶体管的集电极-发射极饱和电压(V(CE(sat)))电压降用指定条件下的电阻表示。它具有正温度系数。
正向转移导纳(|Y(fs)|)输出电流的变化与栅极输入电压的变化之比。其单位是“S:西门子”,与[A]/[V]相同。
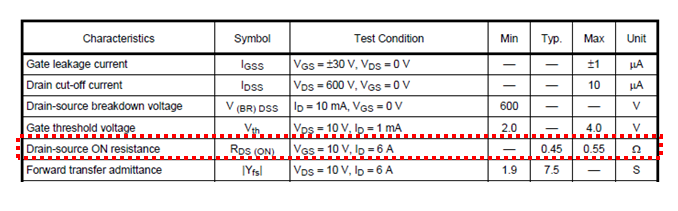
MOSFET的数据表:电容和开关特性
<电气特性>
输入电容(C(iss))等于C(gd)+C(gs)栅极-漏极和栅极-源极电容
反向传输电容(C(rss))等于C(gd)栅极-漏极电容
输出电容(C(oss))等于C(gd)+C(ds)栅极-漏极和漏极-源极和栅极-漏极电容
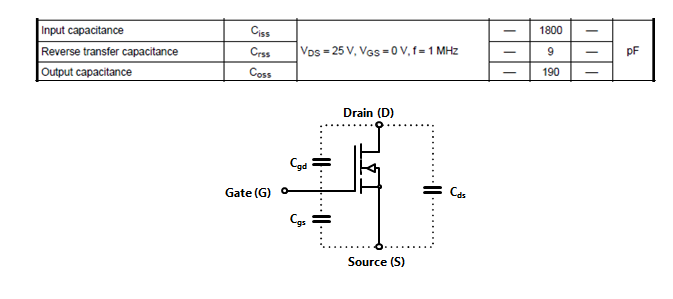
上升时间(t(r))是漏极-源极电压从90%变为10%的时间
导通时间(t(on))栅极-源极电压上升到10%的瞬间和漏极-源极电压下降到10%的瞬间之间的间隔时间
下降时间(t(f))漏极-源极电压从10%变为90%的时间
关断时间(t(off))栅极-源极电压下降到90%的瞬间和漏极-源极电压上升到90%的瞬间之间的间隔时间
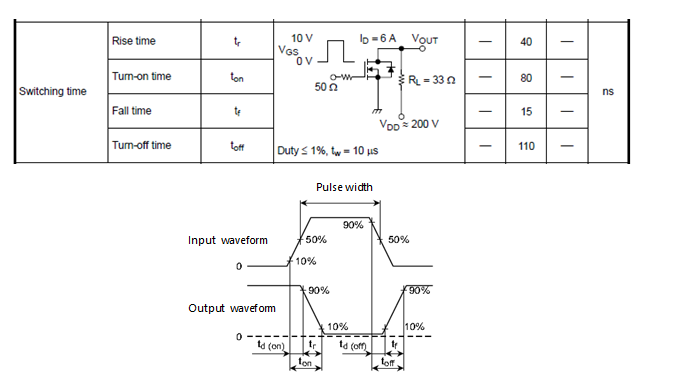
MOSFET的数据表:体二极管
<电气特性>
连续漏极反向电流(I(DR))直流漏极-源极二极管的正向电流
脉冲漏极反向电流(I(DRP))脉冲漏极-源极二极管的正向电流
正向电压(二极管)(V(DSF))正向电流漏极-源极二极管的电压降
反向恢复时间(t(rr))指定条件下漏极-源极二极管的反向恢复时间
反向恢复电荷(Q(rr))指定条件下漏极-源极二极管的反向恢复电荷
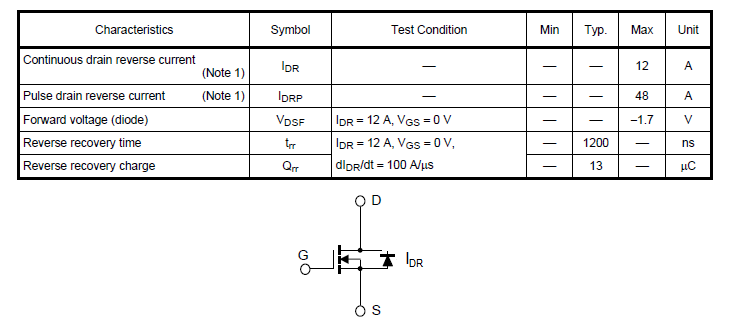
审核编辑:黄飞
-
晶体管的基础知识2023-02-13 9256
-
PNP晶体管的基础知识2022-09-05 11092
-
晶体管和FET实用设计教材《晶体管电路设计(下)》2019-03-06 5286
-
晶体管电路设计2018-12-13 3189
-
【下载】《晶体管电路设计》——晶体管电路基础知识汇总2017-07-25 39955
-
入门经典:晶体管电路设计上下册让你感性认识晶体管2017-06-22 101928
-
晶体管电路设计-上2016-06-21 2825
-
半导体基础知识与晶体管工艺原理2012-08-20 3158
-
双极晶体管的基础知识2010-08-29 1314
-
三极管基础知识及检测方法2010-04-22 7988
-
三极管基础知识及检测方法简介2009-11-28 1960
-
IGBT晶体管基础知识2009-11-06 3388
-
晶体管基础知识2008-06-19 2254
全部0条评论

快来发表一下你的评论吧 !

