

芯片热管理,倒装芯片封装“难”在哪?
电子说
描述
来源 :道芯IC
芯片功耗提升,散热重要性凸显...
01概述Summarize
底部填充料在集成电路倒装芯片封装中扮演着关键的角色。在先进封装技术中,底部填充料被用于多种目的,包括缓解芯片、互连材料(焊球)和基板之间热膨胀系数不匹配所产生的内部应力,分散芯片正面的承载应力,保护焊球、提高芯片的抗跌落性和热循环可靠性,以及在高功率器件中传递芯片间的热量。
根据使用场景的不同,底部填充胶通常分为三种类型。首先是用于填充芯片与封装基板之间凸点间隙的倒装芯片底部填充胶,其精度通常在微米级。
其次是用于填充封装基板与PCB印制电路板之间焊球间隙的(焊)球栅阵列底部填充胶,其间隙精度为毫米级,对底部填充胶的要求相对较低。第三种是用于晶圆级封装。在这些应用中,倒装芯片底部填充胶的市场占比最大。

■ 传统Underfill流程
02材料分类
Material Classification
倒装芯片底部填充料填充在集成电路芯片与有机基板之间的狭缝中,起到密封保护连接焊点的作用。底部填充料是影响倒装芯片组装质量的关键因素之一。由于芯片、有机基板、焊料连接和填充材料属于不同材质,它们的热膨胀系数存在差异。
在没有底部填充的情况下,芯片与有机基板的热膨胀系数差异最大,导致在温度变化时整个封装体易发生形变,且在芯片与有机基板互连点上出现剪应力。
底部填充料的关键作用在于调节上述现象,使整个系统的热膨胀系数介于芯片和基板之间,加强焊接连接的强度,降低连接点的疲劳应力,从而延长产品寿命。

■ 倒装芯片用材料
Underfill材料主要由有机粘合剂、填料、固化剂、催化剂、偶联剂、润湿剂、阻燃剂、消泡剂以及其他添加剂构成。

■ Underfill材料
根据填充阶段的不同,底部填充技术可分为后填充和预填充两种类型。传统的底部填充技术通常在倒装芯片互连后进行。随着系统集成度的不断提高,倒装芯片上凸点的尺寸和间距变得越来越小,当间距小于100微米时,传统的后填充技术常常存在凸点填充不完全或产生孔洞等缺陷,导致封装互连的可靠性下降。
为了适应倒装芯片窄间距互连的填充需求,预成型底部填充技术应运而生。这种技术简化了工艺流程,并且能够有效地对窄间距互连(小于100微米)进行良好的底部填充。
预成型底部填充技术指的是在芯片互连之前将底部填充料施加在芯片或基板上,在随后的回流或热压键合过程中,同时完成芯片凸点互连和底部填充固化的工艺步骤。
03工艺分类
Process Classification
根据填充工艺的分类,后填充可分为毛细管底部填充(CUF)和塑封底部填充(MUF),而预填充则主要涵盖非流动底部填充料(NUF)、晶圆级底部填充料(WLUF)、非导电浆料(NCP)和非导电膜(NCF)。

■ Underfill材料分类
1)毛细管底部填充(CUF)技术依赖毛细作用将材料填充在芯片和芯片载体之间。首先,在带有凸点的基板上涂覆一层助焊剂,然后将芯片焊料凸点对准基板焊盘,加热使焊料回流,实现上下凸点的互连。
随后,通过溶剂喷雾等方式清洗助焊剂,然后沿着芯片边缘注入底部填充料。底部填充料借助毛细作用会被吸入芯片和基板的空隙内,最后进行加热固化。目前,市场上大部分底部填充料采用毛细管底部填充技术,广泛应用于手机等许多电子器件的小尺寸芯片封装中。
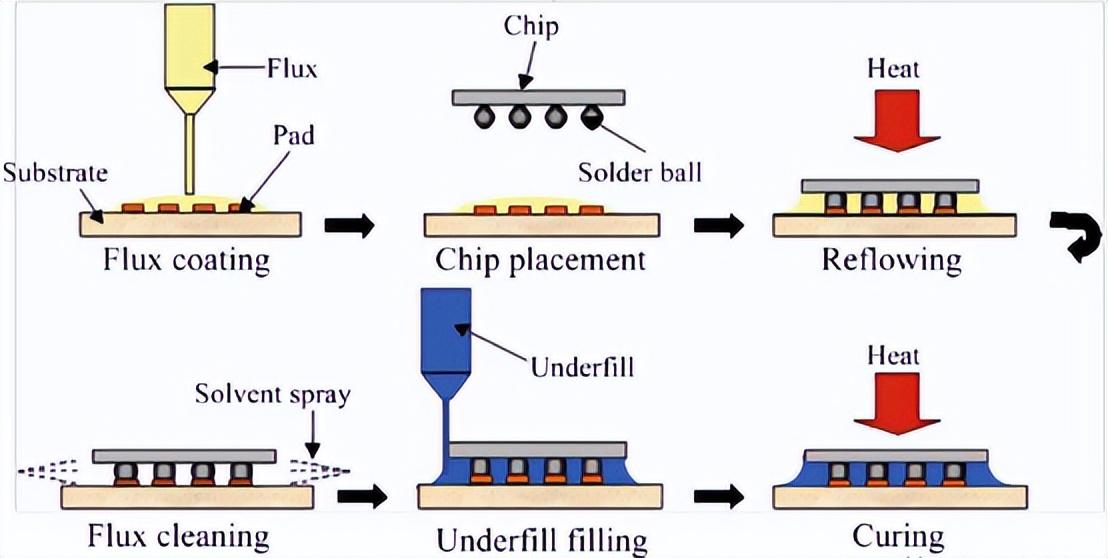
■ FC封装中CUF的填充工艺过程
2)塑封底部填充(MUF)技术将底部填充料的填充和器件塑封两个步骤合二为一。在进行塑封的同时,底部填充料进入芯片和基板之间的空隙,在随后的固化过程中完成填充和密封。相较于毛细管底部填充工艺,塑封底部填充工艺(MUF)更为简便快速。
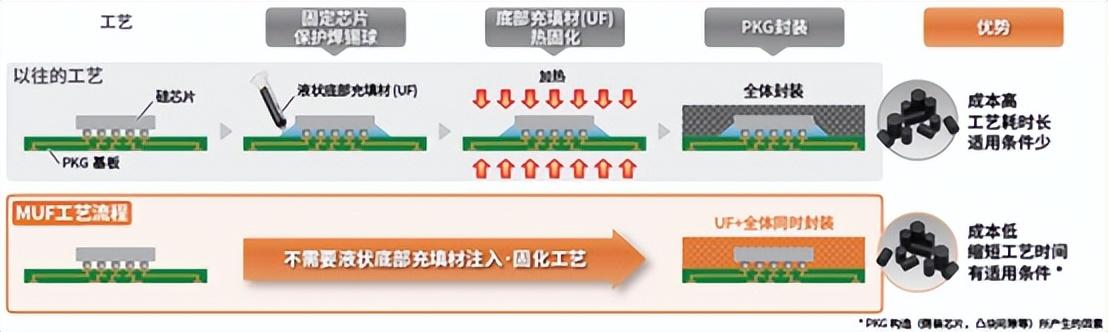
■ MUF工艺优势
3)非流动底部填充料(NUF)工艺不依赖于液体的毛细作用。在芯片和基板互连之前,首先在基板表面涂覆非流动底部填充料,然后在焊料回流过程中同时完成焊球互连和底部填充料的加热固化。这一工艺省去了毛细管底部填充工艺中助焊剂的涂覆和清除步骤,提高了生产效率。

■ NUF工艺流程
4)晶片级底部填充料(WLUF)是针对晶片级封装而设计的填充方式。在晶圆上,通过适当的涂覆工艺(如层压或涂覆)添加一层底部填充料,并对其进行加热以去除溶剂以进行预固化。随后,通过平整化处理露出互连凸点,然后对晶圆进行切割,以获得带有凸点的单个组件。最后,这些组件通过表面安装工艺与基板连接起来。
5)非导电浆料(NCP)工艺可以通过热压的方式直接让凸点和焊盘接触,实现电互连,省去了与助焊剂相关的步骤。该材料在固化后主要用于形成机械连接,并维持凸点和焊盘的接触压力。

■ 面向窄节距凸点互连的NCP非流动底部填充技术工艺流程
6)非导电膜(NCF)材料具有柔软性,可作为卷材夹在塑料薄膜(如PET)中使用,适用于圆片级封装。NUF与NCP/NCF有所不同,NUF的非流动性在焊料回流过程中同时实现封装材料和助焊剂等与焊球的互连。而NCP/NCF是一种非导电材料(膜),通过倒装键合的热压方式完成焊球的互连和封装材料的固化过程。

■ 不同类型的底部填充材料和相关工序
-
倒装芯片的优势_倒装芯片的封装形式2024-12-21 4362
-
倒装芯片封装技术解析2024-10-18 2886
-
芯片倒装Flip Chip封装工艺简介2024-02-19 7169
-
先进倒装芯片封装2023-11-01 605
-
倒装芯片封装选择什么样的锡膏?2023-10-31 1865
-
倒装芯片和芯片级封装的由来2023-10-16 2390
-
什么是倒装芯片 倒装芯片技术的优点 倒装芯片封装工艺流程2023-07-21 8664
-
倒装芯片封装的挑战2023-05-22 2492
-
浅谈倒装芯片封装工艺2023-04-28 6381
-
倒装芯片 CSP 封装2022-11-14 975
-
柔性电路板倒装芯片封装2018-09-11 2718
-
倒装芯片和晶片级封装技术及其应用2018-08-27 3302
-
倒装芯片CSP封装2017-03-31 2767
-
倒装芯片封装的发展2011-10-19 5671
全部0条评论

快来发表一下你的评论吧 !

