

光阻的基础知识
描述
本文将系统介绍光阻的组成与作用、剥离的关键工艺及化学机理,并探讨不同等离子体处理方法在光阻去除中的应用。
一、光阻(Photoresist,PR)的本质与作用
光阻是半导体制造过程中用于光刻工艺的核心材料。它由高分子树脂、光敏剂、溶剂及添加剂组成。其特性直接影响芯片图形化的精度。
光阻的作用:
图形转移:通过曝光显影,在硅片表面形成纳米级图案,作为后续刻蚀或离子注入的掩膜。
保护作用:阻挡刻蚀剂或离子对非目标区域的损伤。
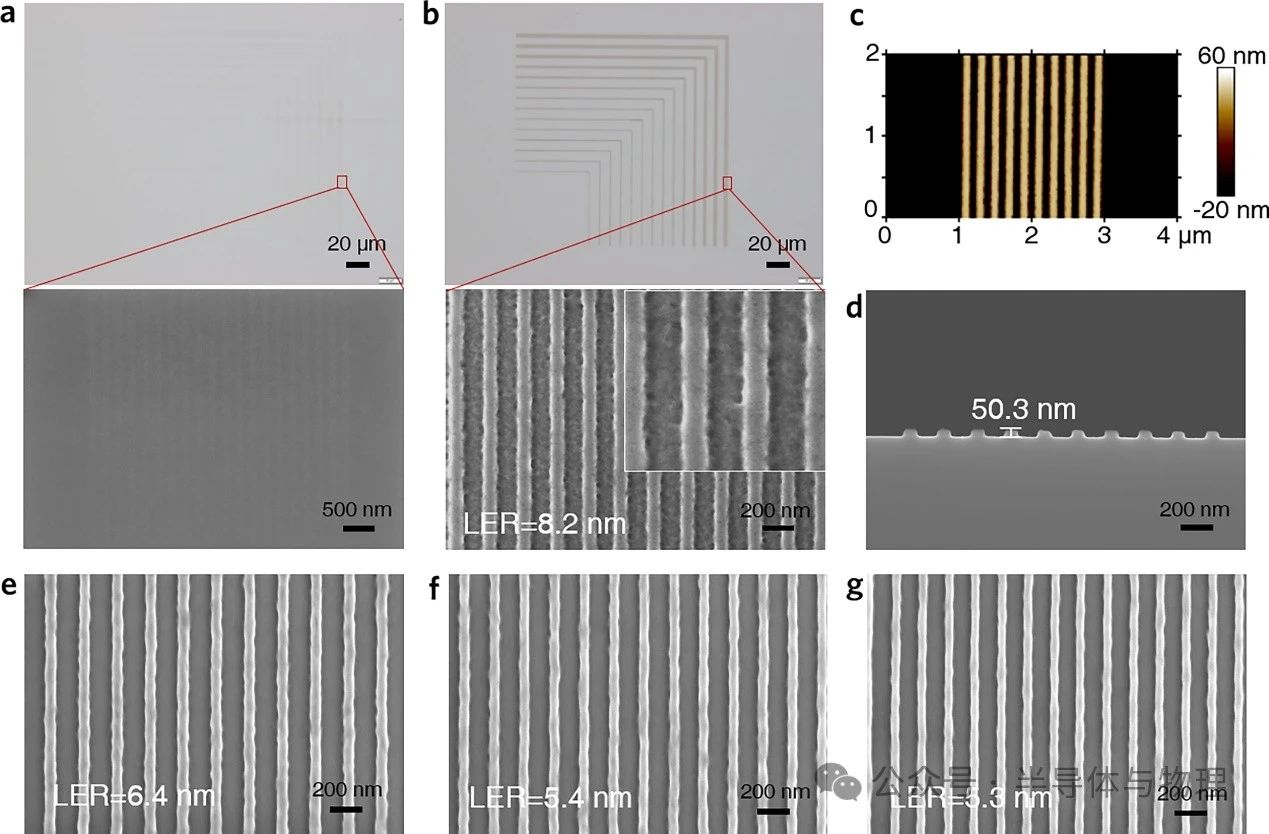
二、光阻剥离(PR Strip)
完成掩膜使命后的光阻需彻底去除,否则残留物会导致:
后续工艺污染(如金属沉积时引入缺陷)
器件短路或断路(残留光阻阻碍导电层连接)
可靠性下降(界面结合力劣化)
剥离目标:彻底清除光阻,同时避免损伤硅片表面材料(如金属、氧化物、低k介质等)。
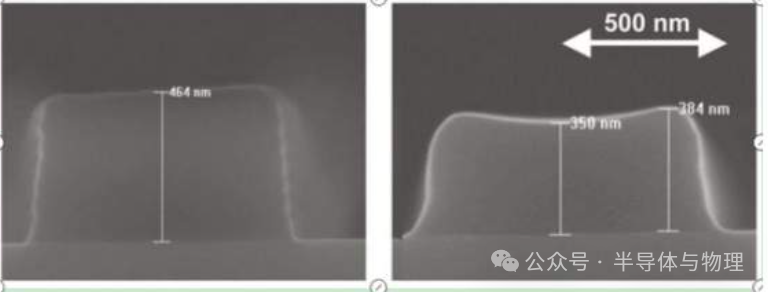
三、光阻剥离的工艺流程与化学机理
原理:利用等离子体中的活性自由基轰击光阻,切断高分子链。
关键步骤与材料:
1.氧气等离子体(O₂ Plasma)
设备:反应离子刻蚀(RIE)或电感耦合等离子体(ICP)设备。
反应机理:活性氧攻击光阻中的C-H键,生成CO、CO₂和H₂O挥发。
2.混合气体增强剥离
CF₄/O₂混合气体:增强对交联光阻的刻蚀速率。
H₂/N₂混合气体:减少对金属层的氧化损伤。
(CH)x+O--CO₂+H₂O,
CxSiyOz+F--CO₂+SiF4+O₂Cx

流程示例:
1.真空腔室加载:硅片置于等离子体反应腔。
2.气体注入:通入O₂(或混合气体),气压5-50 mTorr。
3.等离子体激发:射频功率100-500 W,持续1-5分钟。
4.灰化产物排出:通过真空泵抽走气态产物。
-
电感基础知识2009-11-12 2131
-
光器件BOSA的基础知识2023-12-03 29292
-
labview基础知识2018-03-08 6644
-
通信基础知识教程2010-03-04 989
-
液晶基础知识2008-08-08 1831
-
led芯片基础知识2009-11-13 3083
-
光耦合器的基础知识2010-03-01 851
-
光耦基础知识全集2011-07-10 2221
-
使用Eclipse基础知识2016-02-26 1021
-
电源管理基础知识电源管理基础知识电源管理基础知识2017-09-15 1783
-
热设计技术:热阻和散热基础知识2021-03-04 6986
-
光功能晶体基础知识2021-04-15 979
-
光无源器件基础知识2021-06-08 1151
-
优质LDO基础知识分享2023-03-26 2651
-
功率器件热设计基础知识2025-02-03 1905
全部0条评论

快来发表一下你的评论吧 !

