

什么是3D封装?3D封装是如何工作的?
描述
1 为什么需要3D封装
随着数字时代流量的爆炸式增长,光纤通信成为高速信息传输的关键。光纤通信就像高速公路系统,光模块是公路上的货车,信息是货车上的货物。货车(即光模块)需要不断升级才能跑得更快、更稳,更有效传输“信息”货物。
光模块升级有两个关键点:
一是速度要快,就像货车要换上更大马力的引擎。目前光网络的传输速率正从100G/200G向更高速的400G/800G快速发展。
二是体积要小且性能优,这就好比货车的设计要更紧凑、更小巧,但是耗油量等性能需要更优。
由于光模块的空间有限,就像货车内部空间有限一样,需要将更多的功能集成到更小的空间里。
为了实现这一目标,3D封装(Three-dimension Packaging,三维封装技术)技术应运而生。
这就好比是在货车内部进行巧妙的设计和布局,让所有的零部件都能恰到好处地放置在合适的位置上,而且能保证货车装载容量大且油耗小等优点。
3D封装技术引入到光模块中,能让光模块保持小巧身形,实现高速数据传输,稳定发挥高性能,轻松顺应未来发展趋势。
2 什么是3D封装
3D封装是一种芯片封装技术,广泛用于电子信息行业各类芯片制造领域,本文聚焦光模块领域。芯片是实现电子设备核心功能的基础单元。
所谓封装就是用“保护盒”,密封组成复杂功能的多块芯片,保护芯片不受外界环境的影响。
3D封装指在封装(即“保护盒”)内,通过将多块芯片在垂直方向上叠放并互连,多块芯片叠放成三维结构,实现更高的集成度和更短的互联距离的封装技术。
在光模块领域中,3D封装指在封装(即“保护盒”)内,将组成光模块的各种芯片在垂直方向叠放两个及其以上芯片,从而使光模块具有更小体积、更优性能的技术。
3 3D封装是如何工作的
典型的3D封装光模块过程是将电芯片、光芯片垂直叠放在基板上,两者间采用TSV(Through Silicon Via,硅通孔)互联技术实现通信,如下图所示。
这个过程好比建设摩天大楼,房间(即芯片)是在地面(即基板)一层层垂直建设在一起的。
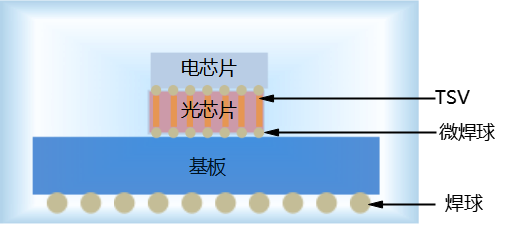
基板是光芯片和电芯片的电气连接平台。基板通常由一块或多块导电层组成,导电层被沉积在基板的衬底材料(如硅、陶瓷或玻璃)上。
所有叠放在一起的芯片被整合到一块基板上,由基板上的导电层实现芯片与外部电路的电气互联。微焊球实现芯片间电气连接。焊球实现基板与封装体外部器件电气连接。
多层叠放的芯片之间还需要互联,才能实现彼此之间的高速通信。常见的互联技术如TSV,通过在芯片上制造垂直通孔,并填充铜或钨等导电材料实现芯片间的垂直通信,如下图所示。
好比在摩天大楼布放电线过程,不同楼层之间先穿孔、再铺设布线管、最后布放电线实现楼层间通电。
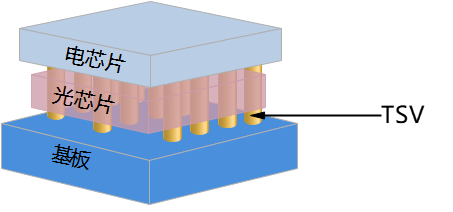
通过TSV技术,可缩短芯片之间连线长度至芯片厚度,有效减少信号传输延迟和损失,提高信号速度和带宽,以此实现光通信模块更低的功耗、更小的体积和更快的传输速率。
4 3D封装与2D/2.5D封装有什么不同
2D封装属于传统封装技术,2.5D和3D封装都属于先进封装技术。
2D封装:是平面化组装,好比建造平房,如下图所示。在2D封装中,所有芯片平铺在基板上,芯片之间需要通过金属线连接,封装尺寸比较大。
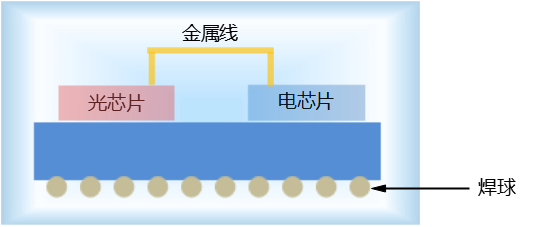
2.5D封装:2.5D封装在2D封装基础上增加了一层阁楼(即中介层),类似建设二层小洋楼,一层楼阁仅用于走水电管,二层才平铺建设房间(即芯片)。
在2.5D封装中,多块芯片仍然是水平布置在同一块基板上,并通过中介层连接在一起,如下图所示。
2.5D封装利用中介层、连接线实现芯片间更短的信号传输距离和更低的电阻,因此相比2D封装具有好的散热性能和更高的带宽、更小的封装尺寸。
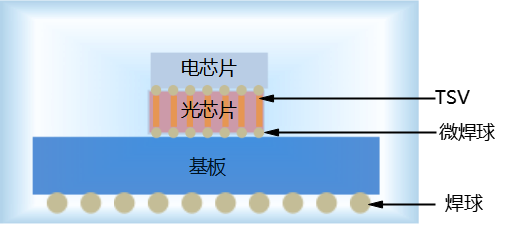
3D封装:3D封装好比建设摩天大楼,合理利用了封装内的垂直方向空间,通过TSV等垂直互联技术,实现更短互联距离和更小封装尺寸。
综上所述,2D、2.5D和3D封装主要异同参见下表。
| 项目 | 2D封装 | 2.5D封装 | 3D封装 |
|---|---|---|---|
| 芯片排列 | 平铺在基板上 | 在中介层上并排 | 垂直堆叠在基板上 |
| 互联长度 | 最长 | 较长 | 最短 |
| 封装尺寸 | 最大 | 较大 | 最小 |
| 功耗 | 最大 | 较大 | 最小 |
5 3D封装有哪些应用场景
3D封装在光模块中的应用正逐渐走向成熟,主要应用于以下场景。
数据中心高速互连:数据中心互连采用的400G/800G光模块,通过3D封装将光芯片、电芯片分层集成,使1U机架内模块密度提升2倍,同时缩短电光路径降低约30%信号损耗。
5G/6G网络应用:在前传微型化中,25G灰光模块采用3D封装技术,实现超薄设计(厚度<5 mm),通过TSV技术实现光电芯片垂直互联,满足基站严格的体积与散热要求。
总之,3D封装在芯片体积、性能和功耗等方面的显著提升,引领行业进入了一个新的时代。
根据知名产业分析机构YoleDéveloppement(Yole)预测,2025年先进封装占全球封装市场份额将接近50%。在先进封装市场中,2.5D/3D封装增速最快,2021年~2027年CAGR(年均复合增长率,Growth Rate)达14.34%。
英特尔已实现3D先进封装技术的大规模量产,在处理器的制造过程中,不仅能够以垂直而非水平方式堆叠计算模块,而且能够集成不同的计算芯片,优化成本和能效。
-
3D封装2013-06-22 11175
-
3D 模型封装2013-12-27 4366
-
带3D封装的PCB库2015-03-07 13030
-
3d封装2015-06-22 2897
-
3D PCB封装库2015-08-06 15282
-
altium designer 3D封装库2015-11-07 4126
-
带有3D的封装2015-11-27 4625
-
画PCB 3D封装问题2016-07-12 5202
-
关于AD16的3D封装问题2019-05-10 6760
-
如何让AD在3D显示下去除3D封装的显示?2019-09-23 17220
-
AD16的3D封装库问题?2019-09-26 5080
-
3D元件封装库2016-03-21 2845
-
Altium Designer 3D封装2017-02-28 2129
-
3D 封装与 3D 集成有何区别?2023-12-05 2660
-
AD 3D封装库资料2025-08-27 576
全部0条评论

快来发表一下你的评论吧 !

