

西门子Innovator3D IC平台荣获3D InCites技术赋能奖
描述
此前,2025年3月3日至6日,第二十一届年度设备封装会议(Annual Device Packaging Conference,简称DPC 2025)在美国亚利桑那州凤凰城成功举办。会上,西门子 Innovator3D IC 平台凭借其前沿技术和先进性能,荣获大会 3D InCites 技术赋能奖。
Innovator3D IC 平台
持续谱写创新优势
Innovator3D IC 平台是一款 AI 增强的协同设计工具,通过系统规划实现芯片、中介层、封装及 PCB 设计的数字连续性。其统一数据模型覆盖设计规划、原型和预测分析,支持如 UCIe、HBM 和 BoW 等行业标准接口。平台提供热、机械和电气性能的早期洞察,助力工程师减少设计迭代,加速开发,打造优化且可投入生产的 3D IC 设计,从而变革半导体设计的工作流程。
Innovator3D IC 平台凭借强大的功能和优势,自2024年9月推出起便在半导体行业引起广泛关注。平台采用西门子的 Aprisa 软件数字化 IC 布局布线技术、Xpedition Package Designer 软件、Calibre 3DThermal 软件、NX 机械设计软件、Tessent 测试软件,以及用于 Chiplet 之间 DRC、LVS 和流片 Signoff 的Calibre 3DSTACK 软件,助力推动 ASIC、Chiplet 和中介层的实现。
西门子拥有半导体封装相关技术的完整产品组合,并将其作为西门子 Xcelerator 的一部分交付市场。这些产品与 Innovator3D IC 紧密结合,能够帮助客户超越摩尔定律。
AJ Incorvaia
电路板系统高级副总裁
西门子数字化工业软件
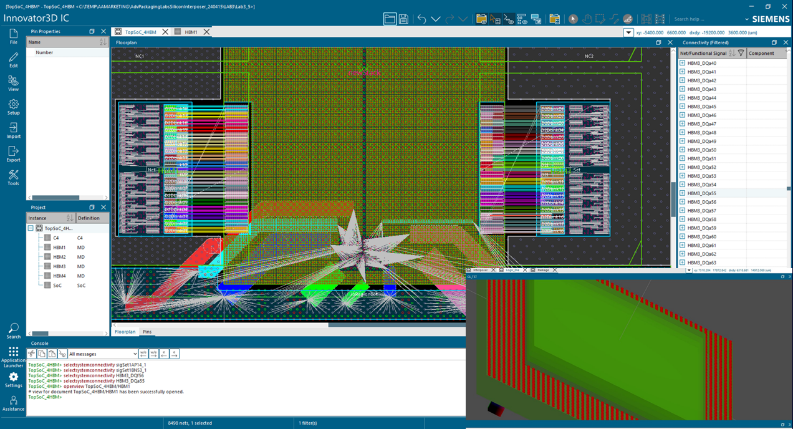
西门子助力半导体设计持续变革
Innovator3D IC 平台荣获 3D InCites 技术赋能奖,不仅是 DPC 2025 对西门子 Innovator3D IC 平台的认可,更是行业对西门子持续推动半导体设计创新的高度肯定。
DPC 2025是由国际微电子组装与封装协会(IMAPS)组织的重要国际知识交流论坛,汇聚来自全球的行业顶尖专家。今年的会议围绕异构封装相关技术举办多场研讨会,涵盖 2D 与 3D 集成、新兴技术、扇出型封装、晶圆级封装、面板级封装以及倒装芯片封装等多个主题。
随着 3D IC 封装技术的不断成熟,行业内的生态格局、设计流程、制造工艺等方面都将发生深刻变革。西门子将致力于持续提供前沿解决方案,助力企业提升自身竞争力,在复杂的市场环境中脱颖而出。
-
西门子Innovator3D IC异构集成平台解决方案2026-01-19 577
-
强强合作 西门子与日月光合作开发 VIPack 先进封装平台工作流程2025-10-23 4936
-
西门子数字化工业软件与台积电开展进一步合作2025-02-20 1333
-
西门子推出Calibre 3DThermal软件,持续布局3D IC热分析2024-06-28 1155
-
nepes采用西门子EDA先进设计流程,扩展3D封装能力2024-03-11 3564
-
芯和半导体荣获3D InCites “Herb Reiter 年度最佳设计工具供应商奖”2023-03-10 1275
-
西门子Tessent Multi-die解决方案实现2.5D/3D IC可测性设计自动化2022-10-17 2084
-
日月光半导体荣获3D InCites颁发的2021永续奖2021-04-10 2386
-
西门子收购Atlas 3D以扩展其3D打印业务2020-05-18 3095
-
西门子将在美国开设3D打印材料创新中心2020-05-13 2294
-
西门子采购Stratasys3D打印机,维护30年铁路2020-04-26 2698
-
3D打印客机有什么优势2020-01-18 3800
-
NVIDIA与西门子为医疗成像带来逼真的3D技术2009-12-03 1389
全部0条评论

快来发表一下你的评论吧 !

