

集成电路前段工艺的可靠性研究
描述
文章来源:学习那些事
原文作者:赵先生
在之前的文章中我们已经对集成电路工艺的可靠性进行了简单的概述,本文将进一步探讨集成电路前段工艺可靠性。
栅介质的经时击穿(TDDB)
在MOSFET器件里,栅极介质处于极高的工作电场环境中,这使得栅介质经时击穿(TDDB)成为集成电路里一种常见且极为关键的失效现象。具体来说,在强电场作用下,MOS器件的栅介质层会由于各种不同的原因,出现漏电或者被击穿的情况,进而致使整个器件无法正常工作。
通常,其失效机制如下:参照图1(a),在一段较长的时间里,缺陷不断累积,伴随着化学键的断裂以及空位的产生。严重的电流问题最终引发灾难性的热失控,使得电介质层被击穿。而局部出现的高密度电流以及由此产生的大量焦耳热,会在电介质内部形成丝状的导电通路。这会让MOSFET器件中原本相互隔离的多晶硅栅极与衬底短路,进一步导致阳极和阴极短路,如图1(b)所示。

图1:失效机制
在过去,有两种TDDB模型被广泛用于解释氧化物介质中电介质随时间推移发生击穿的失效机制。一个是电场驱动模型(E-Model或E-模型),另一个则是电流驱动模型(1/E- Model或1/E-模型)。
1.E模型
E模型也被叫做热化学击穿模型,它是基于共价键断裂建立起来的分子模型。SiO₂中的Si-O键有着很强的极性,大部分电子电荷会从Si原子转移吸附到O原子附近,于是在带正电的Si离子和带负电的O离子之间,就会产生电偶极子运动。当在栅氧化层上施加外加电场E时,电偶极子运动就会在电场方向产生极化电场P。此时,电子在穿越氧化层时所受到的电场力,是外加电场和极化电场的总和,差不多是外加电场的两倍。在这种局部强电场的持续作用下,分子的共价键会逐渐退化,直至最终断裂。由此可见,即便没有电流通过,只要有外加电场存在,栅氧化层最终也会出现退化并被击穿的情况。
2. 1/E模型
1/E模型也被称为空穴击穿模型,其建立的基础是福勒-诺德海姆(Fowler-Nordheim,F -N)隧穿电流。在早期,栅氧化层相对较厚,工作电压也比较大。按照1/E模型的物理解释,阴极端的电子会借助F-N隧穿效应进入到栅氧化层的导带中,随后在外加电场的作用下被加速。当电子获得足够的能量后,就会与SiO₂晶格发生碰撞电离,进而导致Si-O键受到损伤,产生电子陷阱和空穴陷阱。这些空穴陷阱的存在,会使得局部缺陷处的电场强度和隧穿电流不断增加,形成一个正反馈过程,促使缺陷持续增多,最终形成导电通道,将栅氧化层击穿。
而在实际的栅介质击穿过程中,这两种机制是同时存在的。所以,在当下先进的集成电路工艺里,为了评估栅介质的可靠性,一般会采用将两者相结合的电场-电流互补击穿模型 。
3. Vg模型
Vg模型也被称作陷阱产生模型。该模型指出,缺陷的产生与穿过栅氧化层的电子作用成正比,因此,所测量到的缺陷产生速率是施加在栅氧化层上电压的指数函数。对于超薄氧化层而言,其经时击穿模型遵循幂指数模型。具体过程为,隧穿电子在阳极端SiO₂和Si的交界面释放出H离子,这些H离子在外加电压的驱使下穿过氧化层,并与氧化层内的缺陷相互作用,对氧化层造成损伤,最终形成欧姆导电通道,致使氧化层被击穿。
4. 电场 - 电流互补击穿模型
考虑到在栅介质击穿过程中,电场诱导和电流诱导的电介质层退化机制会同时发挥作用,于是将场致退化和电流引发的退化整合到一个单一的TDDB模型中,“电场-电流互补击穿模型”由此形成,且该模型与测试结果契合度很高。一般认为,这一失效模型中TDDB的根本原因在于价键断裂、氧空位以及陷阱的形成。单位时间内价键断裂概率方程如下:

式1
其中,N代表沟道与栅介质界面区域中Si-O键的数量;k是键断裂率常数。对上述方程中的变量进行分离并积分,可得到:

式2
其中,TF表示失效时间,fcrit=(N/N0)crit是价键被破坏并最终导致器件失效的临界比例。通常认为,只需相对少量的键被打破,就会引发介质击穿,所以fcrit预计仅略小于1。
由上述积分后的方程可得出:

式3
倘若存在两个相互独立的键断裂机制k1和k2,那么假设总反应速率常数k是它们的总和,即k = k1 + k2,此时总反应速率变为:

其中,(TF)₁和(TF)₂分别是对应于键断裂机制k₁和k₂的失效时间。结合式3和上述总反应速率方程式4,能够得到:

式5
上述失效时间(TF)方程适用于相互独立却同时作用的退化机制。由此可知,如果(TF)₁大于(TF)₂,那么失效时间TF完全由(TF)₂主导,反之亦然。对于TDDB来说,当电场E高于10MV/cm时,基于电流的1/E模型可能在TDDB过程中占据主导;而当电场E在10MV/cm以下时,阳极空穴注入相对较少,电场主导的E模型可能在TDDB中占据主导地位。因此,结合E模型和1/E模型的物理特性,栅介质击穿时间可由式6描述:

式6
如图2所示为单一失效时间TF模型,它将基于场的E模型和基于电流的1/E模型合并成一个模型。在很高的电场(E>10MV/cm)下,电流诱导的退化起主导作用;而在较低的电场(E<10MV/cm)下,电场诱导的退化占主导地位。
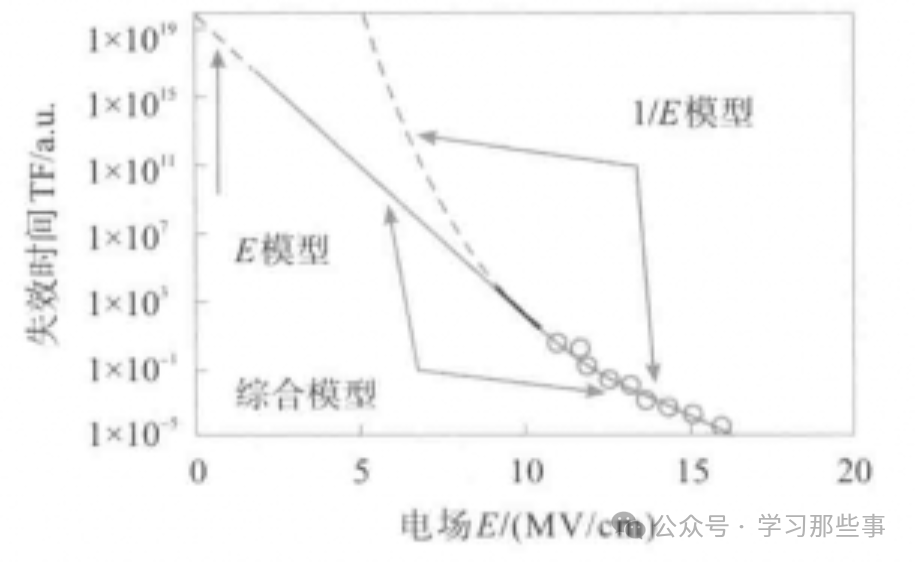
图2:E模型和 I/E 模型合并后得到的单一失效时间模型
尽管E模型已被广泛应用,并且在描述厚度大于4.0nm厚膜的低场TDDB数据方面颇为成功。然而,对于非常薄的氧化物(<4.0nm)而言,这些薄膜中的直接隧道电流可能会显著高于传统氧化物介质。这或许意味着,超薄氧化物薄膜中的失效更多是由电流注入而非电场作用所导致的。此外,不能仅仅将TDDB看作是MOSFET栅极氧化物或电容器氧化物特有的问题。实际上,在后段工艺中,随着低介电常数电介质的引入,互连的TDDB问题同样值得关注。
在介质内部,栅电流主导的空穴捕获现象对化学键断裂过程具有催化作用,进而在缺陷形成以及介质击穿的过程中扮演着关键角色。空穴一旦被捕获,会致使Si-O 键的结合能大幅下降。而键能的降低使得化学键在电场与热的共同作用下,更容易发生断裂。鉴于E模型在几乎所有情形下都能适用,因而普遍将其视作最为保守的TDDB模型。相对来说,互补模型则成为人们评估TDDB的最优选择。
互连电介质的TDDB数据,一般借助梳状 - 梳状或者梳状 - 蛇形测试结构来采集,如图3所示。此结构属于具有最小间距(即最小线宽与最小间距之和)的梳状蛇形测试结构。针对该结构所开展的击穿强度测量,或者获取的TDDB数据,能够作为评判该互连 - 介电结构性能优劣的关键指标。虽说低介电常数介电材料能够有效减少电路延迟,显著提升互连性能,然而在泄漏电流以及击穿强度等方面,相较于传统氧化物介质,它们在电学可靠性方面正面临着严峻的挑战。

图3:一种互连电介质测试结构
热载流子注入(HCI)
当载流子在强电场环境中运动时,若其从电场获取的能量大于在散射过程中与晶格原子碰撞所损失的能量,载流子的平均动能便会显著超出热平衡载流子的平均动能,此时载流子具备高于热能(kT)的能量,这种类似于被“加热”的载流子被称作热载流子。沟道热载流子注入(HCI)描述的是电子(或者空穴)沿着MOSFET的沟道加速,进而获取足够动能的过程(见图4)。这些载流子能够跨越存在于Si/SiO₂界面处的3.1eV势垒(针对电子而言)或者4.7eV势垒(针对空穴而言),进入到氧化层陷阱当中。当沟道电子从源极向漏极加速时,它们能够获取进入SiO₂层所必需的能量,尤其是那些处于玻尔兹曼分布尾部附近的“幸运电子”。由于MOSFET器件漏极附近的沟道电场最强,晶格电子在此处也极有可能发生碰撞电离,这些热载流子随后被散射至栅极氧化物。HCI会对界面造成损害,极有可能产生界面态。
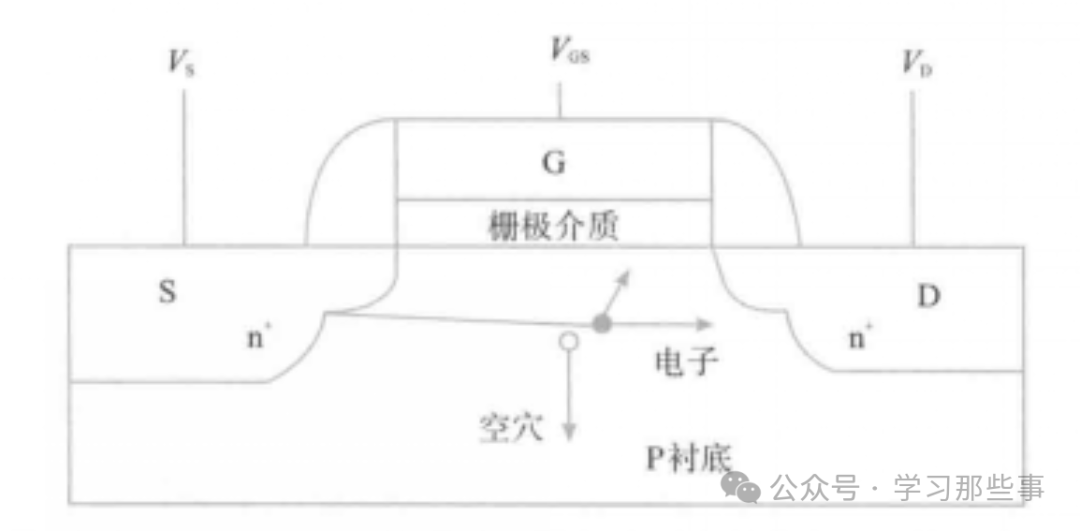
图4:沿NMOSOFT沟道移动的载流子从源极到漏极的加速过程
在这种HCI机制的作用下,界面态的生成以及电荷捕获现象会导致晶体管参数出现退化,特别是在先进技术中,载流子加速的沟道电场的增加速度要快于工作电压的降低速度。所以,HCI可能成为一种对MOSFET造成退化的重要机制。鉴于MOSFET属于场效应器件,硅衬底与SiO₂栅介质之间的界面显得尤为关键。通常情况下,该界面处的键断裂退化现象,会致使器件的稳定性受到影响,如图5所示。

图5:硅衬底和 Si0:栅极电介质之间的界面
硅衬底里的硅原子在晶格中构建起金刚石般的结构。而SiO₂层呈现非晶态结构,一个硅原子与四个相邻的氧原子形成化学键,每个晶格拐角处的氧原子则与相邻的两个硅原子相连。由于界面处晶格结构存在不匹配情况,并非所有硅键都能实现完美匹配,进而产生硅悬空键。一般在MOSFET制造环节会引入氢元素,用于钝化这些悬空键,防止它们带电。接下来将探讨Si/SiO₂界面处化学键断裂对MOSFET的影响。在SiO₂刚形成时,SiO₂内部以及Si/SiO₂界面就已存在一些断裂的键,部分Si-O键的结合能也较弱。依据费米能级的位置,这些悬空键可被视作电子陷阱、空穴陷阱,也可能呈中性状态。在MOSFET运行期间,这些陷阱、悬挂键会被电子、空穴填充,进而导致MOSFET的性能参数出现退化。对于MOSFET的可靠运作而言,界面稳定性至关重要。要是热载流子注入破坏了界面处的Si - H键,形成带电的Si悬空键,将会使MOSFET的工作参数发生退化。所以,为确保MOSFET稳定工作,界面必须维持相对稳定状态。
把某种特性P(比如Vth、gm、Idsat等)按时间t进行泰勒级数展开,由HCI导致的晶体管特性退化能够描述为:

式7
其中,B是与材料和器件相关的参数;m是HCI时间相关性的幂律指数,属于可调拟合参数,一般取值m≈0.5 。
针对N型MOSFET器件的热载流子注入(HCI)效应,其物理机制如图6所示:在漏极附近的高场区域,高能电子引发碰撞电离效应,伴随生成电子-空穴对。其中,部分高能电子被Si/SiO₂界面势垒捕获,在漏端附近微区诱发界面陷阱积累;而空穴则向衬底漂移形成特征电流Isub。值得注意的是,该衬底电流虽非直接损伤因子(实际致损机制为栅极电流引发的界面氧化层击穿),但因其与损伤程度的正相关性(相关系数>0.92),在工程测量中常作为等效应力参数。相较于需精密探针台的栅极电流测试,Isub的检测可通过集成衬底接触直接获取,这种测试便捷性使其成为工艺监控的关键指标。
通常用于计算N沟道晶体管的失效时间(TF)的表达式为

式8
Isub是应力期间的峰值衬底电流;w是晶体管的宽度;n是幂律指数,约等于3;Q是激活能,与沟道长度相关,一般在-0.25 ~ +0.25eV;A₀是与器件相关的参数,因器件不同而不同,会产生与失效时间相关的分布;k是玻尔兹曼常数;T为绝对温度。
将峰值衬底电流Iₛₚₖ除以晶体管宽度w,使得Isub / w成为真正意义上的应力,即大致与器件宽度无关。HCI的激活能较小,依据沟道长度可为正值也可为负值。通常仅在栅极长度小于0.25μm时才会观察到正值激活能。
从历史情况来看,由于空穴迁移率较低,且空穴注入势垒高度增加,P型MOSFET的HCI问题不太受关注。对于P沟道器件,有时栅极电流Igate是衡量器件实际应力的更优指标。因此,对于P沟道器件,HCI的失效时间方程一般写成:

式9
Igate是应力期间的峰值栅极电流;w是晶体管的宽度;n为幂律指数,一般在2-4之间;Q为激活能,通常在-0.25eV到+0.25eV 之间。
对于长沟道MOSFET,HCI退化建模通常采用N管峰值衬底电流Isub、P管峰值栅极电流Igate作为应力指标。在纳米工艺中,HCI诱导的电子俘获会直接衰减N管载流子迁移率,导致驱动电流下降。
尽管晶体管级的退化测量已较成熟,但IC失效预测仍存在两大难点:其一,实际电路中晶体管承受最大应力的时间占比可能极低(如高速开关管占空比<10%);其二,需明确电路参数(速度/功耗/漏电流)允许的晶体管退化阈值(5%-20%不等)。这些问题需要结合电路工作特性与架构冗余度进行综合评估。
鉴于上述种种因素,在某些情形下,采用经验方法来判定HCI对电路工作的影响,反而显得更为简便且精准。在这种经验手段中,先对IC内的器件进行抽样,随后在高于预期工作电压的电压水平下,针对器件与电路展开工作寿命测试。接着,将器件和电路级别的退化状况记录为应力时间的函数。借助从上述模型中能够轻松提取的加速因子,便可预测电路在正常运行阶段预计会出现怎样的退化情况。
负偏压温度不稳定性退化
负偏压温度不稳定性(NBTI)是集成电路可靠性的主要威胁之一。PMOS 晶体管在高温负栅压下会发生退化,表现为阈值电压绝对值升高,伴随迁移率、漏电流和跨导的衰减。这种退化源于 Si/SiO₂界面(图 7)的 Si-H 键断裂 —— 当器件工作时,界面处的 Si-H 键断裂产生悬挂键,直接导致性能劣化直至失效。由于 PMOS 在负栅压下工作,SiO₂内部电场由界面指向栅极,若 Si-H 键断裂释放 H+,离子会向远离界面方向漂移,这解释了为何 PMOS 的 NBTI 问题比 NMOS 的正偏压温度不稳定性(PBTI)更显著。不过在高 κ 栅介质器件中,PBTI 仍是需重点关注的退化机制。目前认为,Si-H 键断裂与工作时的空穴捕获相关,可能的反应式为:

式10
其中,Si-H代表正常的Si-H键;hole代表空穴;Si代表硅悬挂键;H⁺代表释放出的氢离子(质子)。由于存在电场作用,如图7所示

图7:P型MOSFET的Si/SiO₂界面
P型MOSFET在负栅极电压下工作,所以SiO₂层中的电场方向背离界面。若在器件工作时Si-H键断裂并释放出H⁺,其漂移方向会远离Si/SiO₂界面,也就是说上述反应产生的任何H⁺都趋向于离开Si/SiO₂界面。一旦H⁺产生,其输运方程为:

式11
ρ(x,t)是H⁺在任意时刻t、在距界面x处的浓度;D是H⁺的扩散系数;qE是作用在H⁺上的电场力;μ是H⁺的迁移率,D和μ通过爱因斯坦关系与扩散系数相关:

式12
从式11可以发现,由于电场E的存在,H⁺会朝着远离界面的方向移动,使得SiO₂内部H⁺浓度逐步上升。随着SiO₂电介质中H⁺浓度不断累积,可能出现H⁺向界面回流的情况。实际情形中,若电场消失(电场力为零),H⁺回流便会发生,进而让部分器件性能得到恢复。但H⁺通常不会完全回流至界面,因为在SiO₂栅极电介质内,部分H⁺可能会参与还原反应。可能存在的还原反应类型如下:

NBTI对P型MOSFET器件电学特性的影响十分突出:器件阈值电压会产生偏移,反型沟道内的空穴迁移率下降。Vth偏移与迁移率降低,均会导致器件沟道电流(I)减小,进而引发器件性能劣化。阈值电压Vth随时间变化的表达式为:

式13
其中,B0(E, T)是与电场E、温度T相关的因子;m为时间t的幂指数,取值通常在0.15 - 0.35范围内,一般取m = 0.25。
由于与时间关联的指数m小于1,随着时间延续,退化现象会趋向饱和。从图7所示模型中,能够推测出这种退化的饱和趋势。鉴于Si-H键数量有限,未断裂的Si-H键会随时间减少,由Si-H键断裂引发的器件退化速率也会随之降低。
-
集成电路可靠性介绍2025-12-04 1030
-
半导体集成电路的可靠性评价2025-03-04 2108
-
等离子体蚀刻工艺对集成电路可靠性的影响2025-03-01 1990
-
GaN功率集成电路的可靠性系统方法2023-06-19 834
-
集成电路封装可靠性设计2023-06-15 1953
-
集成电路的可靠性判断2023-06-14 3328
-
#硬声创作季 #集成电路 集成电路版图设计-9.12项目设计实例及技巧-芯片的可靠性1-闩锁效应水管工 2022-10-17
-
集成电路封装测试与可靠性2021-04-09 2418
-
集成电路在高可靠性电源的应用2019-06-11 1509
-
PoP的SMT工艺的可靠性2018-09-06 3046
-
集成电路可靠性检查的最佳实践方案2018-02-02 3039
-
集成电路芯片封装技术教程书籍下载2012-01-13 58024
-
半导体集成电路的可靠性设计2009-10-19 614
全部0条评论

快来发表一下你的评论吧 !

