

一种低翘曲扇出重构方案
描述
来源:芯片封装综述
翘曲(Warpage)是结构固有的缺陷之一。晶圆级扇出封装(FOWLP)工艺过程中,由于硅芯片需通过环氧树脂(EMC)进行模塑重构成为新的晶圆,使其新的晶圆变成非均质材料,不同材料间的热膨胀和收缩程度不平衡则非常容易使重构晶圆发生翘曲。
根据ASTM F1390,翘曲的定义为:
warpage = RPDmax-RPDmin

本期借助JCET(长电科技)公司Hu Zhen、Zhao Wei、Gu Xiao等人发表在Journal of Microelectronics and Electronic Packaging期刊的标题为Numerical Simulation on the Warpage of Reconstructed Wafer During Encapsulation Process的文章内容,分享他们的一种低翘曲扇出重构方案。
这种晶圆重构方法是先将晶圆分割成单个芯片,将单个芯片面朝下放置在临时键合载体上,然后将单个芯片通过临时键合膜粘贴在金属临时载体上,通过模压、整平和硅载板键合工艺完成最终构建的晶圆,工艺流程如上图所示。
这种方案就是在晶圆重构过程中,采用Face down工艺进行EMC重构,但是在常规重构工艺后又增加了一次平坦化与永久键合工艺,重构细节流程如下
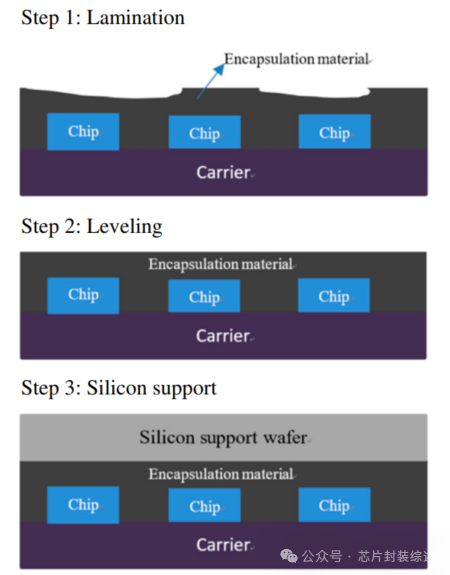
这种方案最关键的问题还是需要确定适用多大尺寸的芯片、芯片重构间距怎么控制、EMC模塑厚度的影响以及用于支撑的硅载板厚度影响等。
他们采用有限元方法研究了芯片厚度、扇出面积、封装材料性能和硅载板固化后对翘曲的影响。结果表明,晶圆翘曲随着塑封材料厚度的增加而逐渐增加,而低模量、小热膨胀系数的塑封材料会提高翘曲度。高模量、较厚的硅载板在减少翘曲方面具有显著作用,而较大的CTE硅载板也可以有效地减少晶圆翘曲,因为较大CTE的硅载板降低了与封装CTE的不匹配程度,更薄的芯片和更高的扇出面积往往会降低重构晶圆的翘曲。
有篇专利也讲述类似这种的翘曲降低方案(记不得哪家的专利和专利号了,仅供参考),专利中的翘曲降低方案是在Face down贴片后,在芯片背面通过粘接材料粘贴一层超薄金属网(粘接材料专利没写,应该是附带导热性能,采用金属网一方面是增加韧性降低翘曲,应该也有导热作用),然后EMC塑封。方案思路也是通过背面增加负载降低变形程度。
(注:如果有人怀疑粘贴金属网后可能影响塑封工艺,那也可以做两次塑封,第一次封到芯片等高(可通过研磨实现),然后粘贴金属网,然后再进行第二次塑封,专利内容记不太清,参考一下创新思路就行)
全部0条评论

快来发表一下你的评论吧 !

