

水平式光刻胶剥离工艺及白光干涉仪在光刻图形的测量
电子说
描述
引言
在半导体制造和微纳加工领域,光刻胶剥离是光刻工艺的重要环节。水平式光刻胶剥离工艺凭借其独特优势在工业生产中占据一席之地,而准确测量光刻图形对保障工艺质量、提升产品性能至关重要,白光干涉仪为此提供了可靠的技术手段。
水平式光刻胶剥离工艺
工艺特点与原理
水平式光刻胶剥离工艺将基片水平放置,通过特定的剥离设备使剥离液均匀覆盖基片表面,与光刻胶发生化学反应或物理作用,实现光刻胶的去除。该工艺相比传统垂直式工艺,剥离液在基片表面分布更均匀,能够有效避免因液体重力导致的剥离液分布不均问题,减少光刻胶残留和基片表面损伤风险。其原理主要基于剥离液对光刻胶的溶解、溶胀或化学反应,破坏光刻胶与基片之间的结合力,促使光刻胶从基片表面脱落。
工艺流程
首先,将完成光刻工艺的基片平稳放置于水平式剥离设备的载片台上,确保基片表面水平。随后,通过泵体将剥离液输送至基片表面,采用喷淋或旋转涂覆等方式,使剥离液快速且均匀地覆盖基片。在剥离液与光刻胶充分接触反应的过程中,依据光刻胶类型和剥离液特性,控制反应时间和温度。反应结束后,利用去离子水对基片进行冲洗,去除残留的剥离液和光刻胶碎屑,最后通过氮气吹干或热风干燥等方式使基片干燥,完成光刻胶剥离流程。
工艺优势与挑战
水平式光刻胶剥离工艺的优势显著,它能有效提高光刻胶剥离的均匀性和一致性,适用于大尺寸基片的剥离处理,在大规模生产中可提升产品良率。同时,水平放置的基片便于观察和检测剥离过程。然而,该工艺也面临一些挑战,如对设备的密封性和液体输送系统要求较高,以防止剥离液泄漏和挥发;并且需要精确控制剥离液的流量和覆盖时间,否则可能影响剥离效果,导致光刻胶残留或过度剥离。
白光干涉仪在光刻图形测量中的应用
测量原理
白光干涉仪基于光的干涉原理,将白光光源发出的光经分光镜分为测量光和参考光。测量光照射到待测光刻图形表面反射回来,与参考光相遇产生干涉条纹。由于光刻图形不同位置的高度差异,致使反射光的光程差不同,进而形成不同的干涉条纹图案。通过分析干涉条纹的形状、间距和强度等信息,结合光程差与表面高度的对应关系,可精确计算出光刻图形的高度、深度、线宽等参数。
测量优势
白光干涉仪具备高精度、非接触式测量的特点,其测量精度可达纳米级别,能够精准捕捉光刻图形细微的尺寸变化。非接触测量避免了对脆弱光刻图形的物理损伤,保证了样品的完整性。此外,该仪器测量速度快,可实现实时在线检测,并能通过专业软件对测量数据进行可视化处理,直观呈现光刻图形的形貌特征,便于工艺优化和质量控制。
实际应用
在水平式光刻胶剥离工艺中,白光干涉仪在多个环节发挥重要作用。剥离前,可测量光刻胶的厚度、光刻图形的初始形貌,评估光刻工艺的质量;剥离过程中,实时监测光刻胶的去除情况,判断剥离进程是否正常;剥离完成后,精确测量残留光刻胶的厚度、基片表面的粗糙度以及光刻图形的最终尺寸,为后续工艺提供准确的数据支持,确保产品符合设计要求 。
一款可以“实时”动态/静态 微纳级3D轮廓测量的白光干涉仪
1)一改传统白光干涉操作复杂的问题,实现一键智能聚焦扫描,亚纳米精度下实现卓越的重复性表现。
2)系统集成CST连续扫描技术,Z向测量范围高达100mm,不受物镜放大倍率的影响的高精度垂直分辨率,为复杂形貌测量提供全面解决方案。
3)可搭载多普勒激光测振系统,实现实现“动态”3D轮廓测量。

实际案例

(以上为新启航实测样品数据结果)
1,优于1nm分辨率,轻松测量硅片表面粗糙度测量,Ra=0.7nm

(以上为新启航实测样品数据结果)
2,毫米级视野,实现5nm-有机油膜厚度扫描
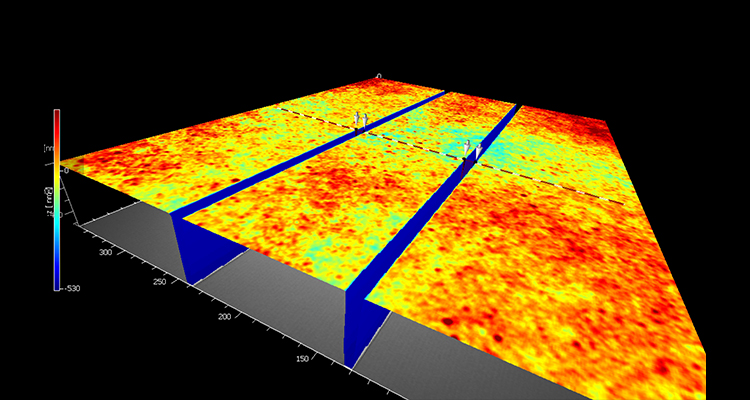
(以上为新启航实测样品数据结果)
3,卓越的“高深宽比”测量能力,实现深蚀刻槽深槽宽测量。
审核编辑 黄宇
-
光刻胶剥离工艺2025-09-17 2427
-
白光干涉仪在晶圆光刻图形 3D 轮廓测量中的应用解析2025-09-03 1179
-
改善光刻图形垂直度的方法及白光干涉仪在光刻图形的测量2025-06-30 825
-
针对晶圆上芯片工艺的光刻胶剥离方法及白光干涉仪在光刻图形的测量2025-06-25 1287
-
金属低蚀刻率光刻胶剥离液组合物应用及白光干涉仪在光刻图形的测量2025-06-24 936
-
用于 ARRAY 制程工艺的低铜腐蚀光刻胶剥离液及白光干涉仪在光刻图形的测量2025-06-18 1059
-
低含量 NMF 光刻胶剥离液和制备方法及白光干涉仪在光刻图形的测量2025-06-17 945
-
金属低刻蚀的光刻胶剥离液及其应用及白光干涉仪在光刻图形的测量2025-06-16 964
-
减少光刻胶剥离工艺对器件性能影响的方法及白光干涉仪在光刻图形的测量2025-06-14 1052
-
光刻胶剥离液及其制备方法及白光干涉仪在光刻图形的测量2025-05-29 1522
-
Micro OLED 阳极像素定义层制备方法及白光干涉仪在光刻图形的测量2025-05-23 881
-
光刻胶的图形反转工艺2024-07-09 2415
-
光刻胶在集成电路制造中的应用2018-08-23 7424
-
光刻胶2018-07-12 2997
全部0条评论

快来发表一下你的评论吧 !

