

电子束曝光与显影工艺解读
描述
文章来源:老千和他的朋友们
原文作者:孙千
EBL就像是纳米世界里的精密画笔,能够在极其微小的尺度上"画"出任何你想要的二维图案。
说到纳米制造,不得不提电子束光刻(EBL)。简单来说,EBL就是用高度聚焦的电子束来"写字"。想象一下,你拿着一支超级细的笔,在一块特殊的材料(叫做抗蚀剂)上写字。这支"笔"就是电子束,而"墨水"就是电子。当电子束照射到抗蚀剂上时,就会改变这种材料的性质,让它在后续的显影过程中变得更容易或更难溶解。这样,通过控制哪些地方被照射,就能"画"出想要的图案。

图1 在正性光刻胶层中形成纳米级图案的电子束光刻(EBL)工艺步骤概述
有趣的是,EBL最初其实是从扫描电镜发展而来的。工程师们很聪明,他们想:"既然这个显微镜能产生这么细的电子束,为什么不用它来做点别的呢?"于是他们加了个图案发生器和束流消隐器,就把观察用的显微镜改造成了能够精确控制曝光区域的"画笔"。
现在的EBL设备可就厉害多了,完全是为了图案化而专门设计的。它们配备了高亮度的电子源,就像换了个超级强力的"灯泡",让写字速度更快。还有高分辨率的机械载台,能够精确地移动样品,确保在电子束相对狭窄的聚焦范围内,也能把整个大基板都写完。

图2 电子束曝光系统:(a) 示意图,(b) Raith 150TWO商用电子束光刻系统
EBL的优点很诱人:分辨率超高,而且不需要掩膜就能创建任意图案。这意味着你想画什么就画什么,完全自由发挥,不像传统的光刻技术那样需要先制作昂贵的掩膜。
但是,天下没有免费的午餐。EBL最大的问题就是慢!写一个复杂的大图案可能需要好几个小时甚至几天。这就像用毛笔一笔一划地写书法,虽然精美,但效率确实不高。
为了解决这个问题,研究人员也在努力,比如开发投影EBL技术,或者使用大规模并行束(就是同时用很多支"笔"一起写)。不过这些技术还在发展中,所以现在我们主要还是聚焦在单束直写EBL上。
EBL的终极目标就是在抗蚀剂中实现四个"高":高分辨率、高密度、高灵敏度、高可靠性。这四个目标听起来简单,但要同时达到可不容易,它们之间的关系复杂得像一团乱麻。
想要达到这些目标,关键要素包括:电子光学器件的质量(能不能产生超细的束斑)、抗蚀剂、基板和显影剂的选择,以及各种工艺条件,比如电子束的能量和剂量,显影的时间和温度等等。
当然,现实总是比理想复杂。EBL面临的挑战也不少:
首先是邻近效应,这是由于电子的前向和后向散射造成的。电子束打到材料上后,不会老老实实地停在原地,而是会到处乱跑,影响周围的区域。然后还有图案塌陷的问题,这是由于材料膨胀和毛细管力造成的,就像盖房子时地基不稳一样。最后还有线边缘粗糙度的问题,就是画出来的线条边缘不够光滑,有波动。
电子传输
就像开车需要一辆好车一样,电子束光刻首先需要一个靠谱的电子源。这里最受欢迎的是热场发射电子源,它就像一个稳定的"电子发射器",能够持续不断地提供高质量的电子束。想象一下,如果你的手电筒忽明忽暗,你还怎么在黑暗中精确地做细活呢?
电子束的质量主要靠各种光学器件来调节,就像相机的镜头一样,需要精确聚焦才能得到清晰的图像。这些器件必须做到位置精准、减少像散,并且能把电子束聚焦到几纳米的小点上。听起来很难对吧?但现在的商业设备已经能做到这个水平了。
为了避免气体分子对电子束的干扰,整个电子镜筒都被放在真空环境中。但即使在真空中,电子们也不是完全"听话"的。就像同性相斥一样,电子之间会相互排斥,导致束流发散。这种现象在电流大、能量低的时候特别明显,就像高峰期的道路一样,车越多越容易堵塞。
当电子束进入抗蚀剂材料后,真正的挑战才开始。电子们会经历一系列的"碰碰车"游戏——每次碰撞都会让它们稍微改变方向。这种前向散射会让原本笔直的电子束变得越来越宽,就像水流冲击沙滩时会逐渐扩散一样。

图3 电子束在光刻胶中由于前向散射导致的束斑展宽,入射能量为(a) 3 keV和(b) 10 keV。图中显示的是两条平行线的光刻胶曝光预测截面
更有趣的是后向散射现象。大部分电子会一路穿过抗蚀剂,深入到基板中。但其中一些"调皮"的电子会在基板里经历大角度碰撞,然后"迷路"般地重新出现在抗蚀剂中,而且位置可能离原来的入射点好几微米远。这就像你在一个复杂的地下停车场里,本来想直接到达目的地,结果绕了一大圈又回到了起点附近。
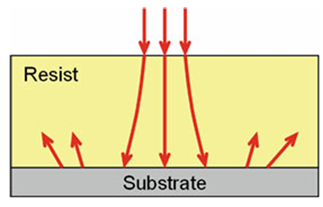
图4 电子在光刻胶和衬底中的前向散射和背向散射导致束流展宽和邻近效应
后向散射带来的最大问题是邻近效应。设想你在纸上画精密图案,结果发现在一个地方画线时,附近的地方也会意外地留下痕迹。这就是邻近效应的写照——在某个位置写入特征的电子会影响到附近区域的曝光,导致图案失真和过度曝光。这就像是一种"牵一发而动全身"的效应,让图案的密度成为了决定曝光水平的重要因素。
还有一类叫做二次电子的"小角色"也不容忽视。当高能电子撞击材料时,就像撞击产生火花一样,会产生一些能量较低的二次电子。虽然它们的能量不高,活动范围也就几纳米,但在追求极致精度的电子束光刻中,连这些"小火花"都可能成为限制分辨率的因素。
最后一个头疼的问题是静电充电,特别是在绝缘材料上工作时。如果电子被吸收后没有地方"泄洪",就会像静电一样积聚起来,最终影响电子束的聚焦效果。解决办法也很直接:在抗蚀剂上下加一层薄薄的导电层,给电子提供一个"逃生通道"。
抗蚀剂
当高能电子束照射到抗蚀剂表面时,就像是在进行一场微观的撞球游戏。电子与抗蚀剂分子发生非弹性碰撞,产生电离现象,同时还会"撞"出二次电子。这个过程不仅仅是物理上的碰撞,更重要的是引发了抗蚀剂内部的化学反应,让材料的性质发生根本性的改变。与光学光刻一样,EBL可以采用两类抗蚀剂。
1. 正性抗蚀剂:从"顽固"到"听话"
正性抗蚀剂有点像那些"吃软不吃硬"的材料。在电子束照射下,它们会从原本难以溶解的状态变成容易溶解的状态。
最典型的例子就是PMMA(聚甲基丙烯酸甲酯)。想象一下,PMMA就像是一根根超长的项链,由无数个小珠子(单体)串联而成。当电子束"攻击"这些长链时,就像是用剪刀在项链上随机剪断,把原本的长链分解成许多短小的片段。这些小片段比原来的长链更容易在显影液中溶解,就像把大块的冰糖敲碎后更容易在水中融化一样。
另一个常见的正性抗蚀剂是ZEP 520,它的工作原理也类似——都是通过断链反应来实现溶解性的转变。
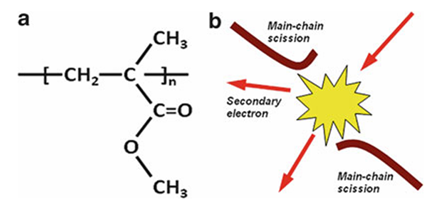
图5 (a) 聚甲基丙烯酸甲酯的聚合物亚单元,以及 (b) 电子束光刻曝光过程中聚合物链的断裂
2. 负性抗蚀剂:团结就是力量
负性抗蚀剂的表现则截然不同,它们遵循"团结就是力量"的原则。电子束照射后,这些材料不是被分解,而是发生交联反应,小分子"手拉手"形成更大的分子网络。
HSQ(氢倍半硅氧烷)就是这方面的典型代表。在电子束的作用下,原本相对较小的聚合物分子会互相连接,形成更大、更难溶解的聚合物网络。这就像是把散落的乐高积木拼接成一个大的结构体——单个积木容易移动,但拼接后的结构就稳固多了。
让我们再深入了解一下最常用的正性抗蚀剂PMMA。这种材料的分子链长度通常以分子量来衡量,常见的有496和950 kDa(千道尔顿)两种规格。这些数字看起来很抽象,但它们代表着分子链的"身材"——数字越大,链越长。
由于PMMA的分子链非常长,要让它们变得可溶,就需要发生很多次断裂事件。这就像要把一根很长的绳子剪成小段——剪一两刀是不够的,需要多次剪切才能让每一段都足够短。
有趣的是,电子束的曝光剂量直接影响着PMMA片段的大小分布。随着剂量的增加,平均片段尺寸会逐渐减小,在显影剂中的溶解度也相应增加。这就像是调节"剪刀"的力度——用力越大,剪出的片段越小,越容易溶解。
但现实情况比这更复杂。由于电子散射的存在,剂量在空间上并不是均匀分布的,而是呈现出复杂的三维分布模式。这种不均匀性直接影响着断裂事件的空间分布,进而影响整个图像的形成质量。

图6 (a) 在10 keV条件下不同剂量的PMMA碎片尺寸分布计算结果。 (b) 单点曝光时抗蚀剂内小碎片(少于10个单体)体积分数的空间分布
抗蚀剂显影
想象一下,你有一块涂了特殊涂料的板子,经过电子束"照射"后,这些涂料分子就像受了刺激一样,要么变得特别容易溶解(正性抗蚀剂),要么变得特别顽固(负性抗蚀剂)。显影就是用特定的溶剂把该溶解的部分"洗掉",留下我们想要的图案。
这个过程中,温度和时间就像是调味料一样重要。温度高一点,时间长一点,溶解的就更彻底。就拿PMMA这种材料来说,如果用"冷显影",就只有那些最小的分子片段会被溶解掉,其他的都"冻"在那里不动。这样做的好处是分辨率特别高,因为那些散射电子造成的"意外曝光"根本达不到溶解的门槛。
显影的时候,溶剂就像小侦探一样,渗透到聚合物里面,开始包围那些被"打散"的分子片段。这时候会形成一种叫"凝胶"的东西,厚度取决于分子被打散的程度和溶剂的"脾气"。
有意思的是,聚合物还会发生溶胀,就像海绵吸水一样。一旦片段被溶剂完全包围,它们就会从基体中脱离出来,扩散到溶剂中。这里有个规律:片段越长,越难移动,和基体的结合越牢固,溶解时间就越长。
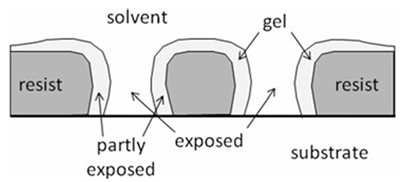
图7 正性光刻胶在显影过程中的情况。聚合物-溶剂相互作用可导致凝胶形成和溶胀
这里有个很巧妙的地方:曝光和显影其实是可以"互补"的。短时间曝光配合长时间显影,效果可能和长时间曝光配合短显影差不多。这就像做菜一样,火候和时间可以互相调节。
不过这也带来了一个问题:有时候分不清到底是曝光不足还是显影不够,或者是过度曝光还是过度显影。这就需要经验和仔细的调试了。
为了更好地控制这个过程,科学家们通常会用溶剂混合物,比如PMMA常用的1:3甲基异丁基酮与异丙醇的混合物。这就像调鸡尾酒一样,不同的配比会产生不同的效果。
如果显影时间太长或者溶剂太强,就会出现问题。抗蚀剂和基底的结合会变差,而且当溶剂被移除时,毛细管力会搞破坏,导致抗蚀剂结构坍塌。这就像搭积木时底座不稳,整个结构都会倒塌。
相邻的线性特征特别容易出现这个问题,尤其是当抗蚀剂比较厚的时候。想象一下,如果你用很细的竹签搭建一个高塔,稍微不注意就会倒塌。
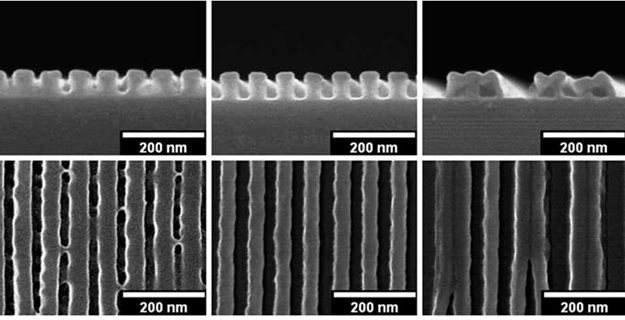
图8 PMMA光栅结构的横截面图(上)和平面图(下)。图中显示了曝光不足/显影不足的结构(左),优质结构(中)和塌陷图案(右)
工艺参数总览
如上所述,有大量参数以复杂的相互作用方式影响EBL工艺。表1给出了部分清单。这不包括次要因素,如抗蚀剂聚合物链长度(可影响敏感性和对比度),或使用超声搅拌等技术来减少显影时间和改善清除效果,或使用临界点干燥来最小化图案坍塌。
当然,操纵这些参数的目标是实现高分辨率、高质量、高通量的结果,并具有大的工艺窗口以最大化产量和重现性。
表1 影响EBL工艺的参数
| 参数 | 工艺影响 |
| 曝光能量 | 分辨率、灵敏度、邻近效应 |
| 曝光剂量 | 图案质量 |
| 图案密度 | 邻近效应、图案质量 |
| 光刻胶材料 | 灵敏度、分辨率、对比度 |
| 光刻胶厚度 | 灵敏度、分辨率、图案质量 |
| 显影剂 | 灵敏度、分辨率、显影窗口 |
| 显影温度 | 灵敏度、分辨率、曝光窗口 |
| 显影时间 | 灵敏度、分辨率、曝光窗口 |
图9显示了这些工艺依赖性的一个例子,显示了剂量对单像素线光栅的影响。虽然在所有三个剂量下结构都得到了良好的分辨,但最终结构的尺寸变化很大。
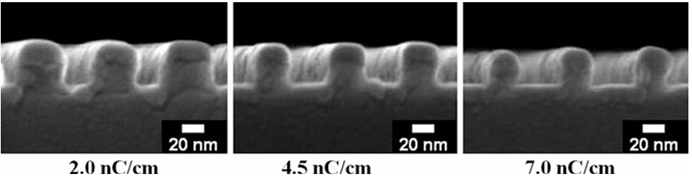
图9 使用30 keV电压和不同线剂量制备的70 nm节距PMMA光栅的横截面轮廓。样品在15°C下显影15秒,初始PMMA厚度为55 nm
PMMA抗蚀剂的工艺窗口:纳米制造的精妙平衡
想象一下,你正在用一支极其精细的画笔在比头发丝还要细千倍的画布上作画。这就是电子束光刻技术面临的挑战,特别是当我们要制造那些小到只有20纳米的微结构时。
说到20纳米,这到底有多小呢?如果把人类头发比作一条高速公路,那20纳米就相当于公路上的一颗小石子。在这个尺度上,我们使用的PMMA抗蚀剂就像是一种特殊的"油漆",电子束就是我们的"画笔"。问题是,这支画笔太过敏感,稍微用力过猛就会把画布戳破,用力太轻又画不出清晰的线条。
从图10的实验结果来看,制造高质量的纳米光栅就像是在走钢丝。每个参数都必须恰到好处:
对于70纳米间距的光栅,情况还算友好。就像用粗一点的画笔画画,除了用力过猛的情况(125 μC/cm²),其他条件下都能得到不错的效果。
但当我们试图制造更精密的结构时,比如40和50纳米的光栅,工艺窗口就开始收缩了。只有在50-75 μC/cm²这个"黄金区间"内,才能获得令人满意的结果。
最具挑战性的是30纳米光栅,这时候工艺窗口窄得像针眼一样。只有在60 μC/cm²这个特定剂量下,才能勉强得到可用的结构。

图10 在硅基底上65纳米厚的PMMA层中制作的30、40、50和70纳米光栅的SEM图像,采用10 keV曝光,不同面积剂量。光栅在室温下用1:3 MIBK:IPA溶液显影5秒。所有图像的横向尺寸为1毫米×1毫米。平均面积剂量与线剂量的关系为darea = dline/l,其中l为线间距离(光栅节距)
在这个精密的制造过程中,稍有不慎就会出现各种问题,就像烹饪一样:
火候不够:曝光剂量太低就像火候不够,PMMA没有充分反应,结果就是图案模糊不清,对比度很低。
火候过头:曝光过度就像把菜炒糊了,PMMA被过度清除,原本精细的结构变得面目全非。
结构坍塌:这是40纳米以上光栅的常见问题,就像房子的墙壁太薄,承受不住重量而倒塌。
相分离现象:这是30纳米光栅的特有问题。想象一下油和水的混合物,当条件不当时,PMMA会像油珠一样重新聚集,形成不规则的岛状结构,完全破坏了原本的图案。
图11很好地总结了整个情况:随着光栅节距的减小,能够获得高质量结果的"甜区"越来越小。这就像是在打靶,靶心越小,命中的难度就越大。
工艺窗口的宽度就像是这个靶心的大小,它决定了制造工艺的稳健性。窗口越大,意味着即使参数有小幅波动,也能得到合格的产品。这对于大规模生产来说至关重要,因为没有人希望制造出来的产品质量完全靠运气。

图11使用10 keV电压时PMMA中不同光栅周期和面积曝光剂量的特征形貌图。实心符号表示来自图2.9的实验结果:三角形表示曝光不足边界(清除不充分);菱形表示过度曝光边界(过度清除);圆形表示导致胶束化图案的塌陷或相分离边界。空心符号显示数值建模结果
从实验结果可以看出,在当前的条件下,能够稳定制造的最小结构大约是15纳米半节距。这已经是相当了不起的成就了,要知道这比病毒还要小得多。而目前最先进的商业化半导体制造工艺,半节距约为6-8纳米(3纳米工艺)。正在研发中,预计半节距约为4-5纳米(2纳米工艺)。
但这也告诉我们,要继续推进技术边界,我们需要在抗蚀剂设计、曝光策略和显影技术方面寻求新的突破。就像爬山一样,每向前一步都比前一步更加困难,但正是这种挑战推动着科技的进步。
总的来说,PMMA抗蚀剂的工艺窗口研究揭示了纳米制造的复杂性和精密性。虽然挑战重重,但每一次技术突破都让我们离制造出更小、更精密的器件又近了一步。这就是科技进步的魅力所在——在看似不可能的地方找到可能。
温度是个好东西——聊聊光刻胶工艺窗口的温度依赖性
说到光刻胶,大家可能觉得这东西挺神秘的,但其实它的工作原理并不复杂。今天我们来聊聊温度对光刻胶工艺窗口的影响,看看为什么调控温度能让我们做出更精细的纳米结构。
备注:抗蚀剂(Resist)是一个更广泛的概念,光刻胶(Photoresist)是抗蚀剂的一种特殊类型。
想象一下,光刻胶显影就像是在"大扫除"。当光刻胶被曝光后,那些被强烈照射的区域会产生很多小分子碎片,这些碎片需要在显影过程中被"清理"掉。这个清理过程实际上是一个动力学扩散过程——小分子们要靠"游泳"才能从材料中跑出来。
科学家们用扩散系数D来描述这些分子的迁移能力:D = n^(-a) × exp(-U/kT)。
这个公式看起来有点复杂,但道理很简单:分子越小(n越小),温度越高(T越大),它们就越容易移动。其中那个神秘的指数a,在不同的聚合物中从1变化到2,反映了材料的致密程度。
这里有个有趣的现象:适用的曝光剂量范围(就是我们说的"剂量窗口")会随着温度变化而变化。研究人员发现,这个窗口的上下边界都遵循一个指数关系:
dmin,max = dmin,max^ref × exp[-U/ak × (1/T - 1/Tref)]
听起来很学术,但实际效果却很惊人。当他们用70纳米间距的光栅做实验时,发现把显影温度从室温降到15°C,剂量窗口居然能拓宽五倍以上!这意味着什么?意味着工艺的容错性大大提高了,不用那么精确地控制曝光剂量也能得到好结果。
更有趣的是分辨率的提升。实验结果相当惊人:
室温显影:70纳米间距的光栅,能做出33±2纳米的线条
10°C显影:50纳米间距的光栅,线宽缩小到20±2纳米
-15°C显影:40纳米间距的光栅,线宽进一步压缩至15±2纳米
这个进步可不是一点点!随着温度降低,能制造的最小特征尺寸显著减小,这对纳米制造来说是个重大突破。
当然,世界上没有免费的午餐。低温显影虽然能提高分辨率和工艺窗口,但也会带来一个问题:工艺灵敏度下降。简单说就是,要达到同样的效果,你需要更多的曝光剂量。
这就像开车一样,你想要更好的操控性(更宽的工艺窗口),就得牺牲一些动力性能(灵敏度)。在实际应用中,需要根据具体需求来权衡这两者的关系。
为什么低温会有这样的效果?回到我们前面提到的扩散系数公式,温度降低时,分子的迁移率会按指数规律下降。这意味着那些应该被清理掉的小分子碎片移动得更慢,需要更长时间才能扩散出去。
但同时,这也让侧壁区域的分子扩散变慢,减少了不该被清理的地方被误伤的可能性。这就像精细手术一样,动作慢一点,反而能做得更精准。
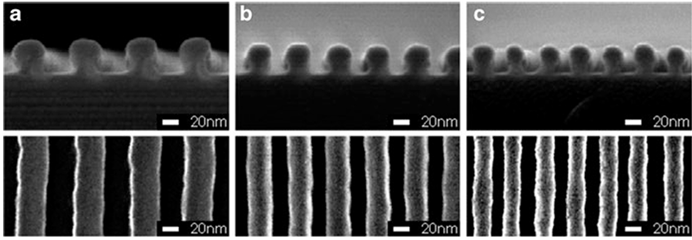
图14横截面和俯视SEM显微照片,展示了使用Raith 150系统在10 keV电压下于PMMA中制备的优化致密纳米级光栅的实例,采用了不同的显影温度:(a) 室温,70 nm间距;(b) 10°C,50 nm间距;(c) 15°C,40 nm间距
电子束剂量与显影时间的相互依赖性
研究人员做了个有趣的实验,他们在PMMA材料上刻出50纳米的超细光栅图案。结果发现,随着显影时间的延长,所需的最小和最大电子束剂量都会适度下降。这就好比泡茶时间越长,茶叶用量可以相应减少一样。
更精彩的是另一组实验。科学家们用不同的电子束剂量照射70纳米间距的光栅,然后在15°C下显影0.5到32秒不等。神奇的是,尽管工艺条件完全不同,有些图案的沟槽宽度竟然非常接近!
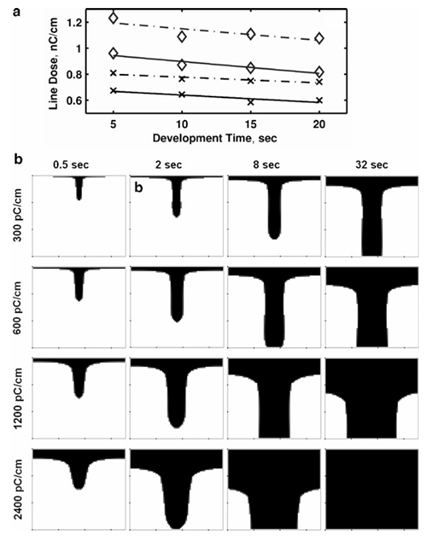
图15 (a) 50 nm间距光栅在PMMA中的适用剂量窗口,显示了优质图案化的最小线剂量(实线)和最大线剂量(虚线)。符号表示显影温度为5°C(叉号)和15°C(菱形)。(b) 在70 nm间距周期性光栅中,使用10 keV电压以不同线剂量曝光,并在15°C下显影不同时间后计算得出的抗蚀剂清除轮廓。所有方框的宽度均为70 nm,高度为60 nm。白色表示未溶解的PMMA,黑色表示清除区域
这个现象其实不难理解。显影过程本质上是一个扩散过程——被光照射过的材料碎片要"游泳"到溶剂中去。根据菲克扩散定律,这个过程遵循一个简单的数学关系:扩散距离与时间的平方根成正比。
换句话说,沟槽宽度Δx大致遵循这样的关系:Δx ∼ dt^(1/2),其中d是剂量,t是时间。
电压选择:高低各有千秋
说到电子束光刻,电压的选择真是个让人头疼的问题。就像买车一样,你得在各种性能之间做权衡。
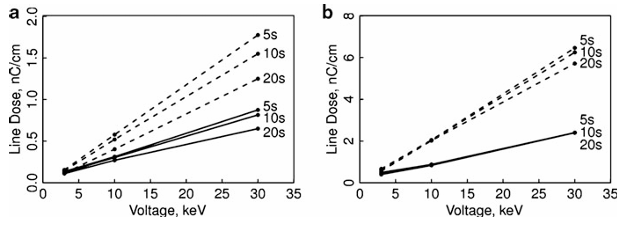
图16 在室温(a)和15°C(b)条件下,不同显影时间对70 nm间距光栅在3、10和30 keV曝光电压下的适用线剂量窗口。初始PMMA厚度为55 nm。实线和虚线的含义与图15相同
3 keV这样的低电压,优点是灵敏度高,也就是说用更少的"电子子弹"就能把图案"刻"出来,效率挺不错。而且最大的好处是邻近效应小——简单说就是你想刻A图案,结果不会意外地影响到旁边的B图案。这对精密加工来说很重要。
但是低电压也有烦人的地方:电子容易"走歪"(前向散射强),导致刻出来的线条不够直,底部还会被掏空,像个倒梯形。这种结构不够稳定,容易倒塌。
30 keV这样的高电压就不一样了。虽然灵敏度降低了,需要更多的电子才能完成曝光,但刻出来的线条更直更垂直,质量更好。而且剂量窗口更大,也就是说工艺容错性更强。
不过高电压也有自己的问题:电子能量太高,会钻到基板里去,然后被"弹"回来影响周围区域,这就是邻近效应。就像扔石头到水里,能量越大,涟漪传得越远。
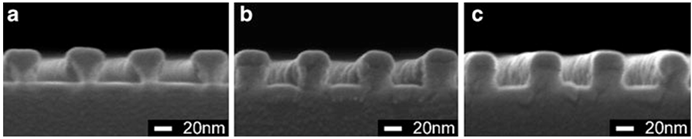
图17 在3 keV (a)、10 keV (b)和30 keV (c)电压下制备的70 nm节距光栅横截面轮廓的SEM图像
怎么选择?其实没有标准答案,关键看你的具体需求。如果要做高精度的小尺寸图案,低电压可能更合适;如果要做大面积的稳定结构,高电压可能是更好的选择。
有趣的是,现在有些研究还利用低电压的前向散射特性来制作三维纳米结构,把"缺点"变成了"特色功能"。这就像把汽车的噪音改造成音响系统一样,创意十足。
总的来说,电压选择就是个平衡游戏,没有完美的方案,只有最适合的方案。
-
简单认识电子束曝光技术2026-02-10 594
-
光刻工艺中的显影技术2025-06-09 3337
-
电子束技术的原理与应用概览2024-04-30 4686
-
电子束加工与离子束加工工艺比较2023-12-07 3706
-
电子束曝光原理_电子束曝光结构2020-11-27 12064
-
电子束焊分类_电子束焊的技术指标2020-09-03 10470
-
电子束焊是什么意思_电子束焊的应用2020-09-02 10435
-
电子束焊原理_电子束焊特点2019-12-10 17420
-
现代焊接技术中的电子束焊接技术2018-03-15 3848
-
电子束的概念2013-03-26 1939
-
电子束加工原理2011-05-22 24994
-
电子束管2006-04-16 2797
全部0条评论

快来发表一下你的评论吧 !

