

1um 以下的光刻深度,凹槽深度和宽度测量
电子说
描述
一、引言
在半导体制造、微机电系统(MEMS)等高新技术领域,1um 以下光刻深度、凹槽深度和宽度的精确测量至关重要。这类微小尺寸的测量精度直接影响产品性能与质量,但因其尺寸微小,测量面临诸多挑战,亟需合适的测量技术与方法。
二、测量挑战
1um 以下的光刻结构与凹槽尺寸极小,传统测量方法难以满足精度要求。一方面,测量工具的分辨率需达到亚微米甚至纳米级别;另一方面,测量过程中易受外界因素干扰,如环境振动、温度变化等,且微小结构易因测量力产生形变,影响测量准确性 。
三、常用测量技术
(一)白光干涉测量技术
白光干涉技术基于光的干涉原理,通过获取干涉条纹信息来实现微小尺寸测量。其具有非接触、高精度等特点,能够分辨微米甚至亚微米级的高度变化。对于 1um 以下的光刻深度和凹槽深度测量,白光干涉仪可利用短相干特性,精确分析不同位置的光程差,进而得到深度信息。同时,通过图像处理技术,也能实现凹槽宽度的测量 。
(二)扫描电子显微镜(SEM)测量技术
扫描电子显微镜利用聚焦的电子束扫描样品表面,通过检测二次电子等信号来获取样品表面形貌。SEM 具有极高的分辨率,能够清晰呈现 1um 以下光刻结构和凹槽的细节,可直接测量深度和宽度。其优势在于能够提供高放大倍数的图像,但测量过程中电子束可能会对样品产生一定损伤,且制样过程相对复杂 。
(三)原子力显微镜(AFM)测量技术
原子力显微镜通过检测探针与样品表面的相互作用力来获取表面形貌。在 1um 以下微小尺寸测量中,AFM 具有纳米级的测量精度,可对光刻深度和凹槽进行三维形貌测量,准确得到深度和宽度数据。不过,AFM 的测量范围相对较小,测量速度较慢 。
TopMap Micro View白光干涉3D轮廓仪
一款可以“实时”动态/静态 微纳级3D轮廓测量的白光干涉仪
1)一改传统白光干涉操作复杂的问题,实现一键智能聚焦扫描,亚纳米精度下实现卓越的重复性表现。
2)系统集成CST连续扫描技术,Z向测量范围高达100mm,不受物镜放大倍率的影响的高精度垂直分辨率,为复杂形貌测量提供全面解决方案。
3)可搭载多普勒激光测振系统,实现实现“动态”3D轮廓测量。

实际案例

1,优于1nm分辨率,轻松测量硅片表面粗糙度测量,Ra=0.7nm

2,毫米级视野,实现5nm-有机油膜厚度扫描
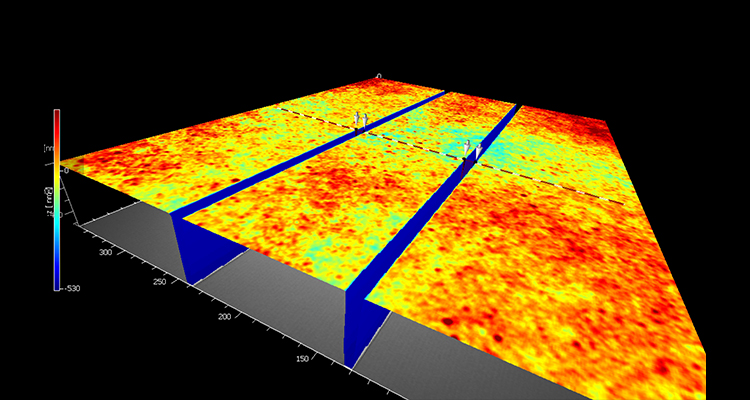
3,卓越的“高深宽比”测量能力,实现光刻图形凹槽深度和开口宽度测量。
审核编辑 黄宇
-
PLC平面光波导的图形凹槽深度测量-3D白光干涉仪应用2026-02-02 420
-
激光频率梳 3D 轮廓测量 - 油路板的凹槽深度和平面度测量2025-09-06 965
-
存储示波器的存储深度对信号分析有什么影响?2025-05-27 1650
-
1um以下的光刻深度,凹槽深度和宽度测量2024-12-27 475
-
哪种传感器可以非接触测量1um精度的位移量?2024-10-05 1951
-
深度学习介绍2022-11-11 828
-
EDX与XPS测试时采样深度的差别?2021-09-30 3470
-
请问fpga的深度和宽度的兼容值是什么?2019-10-31 1783
-
对砂轮基体厚度的测量2018-12-24 2231
-
Nanopi深度学习之路(1)深度学习框架分析2018-06-04 4341
-
光栅尺定位精度从4um提高到1um的方法2016-02-23 9367
-
在altium designer中能不能挖一个凹槽?2015-04-05 7503
-
给大家推荐一款高精度晶圆边界和凹槽轮廓尺寸测量系统2014-09-30 13078
-
浅谈示波器的存储深度2012-05-07 8636
全部0条评论

快来发表一下你的评论吧 !

