

CoWoP封装的概念、流程与优势
描述
文章来源:老虎说芯
原文作者:老虎说芯
本文介绍了CoWoP(Chip‑on‑Wafer‑on‑Substrate)封装的概念、流程与优势。
什么是 CoWoP?
CoWoS(Chip‑on‑Wafer‑on‑Substrate):传统先进的 2.5D 封装,将硅芯片(Logic + HBM)并排贴在一个中介层(硅 Interposer)上,再焊接到封装基板(Package Substrate),然后用 BGA 焊球连接到主板。
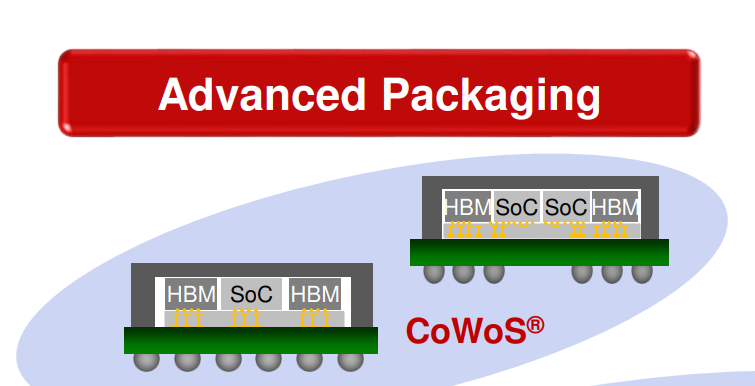
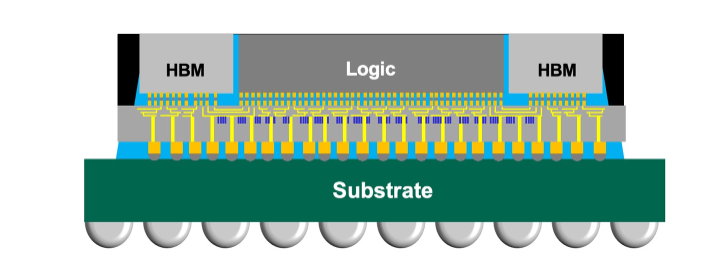
CoWoP 的核心思路就是把这个封装基板去掉 —— CoWoP = CoWoS - 封装基板。中介硅片 + 芯片直接安装在增强型主板上,不再走传统封装那一层。
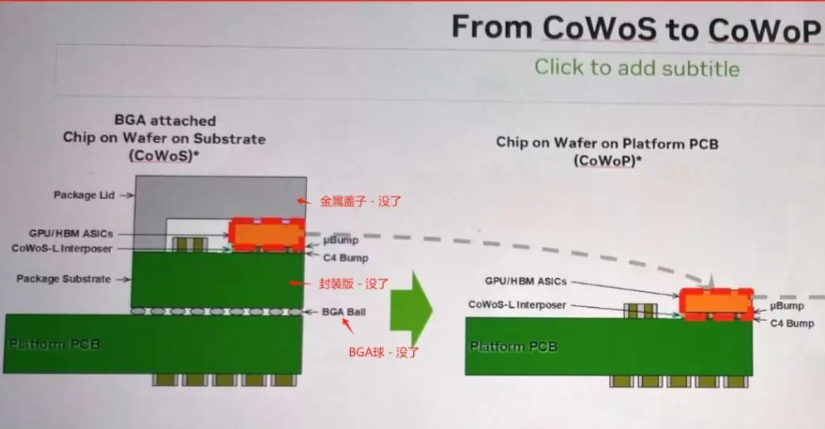
为什么这么做?CoWoP 有什么好处
省掉中间层,降低信号损耗
封装基板那层走线、引线、接触都会带来寄生电阻、电容。去掉后,逻辑芯片对高带宽连接(如 NVLink)更可靠、更远、更快。
热性能更强
没有封装基板那块厚材料,封装热膨胀系数配合更一致、热堆栈更薄,散热更直接、更好控温,减少板变形(warpage)。
成本下降
去掉封装底板和封装盖,少了材料、工艺、BGA焊球等制造步骤,潜在节约封装成本,同时也减轻整体厚度、体积。
CoWoP 的关键技术要点
主板(Platform PCB)必须升级
PCB 上要具备过去由封装 substrate 提供的高密度布线能力,包括精准微线距、精准信号/电源/地层布线能力。
中介层(Interposer)依然重要
包含 GPU 核心和 HBM 等小 die,放在高精度硅片 interposer 上,保持高带宽连接能力。
可靠力学与热匹配设计
硅 interposer、die 与 PCB 的热膨胀系数(CTE)必须匹配,避免因热循环导致 warpage 或失效。
信号电气完整性管理
PCB 与 interposer 对高速信号(如 NVLink、HBM RDL)路径需要严格控制阻抗、延迟、电容、电感分布。
系统流程概览(从传统到 CoWoP)
| 阶段 | CoWoS 流程 | CoWoP 流程 |
|---|---|---|
| 封装结构 | Die → Interposer → Package Substrate → BGA → PCB | Die → Interposer → 直接贴装到 PCB(平台 PCB) |
| 制造复杂度 | 多层焊接、BGA、substrate 工艺 | PCB 信号层复杂化,封装 substrate 去除 |
| 信号路径 | die→sub→BGA→PCB,中间寄生多 | die→PCB 路径短,直接布线更低寄生 |
| 热管理 | 封装基板热阻仍存在 | 板子薄、无盖封装,热阻更小,散热更好 |
| 成本 | 封装 substrate + 材料费高 | 省掉 substrate,节省封装成本 |
CoWoP 是在先进 AI 封装中,去掉了封装基板这一层,把 die + interposer 直接贴到平台 PCB 上,借力 PCB 本身承接 substrate 功能,让信号更快、热阻更小、成本更低,但要求 PCB、设计和热机械一体化的集成度非常高。
CoWoP对半导体产业链的影响
1、封装模式变革:需求迁移与供应链重构
从 CoWoS‑S 向 CoWoS‑L 或 CoWoP 的转变,意味着对封装基板层的大幅调整。
CoWoS 能力长期供不应求,CoWoP 的推广可能部分缓解这一瓶颈,特别是若 CoWoP 能有效替代部分 CoWoS-S 产能需求 。
建立多元化的封装供应链,减轻对 CoWoS 的依赖。
2、对封装、PCB、PCB 材料与制造合作伙伴的挑战
CoWoP 将封装 substrate 功能迁移到平台 PCB,这要求 PCB 厂商升级生产工艺:更细线距、高密度线路、多层电源地层、低热膨胀系数材料等。
原先制作封装 substrate 的企业,可能转向更多 interposer 的测试与组装环节,或扩展业务至高精度 PCB 领域。
3、封装供应商与功耗相关链条的重新布局
传统 CoWoS substrate 供应商业务可能减少,而 提供硅中介层(interposer)的需求将持续增长。
HBM 高带宽内存供应商由于 CoWoP 依然使用 HBM,与封装 interposer 集合,因此对 HBM 的依赖继续强化,市场需求和价格仍上涨趋势明显。
4、研发挑战与联盟协同升级
CoWoP 要求 PCB 与 interposer、die 一体设计,信号、电源、热管理、机械力学需协同工程化实现。这推动 设计工具商、EDA、材料商、PCB 厂商共研新规范。
封装技术更新加快,CoWoP 与 CoWoS‑L、FOPLP(扇出面板级封装)形成互补和竞争。这对封装厂商提出更高要求,也创造新的合作空间 。
5、小结
CoWoP 带来的最核心影响是:将封装 substrate 的功能重置到主板层,推动 PCB 制造商、设计工具、材料供应商与传统封装厂商重新协作,重构 AI 封装与供应链生态。 它不仅可能缓解 CoWoS 的产能瓶颈,还将推动封装与板级供应链迈向更高集成度和设计协同性时代。
-
ic封装工艺流程2010-07-18 3636
-
简单认识CoWoP封装技术2025-09-22 5103
-
封装设计与仿真流程2023-05-19 2963
-
最近大火的CoWoP跟CoWoS、CoPoS有什么区别?2025-08-10 6766
-
IC封装流程2011-04-07 31069
-
芯片封装测试流程详解ppt2012-01-13 78107
-
AD19封装库建立流程2020-11-26 3641
-
NB-IoT的概念及优势2021-07-23 2508
-
STM32的中断系统基本概念2022-01-07 1308
-
芯片封装工艺流程-芯片封装工艺流程图2008-05-26 8640
-
半导体封装流程2016-05-26 2167
-
HLS/HLV 流程说明及优势2017-09-11 1817
-
形式验证入门之基本概念和流程2022-12-27 3970
-
什么是3.5D封装?它有哪些优势?2024-10-28 2228
-
CoWoP能否挑战CoWoS的霸主地位2025-09-03 3310
全部0条评论

快来发表一下你的评论吧 !

