

详解芯片封装的工艺步骤
描述
文章来源:半导体与物理
原文作者:jjfly686
本文介绍了芯片封装的类型与流程。
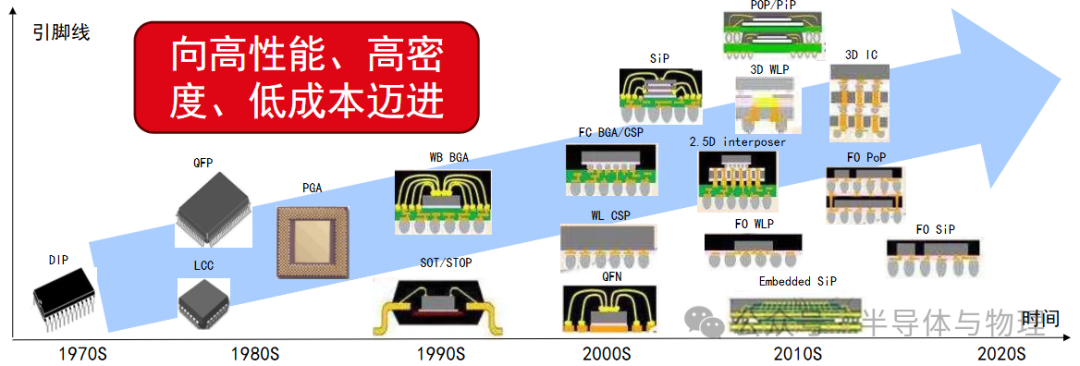
芯片封装是半导体制造过程中至关重要的一步,它不仅保护了精密的硅芯片免受外界环境的影响,还提供了与外部电路连接的方式。通过一系列复杂的工艺步骤,芯片从晶圆上被切割下来,经过处理和封装,最终成为可以安装在各种电子设备中的组件。
晶圆减薄
在进行封装之前,通常需要对硅片进行减薄处理。这是因为较薄的硅片更容易进行后续的切割和加工,还有助于多个die封装在一起。背面减薄技术主要包括磨削、研磨、干式抛光、化学机械平坦工艺(CMP)、常压等离子腐蚀等方法。
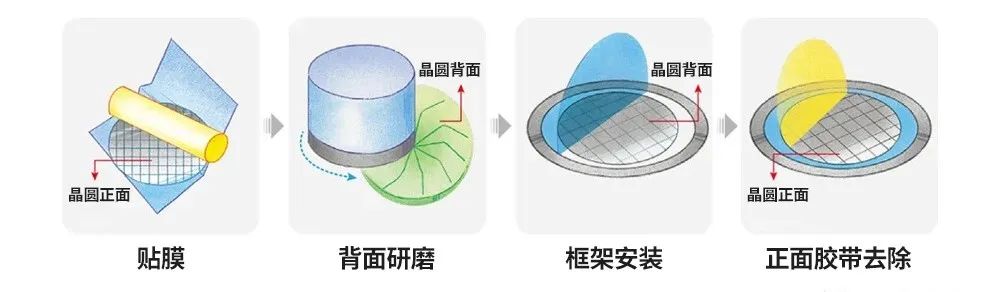
切割工艺:DBG与DBT
为了减少硅片减薄过程中的翘曲问题及划片引起的芯片边缘损害,有两种改进的切割工艺:先切割后减薄(DBG)和减薄切割法(DBT)。
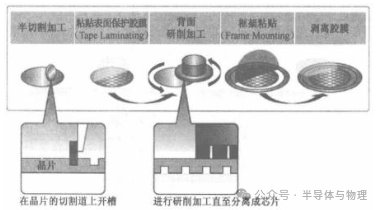
芯片贴装:固定芯片的方法

将IC芯片固定于封装基板或引脚架上的过程被称为芯片贴装。常用的工艺包括:
共晶粘贴法:利用金-硅合金在高温下熔合的特点实现固定。
焊接粘贴法:使用铅锡合金焊接。
导电胶粘贴法:适用于塑料封装,使用高分子聚合物作为粘合剂。
玻璃胶粘贴法:采用玻璃材料进行粘合。

芯片互连:连接内部与外部世界

芯片互连是指将芯片焊区与封装外壳的I/O引线或基板上的金属布线相连接的过程。这可以通过以下几种技术实现:
打线键合技术(WB):如超声波键合、热压键合和热超声波键合。

载带自动键合技术(TAB):一次性完成所有接口的连接。

倒装芯片键合技术(FCB):直接将芯片焊区与基板焊区相连,减少了信号传输的距离,提高了效率。

成型技术:给芯片穿上“外衣”
成型技术指的是将芯片与引线框架一起封装起来,以提供物理保护并便于安装。根据材料的不同,可分为金属封装、塑料封装和陶瓷封装等。
后处理步骤
去飞边毛刺:去除封装过程中产生的多余材料,确保表面光滑。
上焊锡:为引脚涂覆焊锡,便于后续焊接。
切筋成型:将引脚弯曲成特定形状,方便装配。
打码:在封装模块上印上制造商信息、国家代码和器件代码等,以便识别和追踪
-
芯片封装中银烧结工艺详解2025-04-17 3662
-
芯片封装工艺详解2025-04-16 3471
-
一文详解2.5D封装工艺2025-02-08 8060
-
mos封装工艺是什么,MOS管封装类型2024-06-09 4054
-
芯片封装的封装步骤2023-12-18 3448
-
详解半导体封装测试工艺2023-05-31 2723
-
芯片封装烧结银工艺2022-12-26 3287
-
芯片制造工艺流程步骤2021-12-15 46784
-
IC封装工艺测试流程的详细资料详解2018-12-06 3308
-
Uboot移植步骤详解2017-10-30 1518
-
芯片封装工艺详细讲解2016-06-16 22666
-
PCB工艺流程详解2013-05-22 10214
-
芯片封装测试流程详解ppt2012-01-13 78595
-
各类芯片封装的主要步骤详细资料2010-03-04 3913
全部0条评论

快来发表一下你的评论吧 !

