

3D封装架构的分类和定义
描述
文章来源:Tom聊芯片智造
原文作者:芯片智造
本文介绍了3D封装架构的分类、定义、实现和挑战。
3D封装架构主要分为芯片对芯片集成、封装对封装集成和异构集成三大类,分别采用TSV、TCB和混合键合等先进工艺实现高密度互连。
3D封装架构分类
3D封装架构主要分三大类:芯片对芯片的3D集成、封装对封装的3D集成,还有把封装和芯片堆叠混在一起用的3D异构集成。
芯片对芯片的3D集成
1. 基本概念
芯片对芯片的3D集成,简单来说就是把几颗芯片"堆叠"在一起,并用硅通孔(TSV)和微凸点把它们牢牢连起来。
2. 具体实现
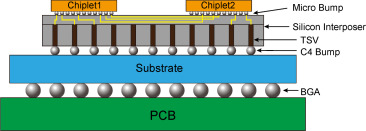
比如:两颗存储芯片先通过TSV和微凸点堆叠在一颗逻辑芯片上;逻辑芯片再通过一级焊点连到基板上;最后用二级焊点把整个3D封装连到印刷电路板(PCB)上。
3. 工艺挑战
传统的2D封装里,用的是"焊料回流"——先涂助焊剂,再贴芯片,然后放到炉子里回流焊接。但到了3D封装时代,这种方法就不太好使了:
3D封装里的芯片和基板都更薄
互连更小更密
一加热就容易翘曲、错位、倾斜、焊接不良、焊料桥连
所以,3D封装需要更先进的工艺来代替传统回流焊。
4. 先进工艺方案
TCB(热压键合)就是最常用的替代方案,它专门用来把3D封装里的微凸点精确焊接到位,避免翘曲和焊接不良。
再往前一步,混合键合(Hybrid Bonding)等新工艺,甚至可以处理小于5微米间距的超密互连,组装温度还低,更适合下一代3D封装的发展。
封装对封装的3D集成
1. 典型配置
系统级封装(SIP)和封装堆叠封装(POP)是封装对封装3D集成的典型配置,通过引线键合或倒装键合把封装堆叠起来。
2. 技术优势
跟芯片堆叠比,封装堆叠技术开发周期短,能更快地把产品推向市场,价格也便宜。
3. 结构描述
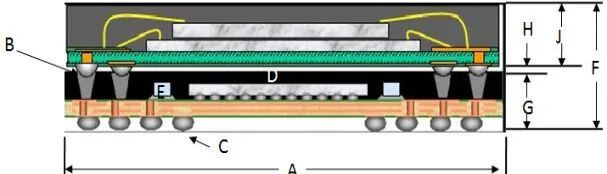
如图所示,一个引线键合封装通过倒装键合堆叠在另一个引线键合封装上面,然后这两个封装再堆到一个倒装封装上,形成POP。
异构3D集成
1. 定义与特点
异构3D集成,是指将不同功能、不同工艺节点的芯片堆叠整合在同一个紧凑封装中的封装方式。
2. 应用优势
相比传统的单片芯片(所有功能做在一个Die上),异构3D封装的优势非常明显:
可以让每个小芯片用最合适的制程工艺(比如CPU用先进工艺,模拟部分用成熟工艺)
小芯片面积小,良率更高、成本更低
可以用现成的芯片快速组合出新产品,大大缩短开发周期
整体封装更紧凑,系统级性能更强
3. 实现案例
比如,下面这种异构3D结构
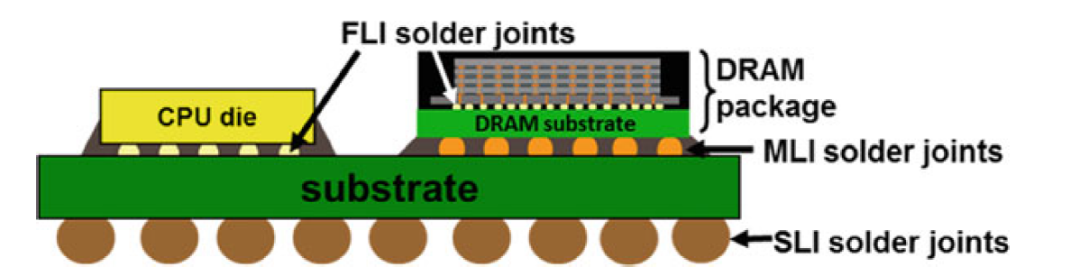
一颗DRAM封装(里面是4颗通过TSV+微凸点堆叠的存储芯片) 再跟一颗倒装的CPU芯片并排组合在一个封装中 封装与封装之间通过多级互连,再通过封装内的一级互连、基板连接,实现整个系统级的高速通信
这样的"芯片堆+封装堆"组合,既高效又灵活。
-
3D 模型封装2013-12-27 4363
-
3d封装2015-06-22 2888
-
3D PCB封装库2015-08-06 15278
-
altium designer 3D封装库2015-11-07 4116
-
带有3D的封装2015-11-27 4620
-
画PCB 3D封装问题2016-07-12 5200
-
关于AD16的3D封装问题2019-05-10 6758
-
如何让AD在3D显示下去除3D封装的显示?2019-09-23 17216
-
AD16的3D封装库问题?2019-09-26 5078
-
分享一个分类、命名规范的Allegro PCB封装库,还附有3D模型显示2020-10-16 6595
-
3D元件封装库2016-03-21 2843
-
Altium Designer 3D封装2017-02-28 2127
-
3D封装技术定义和解析2020-05-28 7516
-
3D 封装与 3D 集成有何区别?2023-12-05 2650
-
AD 3D封装库资料2025-08-27 573
全部0条评论

快来发表一下你的评论吧 !

