

PECVD的基本定义和主要作用
描述
文章来源:学习那些事
原文作者:新手求学
本文主要讲述PECVD。
基本定义
PECVD( Plasma Enhanced Chemical Vapor Deposition ,等离子体增强化学气相沉积)是一种通过射频( RF )电源激发等离子体,在低温条件下实现薄膜沉积的半导体制造技术。其核心在于利用等离子体中的高能粒子(电子、离子、自由基)增强化学反应活性。
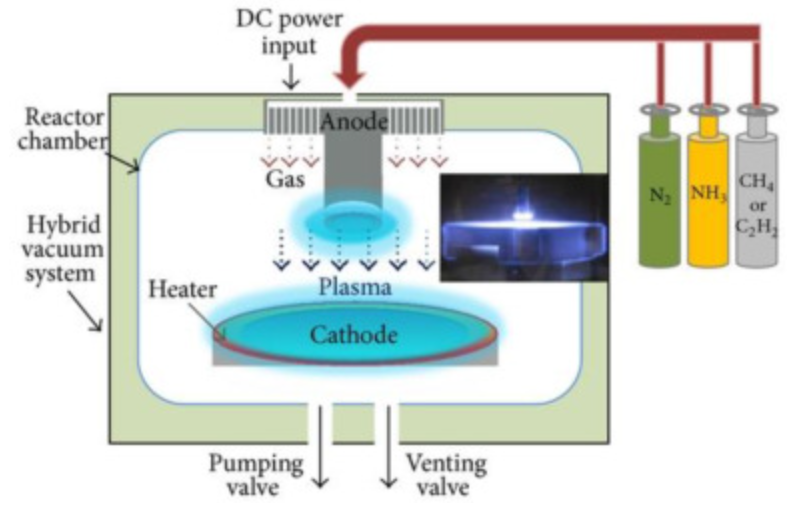
工作原理与设备组成
等离子体生成
通过 13.56 MHz 射频电源在反应腔室内形成电场,将工艺气体(如 SiH₄、 NH₃、 N₂O 等)电离为活性粒子。
典型功率范围: 40 kHz 至 2.45 GHz (微波段),能量密度可达 0.1-5 W/cm²。
反应机制
气体分子(如 SiH₄)在等离子体中被解离为活性基团。
基板温度通常控制在 200-400℃,显著低于传统 CVD 的 700-900℃。
设备核心模块
| 模块 | 功能描述 |
|---|---|
| 工艺腔室 | 配备独立温控模块(典型温度精度±1℃),气体反应场所 |
| RF 电源系统 | 产生 13.56 MHz 射频场,电离气体形成等离子体 |
| 真空系统 | 干泵与分子泵组合,维持 0.1-10 Torr 真空环境 |
| 气体输送系统 | 多通道质量流量计( MFC )精确控制气体配比(精度±0.1 sccm ) |
主要作用与技术优势
低温沉积能力
可在 300℃以下沉积氮化硅( SiNₓ)、二氧化硅( SiO₂)等薄膜,避免高温对金属互连层或敏感结构的损伤。
对比数据: LPCVD 沉积 Si₃N₄需 700-800℃,而 PECVD 仅需 300-400℃。
薄膜性能调控
通过调节射频功率( 50-1000 W )、气体比例(如 SiH₄/NH₃)、压力( 1-5 Torr )等参数,可控制薄膜应力(-1 GPa 至+1 GPa )、折射率( 1.8-2.1 )、蚀刻速率等性能。
例如:提高 H₂流量可减少 SiNₓ薄膜的 H 含量,提升介电强度。
关键应用领域
半导体器件:栅极绝缘层( SiNₓ)、钝化层(抗湿气与离子扩散)。
显示面板: TFT-LCD 中非晶硅( a-Si:H )通道层、透明电极( ITO )封装层。
MEMS 器件:低应力介质层沉积,支持三维结构加工。
技术演进方向
高密度等离子体( HDP ) PECVD
采用电感耦合( ICP )或电子回旋共振( ECR )技术,等离子体密度提升至 10¹¹-10¹² cm⁻³,实现更优的间隙填充能力(深宽比>10:1 )。
原子层沉积( ALD )集成
结合 PECVD 与 ALD 技术,实现亚纳米级薄膜均匀性(厚度偏差<1%),适用于 FinFET 等先进节点。
-
PECVD中影响薄膜应力的因素2025-02-10 1611
-
填充片的定义及作用2024-12-04 1965
-
沉积氮化硅薄膜的重要制备工艺——PECVD镀膜2023-09-27 6998
-
交流恒流源的定义、作用、类型及电路设计2022-09-27 5012
-
C语言里函数的定义、子函数的使用及变量的作用域2022-04-28 8071
-
芯片的主要作用是什么2021-12-22 20091
-
什么是灌封? 灌封的主要作用?2021-11-12 13269
-
RCC主要作用2021-08-06 1498
-
什么是灌封?灌封的主要作用?2021-03-07 9403
-
OTP软件的控件名称和定义及作用和说明2019-01-25 1168
-
首台国产12英寸PECVD设备诞生2011-11-08 2511
-
PECVD原理2010-07-18 9293
-
卧式热壁型PECVD设备2009-12-18 1192
-
ControlNet技术在PECVD设备中的应用2009-08-18 1229
全部0条评论

快来发表一下你的评论吧 !

