

工程师必备!ULTEA®负热膨胀填充剂在环氧树脂封装中的应用方案
描述
主题:
解决封装材料热失配难题
正文:
在芯片封装、LED封装及功率器件模封中,环氧树脂等有机封装材料与芯片、陶瓷基板之间存在的热膨胀系数(CTE)失配,是导致界面开裂、可靠性下降的主要原因。添加常规填充剂虽能一定程度降低CTE,但往往难以达到理想状态。ULTEA®负热膨胀填充剂为此提供了完美答案。当将其添加到环氧树脂中时,ULTEA®在受热过程中的收缩行为,能主动抵消树脂基体的膨胀,从而将复合材料的整体CTE调整至接近芯片或陶瓷的水平,极大减少热应力。
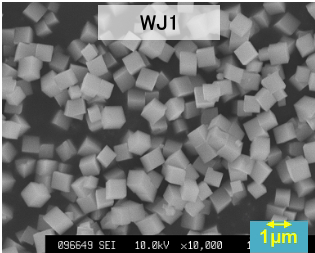
特别是开发品WJ1型号,其平均粒径更细(0.5-1μm),负热膨胀系数更强(-6 x10⁻⁶/K),且密度低(0.2 g/cm³),更容易在树脂中实现高填充量和均匀分散,是树脂应用的理想选择。
深圳市智美行科技有限公司
作为东亚合成的战略伙伴,不仅提供高质量的ULTEA®产品,更能为您的特定封装应用提供技术支持和选型建议。
立即申请免费样品,测试ULTEA®在您配方中的卓越表现!
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
破解热致失效困局:深入解析负热膨胀材料ULTEA®在高端电子封装中的应用2025-12-03 1446
-
破解热管理难题:负热膨胀材料ULTEA®为何是精密电子设计的“稳定器”?2025-11-27 507
-
适用于内窥镜镜头模组的环氧树脂封装胶2025-01-10 1124
-
环氧树脂基底部填充电子封装材料研究进展2023-01-05 7021
-
填充型高导热环氧树脂复合材料的研究进展2022-09-13 4919
-
环氧树脂在物联网设备 PCB 制造中的多种作用2022-07-15 4426
-
科学家发现环氧树脂固化新方案2020-12-23 2718
-
热膨胀系数以及UV胶水热膨胀系数的介绍2020-11-24 14507
-
PCB线路板导电填充与非导电填充的区别及其各自的优势2020-09-21 5833
-
点胶机在芯片封装行业中的应用2018-09-20 1973
-
基于环氧树脂封装料的LED应用2018-08-28 1837
-
工程师必备2012-08-20 3592
-
LED环氧树脂(Epoxy)的封装技术2009-11-18 2334
全部0条评论

快来发表一下你的评论吧 !

