

 半导体“光电子封装”与“先进系统集成”工艺技术的详解;
半导体“光电子封装”与“先进系统集成”工艺技术的详解;
描述
【博主简介】本人“爱在七夕时”,系一名半导体行业质量管理从业者,旨在业余时间不定期的分享半导体行业中的:产品质量、失效分析、可靠性分析和产品基础应用等相关知识。常言:真知不问出处,所分享的内容如有雷同或是不当之处,还请大家海涵。当前在各网络平台上均以此昵称为ID跟大家一起交流学习!

光电子封装与先进系统集成技术涵盖了光电子集成芯片与外部世界的光学、电子、机械和热耦合。由于涉及技术的复杂性以及标准化程度较低,这个领域仍面临诸多技术挑战。

一、光电子封装
光电子器件系统封装是把光电子器件、电子元器件及功能应用原材料进行封装的一个系统集成过程。光电子器件封装在光通讯系统、数据中心、工业激光、民用光显示等领域应用广泛。主要可以分为如下几个级别的封装:芯片IC级封装、器件封装、模块封装、系统板级封装、子系统组装和系统集成。
光学封装主要关注光纤与光电子集成芯片之间的高效光耦合。主要采用边缘耦合和光栅耦合两种方法,这些技术特别适用于1550nm和1310nm波长范围。

边缘耦合具有低插入损耗、宽光谱带宽和低偏振敏感性等优点。单光纤应用通常使用安装在金属套管中的透镜光纤,通过精确对准和激光焊接实现最佳耦合。

1、光电子器件封装形式
光电子器件与一般的半导体器件不同,它除了含有电学部分外,还有光学准直机构,因此器其封装结构比较复杂,并且通常由一些不同得子部件构成。其子部件一般有两种结构,一种是激光二极管、光电探测器等部分都安装在密闭型得封装里面。根据其应用可以分为商业标准封装和客户要求的专有封装。其中商业标准封装可以分为同轴TO 封装,蝶形封装。
1.1 TO封装
同轴封装是指管体内的光学元件(激光器芯片、背光探测器)、透镜和外部连接的 光纤的光路在一同心轴线上。同轴封装器件内部的激光器芯片和背光探测器贴装在氮化铝热沉上,通过金线引线与外部电路实现导通,由于同轴封装仅存在一个透镜,相较于蝶形封装提高了耦合效率。
TO管壳所用材料主要为不锈钢或可伐合金。整个结构由底座、透镜、外部散热块等部位组成,结构上下同轴。通常,TO封装激光器的内部有激光器芯片(LD)、背光探测器芯片(PD)、L型支架等,若带内部温控系统如TEC则内部还需要热敏电阻和控制芯片等部位。下图为带透镜的TO激光器示意图:
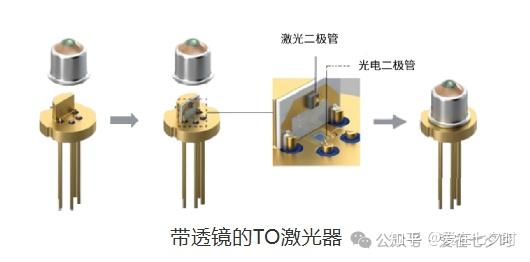
1.2 蝶形封装
由于外形像蝴蝶一样,所以这种封装形式被称为蝶形封装,如下图所示为蝶形封 装光器件的外形图。蝶形封装在高速率、长距离传输的光纤通信系统中技术应用的较为广泛。具有一些特点,如蝶形封装体内的空间大,易于半导体热电制冷器的贴装,实现对应的温控功能;相关的激光器芯片、透镜等元件易于在体内进行布局;管腿分布两侧,易于实现电路的连接;且结构方便进行测试与包装。壳体通常为长方体,结构及实现功能通常比较复杂,可以内置制冷器、热沉、陶瓷基块、芯片、热敏电阻、背光监控,并且可以支持所有以上部件的键合引线。壳体面积大,散热好。

2、光电子器件封装工艺
对半导体激光器芯片的封装对可靠性的要求可参考 MIL-STD-883,在封装过程中必须关注过度块、热沉、焊料、胶水等材料的热传导特性、热膨胀系数、材料的扩散以及响应的工艺特性。
热沉多选用铜、钨铜、硅、陶瓷、可伐或各种其他合成材料等。通常情况下,裸芯片通过焊接或者银胶粘结在陶瓷过度块上,过度块起到横向散热作用,避免发射器件局部温度升高。此外过度块的热膨胀系数介于芯片材料热沉之间,可以达到有效的热变形匹配。从而有效减小安装工艺过程中温度变化或者固化过程中产生的应力。陶瓷AlN具有良好的线膨胀匹配能力且导热良好,因此在实际生产中被广泛的应用。
器件的封装也可以分为封装设计和封装工艺。封装设计阶段需要根据使用的目标选择封装的结构,完成封装机械结构的设计,尽量选择现有的通用管壳。同时进行封装的设计仿真包括热仿真,应力仿真,射频仿真。再说合计阶段同时兼顾工艺的优化设计。如下图表:

完成了封装的设计进行封装的工艺验证与封装的实施。工艺流程如下表:

3、光电子封装方案
光电子封装的电气连接主要实现光电子集成芯片与外部控制电路的可靠连接。线键合是最常用的方法,直流和射频连接都需要特定的考虑因素。

直流连接的接合垫通常需要最小尺寸为70μm × 70μm,间距至少150μm。射频连接需要更谨慎的考虑,因为需要阻抗匹配并最小化寄生效应。

二、先进系统集成技术
现代光电子封装越来越多地涉及多个组件的集成,包括光电子集成芯片、电子集成电路和MEMS器件。倒装芯片键合已成为实现紧凑、高性能封装的关键技术。

MEMS器件的集成提出了独特的挑战,需要在考虑光学和电气因素的同时关注机械方面。这些器件通常构成更大的片上系统或封装系统的一部分。

半导体先进系统集成技术是半导体制造领域中的一个重要发展方向,它通过将不同的半导体材料、器件和系统进行高效集成,以提升微电子系统的整体性能和价值。
1、关键技术和趋势
1.1 先进键合技术
先进键合技术在半导体制造过程中起到关键作用,广泛应用于先进封装、显示面板、先进基板、功率电子和MEMS传感器制造等领域。
键合技术不仅实现了不同材料之间的融合,还支持三维堆叠,打破了光刻技术的瓶颈,突破了平面器件的限制。

1.2 Chiplet技术
Chiplet(小芯片)技术通过将不同功能或不同制程工艺的小芯片通过先进的封装技术集成在一起,形成系统级芯片。
这种设计方法降低了对先进工艺的依赖性,提高了设计的灵活性和可扩展性,同时也有助于突破先进工艺的瓶颈。

1.3 异构集成
异构集成技术将不同功能或不同制程的芯片集成在一起,形成系统级芯片,从而提升了系统的整体性能和功能。
这种技术不仅适用于高性能计算和高能效应用,还能满足多样化市场需求。
1.4 EDA工具支持
电子设计自动化(EDA)工具在Chiplet设计中需要提供全面支持,包括电源、信号完整性、多物理场分析以及整个系统的验证。
这些分析需要在设计阶段和后续的制造和测试阶段持续进行,以确保系统的性能和可靠性。
1.5 延续摩尔和超越摩尔
先进系统集成技术综合了“延续摩尔”和“超越摩尔”两条路径的成果,通过在现有制程基础上进行创新设计和集成,实现了性能的提升和成本的降低。
这种方法有助于推动半导体行业的持续发展,满足不断增长的市场需求。
2、对系统集成技术的建议
2.1 持续投资研发 :半导体先进系统集成技术仍处于快速发展阶段,需要持续投资研发以保持技术领先。
2.2 加强跨学科合作 :由于该技术涉及材料科学、电子工程、计算机科学等多个领域,因此加强跨学科合作至关重要。
2.3 关注市场需求 :了解市场需求和趋势,以便及时调整技术研发方向和产品策略。
通过以上技术和策略,半导体先进系统集成技术将为未来的微电子系统带来更高的性能和更广泛的应用。
三、封装技术的获取
多个欧洲计划提供了获取先进光电子封装技术的途径。这些计划旨在缩小研究和商业实施之间的差距。通过ACTPHAST、EUROPRACTICE和PIXAPP等计划,学术机构和商业实体都能获得最先进的封装设施和专业知识。

四、最后想说的话
光电子封装和先进系统集成技术不断发展,新技术和方法不断涌现,以满足从电信到医疗诊断等应用的growing需求。遵循适当的设计规则和标准对于成功的光电子系统集成很重要。欧洲的科技计划正在促进先进封装技术的普及应用。这些资源对于加速光电子技术的开发和商业化具有重要意义。

免责声明
【我们尊重原创,也注重分享。文中的文字、图片版权归原作者所有,转载目的在于分享更多信息,不代表本号立场,如有侵犯您的权益请及时私信联系,我们将第一时间跟踪核实并作处理,谢谢!】
审核编辑 黄宇
-
单片光电子集成技术2011-11-15 3761
-
招聘半导体封装工程师2015-02-10 3874
-
电子封装技术最新进展2018-08-23 3435
-
半导体工艺技术的发展趋势2019-07-05 4666
-
半导体工艺技术的发展趋势是什么?2019-08-20 4618
-
光电子集成芯片2022-02-15 1612
-
半导体光电子器件, 半导体光电子器件是什么意思2010-03-04 3100
-
半导体光电子技术2011-10-31 1439
-
半导体工艺技术2016-05-26 1294
-
IMT公司与陕西光电子集成电路先导技术研究院建立战略合作关系,合力推动光电子集成电路与MEMS工艺技术的融2017-02-20 2170
-
光电子器件封装形式2022-11-21 7499
-
详解半导体封装测试工艺2023-05-31 2731
-
电子产品装联工艺技术详解2023-10-27 2386
-
光电子集成芯片是什么2024-03-19 3199
-
光电子半导体市场新趋势2025-01-16 1303
全部0条评论

快来发表一下你的评论吧 !

