

晶圆级封装良率提升方案:DW185半导体级低黏度晶圆助焊剂
描述
在晶圆级封装与先进互连工艺中,焊点问题往往并不出现在“设备”,而是出现在一个被低估的环节——助焊剂选择。焊点不圆、桥连频发、回流后残留难清、良率波动大……这些问题,DW185 正是为此而来。
DW185:专为晶圆焊点成形与良率稳定设计的工艺解决方案
DW185 是一款半导体级低黏度晶圆助焊剂,专为晶圆焊点成形与良率稳定而设计。它不是“通用型材料”,而是直接服务于晶圆级焊接结果的工艺解决方案。在回流过程中,DW185 能高效去除焊点表面氧化物,并在焊料自身表面张力作用下,促使焊点自然收缩成高度一致的半球形结构:
• 焊点饱满
• 形状一致
• 无焊料损失
• 不易桥连
成形好,后段工艺才会更稳。
真正解决产线“痛点”的性能设计
DW185 的每一项性能,都是围绕量产稳定性展开: • 水溶性配方→ 回流后易清洗,残留风险低 • 适配 150–300 mm 晶圆黏度区间→ 大尺寸晶圆涂覆更均匀 • 多次回流 + 清洗后无残留→ 满足高可靠性封装要求 • 无卤素→ 更安全、更可靠 • 焊点形状一致性高→ 有效提升良率与一致性 • 兼容有铅 / 无铅 / 高温焊接制程→ 工艺切换无需更换材料 • 不侵蚀金属化层→ 长期可靠性更有保障
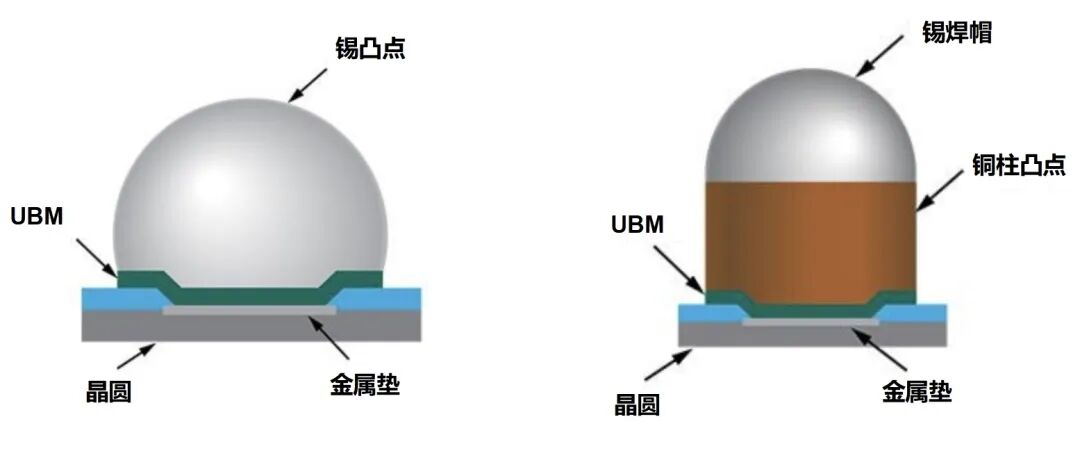
工艺兼容性强,上线更快
DW185 可直接应用于主流晶圆产线工艺:
旋涂工艺
•低速铺展 → 高速减薄
•转速范围 15–800 rpm
•可根据晶圆尺寸、焊点间距灵活调整
喷涂工艺
•支持 8 小时连续稳定供料
•涂覆均匀,适合量产
•只需常规系统清洗即可保持纯净度
清洗简单,窗口宽
DW185 残留物完全可溶于水,推荐使用加热去离子水喷雾清洗: •初始建议: •压力:60 psi •温度:55 ℃
清洗窗口宽,对设备和工艺友好,更适合规模化生产线长期运行。
细间距应用也有解法
•回流建议在氮气环境下进行 •氧含量建议 <20 ppm(最高不超过 50 ppm) •对于 <55 µm 铜柱微型焊点 •若出现桥连或缺锡 •通过适当降低峰值温度即可有效改善
DW185 已在多种晶圆凸点结构中验证,300 mm 晶圆可直接参考应用曲线,并可根据客户制程进一步优化。
-
晶圆级封装Bump制作中锡膏和助焊剂的应用解析2025-11-22 1231
-
晶圆隐裂检测提高半导体行业效率2025-05-23 1040
-
一文看懂晶圆级封装2024-03-05 4169
-
晶圆级封装的基本流程2023-11-08 12249
-
什么是晶圆级封装2022-04-06 12614
-
什么是半导体晶圆?2021-07-23 4330
-
晶圆封装有哪些优缺点?2021-02-23 6806
-
晶圆级封装的方法是什么?2020-03-06 3922
-
晶圆级CSP的锡膏装配和助焊剂装配2018-09-06 1709
-
什么是晶圆级封装?2011-12-01 16875
-
晶圆级封装产业(WLP),晶圆级封装产业(WLP)是什么意思2010-03-04 47086
全部0条评论

快来发表一下你的评论吧 !

