

一文详解封装基板的制备工艺
描述
以下文章来源于芯禾叶带你看芯片,作者花茶
一、封装基板制造方法
1.减成法制造技术
在封装基板发展的早期阶段,广泛采用一种称为减成法的印制电路板制造技术,亦称蚀刻铜箔技术。该技术的基本原理是在覆铜板上印刷出所需的电路图案,通过抗蚀膜保护图案区域,随后利用化学蚀刻去除未被保护的铜层,最终形成印刷线路板。
减成法制造技术具有多方面的优势:①高精度,能够实现精细加工,适用于对尺寸精度要求较高的零部件与产品;②多材料适用性,可加工金属、塑料、陶瓷等多种材料,适应不同材料的制造需求;③工艺灵活性,制造过程可根据设计及产品要求进行定制化调整;④良好表面质量,加工后可获得较高的表面光洁度,有助于提升产品的外观与性能;⑤工艺成熟可靠。
然而,减成法在制作过程中常出现侧蚀现象,即在垂直蚀刻方向发生横向侵蚀,导致线路截面呈梯形结构,顶部宽度小于底部。这种形貌易引发线路开路或短路,同时也会使线路电阻值偏离设计范围,影响电路性能与可靠性。
2.半加成法与改良型半加成法
在近年来,对于线路制作工艺,往往不再用原来的减成法技术,而是用日益兴起的半加成法技术。减成法技术流程会受到诸多因素的影响,也就是其不可控因素较半加成法技术更多。目前,半加成法技术的主要工艺是电沉积铜工艺,该工艺也是实现互联结构的主流工艺,其最大的优点就是利用铜具备适合该工艺的性能特点,在工艺实施过程中能够避免蚀刻铜流程对互连结构侧面会造成侵蚀,以及此方法成本相对较低。电沉积铜技术在封装基板制作过程中起到了至关重要的作用,能够提供更好的互连结构精细度和完整性,同时也是一种更准确、环保的选择。
改良型半加成法(modified semi-additive process,MSAP)进一步改进了半加成法的技术。它使用了薄铜箔作为基材(≤8 μm),在其上使用正片进行图形转移,并通过图形电镀来加厚形成线路。去除干膜和底铜,完成高精度的布线,再进行脱膜,将底铜进行蚀刻(即闪蚀)。基材铜箔非常薄,在制作精细线路过程中可以发现,在进行差分蚀刻时,没有进行电镀加厚工艺的区域,铜会比较容易消失,只留下需要的部分形成线路。如果控制好电镀的时间和其他参数,就可以得到需要的线路厚度。随着工艺的不断改进,使用更多的是MSAP。相较于半加成法工艺,其工艺稍微复杂一些,但是比较容易实现。而以前的半加成法虽然工艺简单,但工艺操作技术较复杂,特别是在化学沉铜工艺上难以实现。借助MSAP技术的发展,封装基板制造能够更加精确和可靠。随着技术的不断进步和深入研究,可以期待封装基板制造技术在未来的持续发展,以满足不断变化的市场需求。
二、制备基板关键工艺技术
目前市面上的主流工艺是MSAP,其流程如图所示。
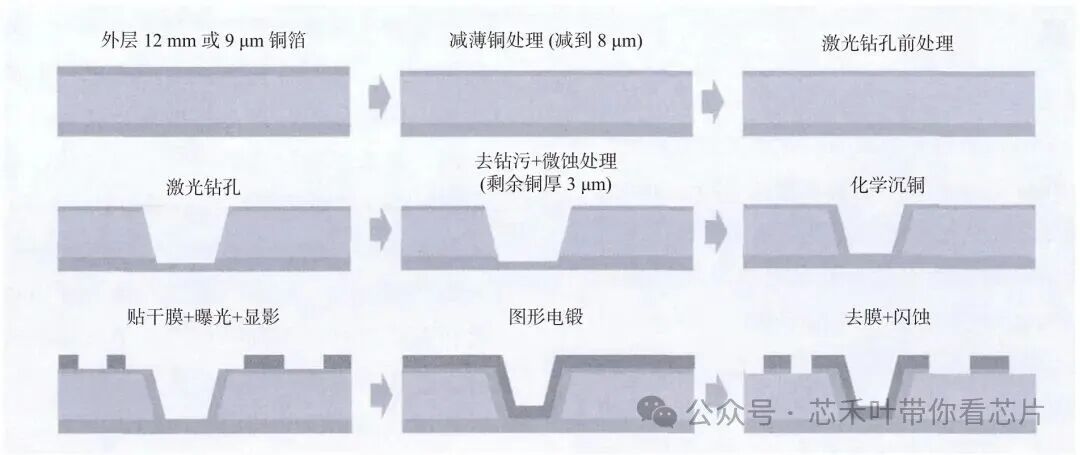 改良型半加成工艺流程
改良型半加成工艺流程
1) 基铜。在改良型半加成法工艺中对基铜的厚度有着严格要求,为了薄化铜厚度,常使用覆铜箔层压板的方式来减厚。覆铜箔层压板的铜箔厚度有规定范围,一般来说规定其厚度不超过12 μm,因此选择合适的铜箔厚度至关重要。铜箔的厚度需要严格把控,超过一定的厚度要求就容易导致表面铜层的不均匀。如果太薄,则会增加工艺难度,太薄的铜箔在层压时会容易出现表面不平坦,并且薄铜箔由于成本太高,不适合大量使用。将减铜量控制在9 μm以下时,可以在±2 μm的范围内控制表面铜层的厚度均匀性。标准铜箔不能作为基铜,因为其粗糙度很大,在进行闪蚀时不容易去除不需要的铜,因此不会选择标准铜箔进行制作精细线路。现在大多采用低轮廓铜箔或者超低轮廓铜箔,这有助于保证线路制作的精细度和质量。
2) 贴膜前处理。涂膜前的预处理质量和干膜性能的选择将影响干膜与铜的附着力。常见的前处理方法包括3种:化学处理法、喷砂研磨法和机械研磨法。后2种方法属于物理处理方法,经过物理方法处理后会发现处理之后铜表面的粗糙程度不符合要求,因此如果要获得微粗糙度,通常采用最后1种方法,或者将喷砂研磨与最后1种方法相结合。这样更容易得到满足要求的表面粗糙度。
3) 图形电镀。图形电镀是指将干膜覆盖在经过孔处理的铜箔板上,使用阳纹底片进行曝光和显影,形成阴纹线路图案,并通过电镀方式给线路覆盖一层耐蚀金属的工艺。其中,感光干膜的作用是作为电镀保护层。其工艺中最关键的是控制铜层厚度和均匀性,如果铜层过厚或不均匀,在闪蚀后可能会残留铜层引发短路问题;如果铜层过薄或不均匀,在闪蚀过程中部分线路可能会被完全蚀刻掉,或者残留的铜层厚度不足,导致线路截面形状变形。一些研究学者采用实验设计、数值模拟和电化学实验等方法,研究会对细线路电镀铜的均匀性产生影响的因素、以及适用于半加成工艺或改进半加成工艺制程的新型电镀铜添加剂。
4) 闪蚀。闪蚀技术是一项有效的工艺,其目的是去掉不需要的铜,并且能够防止所需要的图形区域的铜被去掉(尤其是图形侧壁)。蚀刻因子是判断蚀刻强弱的重要参考量之一,反映了蚀刻的效果和能力。侧向侵蚀量是在半加成法工艺中衡量线形质量的另一个重要指标。使用蚀刻药水去除铜的时候,由于药水具有流动性,其流动方向不好把控,很容易会发生侧向侵蚀的情况。如果侧向侵蚀过于严重,就会造成线路与基材方式脱离,最终导致制作精细线路失败。通过不断的实践操作,发现主要因素包括闪蚀的程度和药水特性。若闪蚀程度没有把控好,就很容易导致发生侧向侵蚀现象。所以,在实际操作工艺中,要经过日积月累的工艺操作经验,来精准地把握好闪蚀的程度以及药水的特性,来保证这一步骤的工艺具有更高的质量。为了确保产品质量的稳定性,传统闪蚀设备可能难以满足未来对品质的要求。引入真空和二流体相结合的闪蚀设备将成为未来的趋势,合理调配二流体段的液压和气压比例可以获得更好的线路效果。而与单独使用真空段或二流体段相比,将真空段与二流体段结合使用能够在制作线路时取得更优异的效果。
5) 化学沉铜。有研究学者提出了全新的化学沉铜速率控制配方,在探究化学铜沉积速率偏快的状况下基底对于拉力值的表现时,得出化学沉铜速率对于粗糙度0.45 μm的基材没有产生拉力方面的变化。其他研究使用表面改性在同一基底上产生增强的化学键来提高抗拉强度,但最终结果表明,产品的抗拉强度比较相似。虽然目前的半加成法技术满足了精细线路的需求,但不能忽视产品可靠性和功能等因素。国内半加成法工艺仍有很长的路要走,需要不断改进工艺和探索新的材料与制造方法,以提高产品的可靠性和功能,并确保其在长期使用中能够表现出色。
三、结语
随着先进封装技术的演进,与之适配的高端封装基板市场份额不断扩大,其制备工艺也日益受到产业与学界的重点关注。其中,基板精细化线路蚀刻工艺的精度控制水平持续提升。理解干膜在分辨率、附着力、显影性与耐显影性,以及耐蚀刻性与耐电镀性等方面的性能表现,有助于更清晰地认识其在制作精细线路工艺过程中的功能与作用。然而,必须指出的是,对线路精细化的追求不能以牺牲电子产品的实际可靠性为代价。因此,研究者需持续探索新材料与制造工艺,以提升线路的可靠性及功能性。这可能涉及电路布局设计的优化、材料耐久性与导电性能的改进,以及制造过程中各环节的精确控制,确保每一工艺步骤均能可靠、精准地完成。同时,也应充分考虑产品的实际应用环境,积极开展环境适应性测试,以保障产品在不同条件下的性能稳定性。这仍有待研究人员的进一步深入探索。
-
集成电路封装基板工艺详解(68页PPT)2024-11-01 1070
-
玻璃基板时代,TGV技术引领基板封装2024-05-30 6156
-
什么是覆铜陶瓷基板DPC工艺?2023-06-06 2392
-
详解半导体封装测试工艺2023-05-31 2723
-
一文详解封装互连技术2023-04-03 8512
-
一文详解封装制程工艺2023-02-06 7596
-
一文详解精密封装技术2022-12-30 2689
-
浅谈电子封装用陶瓷基板材料及其制备工艺2022-11-03 5365
-
《炬丰科技-半导体工艺》用于半导体封装基板的化学镀 Ni-P/Pd/Au2021-07-09 4075
-
四种功率型封装基板对比分析2020-12-23 1485
-
【转帖】一文读懂BGA封装技术的特点和工艺2018-09-18 2549
-
一文看懂铝基板生产工艺流程2018-02-27 45938
-
电子器件制备工艺2012-08-20 2329
全部0条评论

快来发表一下你的评论吧 !

