

从基于规则到基于模型的OPC和反演光刻技术
描述
通过观察偏移、辅助图形、衬线和其他掩模校正方法对光刻成像的影响,可以建立用作掩模版图校正的规则。一个简单的例子如图4-12所示,如果将左上角的目标图形或设计目标作为掩模版图,则会获得与目标图形有着显著偏差的光刻胶轮廓(右上)。与目标图形相比,光刻胶轮廓的末端缩短了。此外,图形拐角处的轮廓形状发生了强烈的变形。采用几种基于规则的校正方法,获得新的经光学邻近效应校正后的掩模版图(OPC掩模版图,左下)。校正后掩模版图的光刻胶轮廓更接近于目标图形(右下)。
将少数规则应用于给定目标图形比较简单,然而,随着工艺因子K1的不断降低,光刻工艺会引起更严重的邻近效应。与特征尺寸相比,不同特征图形之间的相互作用距离会增加。因此,越来越多的相互作用场景需要被考虑进来,并且需要日益复杂的掩模校正方法来补偿邻近效应。如此一来,OPC规则的数量呈指数级增长。对于先进半导体制程而言,完全基于规则的OPC变得越来越难,且不切实际。
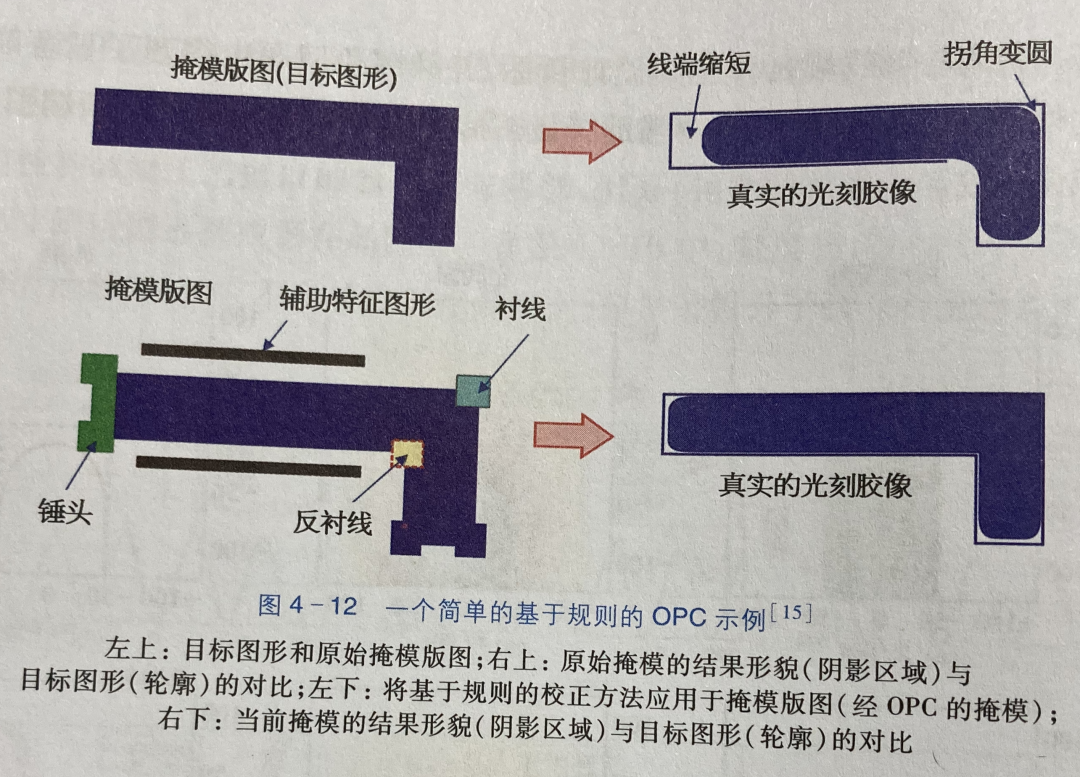
基于模型的OPC采用高效(紧姿)的光刻成像模型和光刻胶反应模型来预测推模版图的必要修正。其基本思想、概念和方法是由 Rieger 和 Stirniman ,以及 Nick Cobb共同提出并开发的。该方法的基本思想如图4-13所示。首先,将原始掩模版图的边缘分成几部分,这个过程称为碎片化:然后,调整各个部分的位置,最大限度地减少每次调整掩模后获得的成像轮廓与目标图形之间的差异。在每次迭代中,都会执行一次仿真。Cobb 使用SOCS 成像算法来实现空间像的高效计算(参见2.2.3节)。Rieger 和 Stirniman 使用经验化的行为模型,这些模型基于适当内核(区域样本)的卷积。数值化的有效卷积运算的应用以及图像计算对特征边缘或边缘位置误差的限制,使得基于模型的 OPC能够应用于掩模上的大块区域,甚至整个芯片的版图。

第一个基于模型的OPC得到的掩模几何形状是通过已知解的扰动获得的。在许多情况下,以这种方式获得的掩模几何形状往往不是最佳的解决方案,例如,图4-13所示原始的基于模型的OPC永远不会找到亚分辨率辅助图形,而这些辅助图形已被证明可用于增加孤立/半密集特征图形的焦深。因此,各种用于添加辅助图形的基于规则和模型的策略已经被设计出来,这些策略包括受物理效应启发的干涉映射技术、在数字网格上专门的“有效”矩阵的计算以及机器学习的应用。
一般而言,当为一个具有已知特征的系统设计输入图形(或掩模),以使输出结果尽可能接近目标图形时,可以将 OPC视为一个图像合成问题。最先进的 OPC 算法是从逆向问题的抽象数学公式开始的(图4-14)。为此,图像形成过程在数学上可以被表示为

式中,H为将掩模传输函数 m(x,y)映射到输出强度函数I(x,y)的前馈模型。一般来说,H是不可逆的。该优化问题的解是确定一个最合适的掩模版图m(x,y),其生成的图像强度分布接近于目标图形强度分布Z(x,y):

式中,d为一个合适的用于量化图像和目标之间相似性的距离度量。有关光源掩模协同优化(SMO)和反演光刻技术(ILT)的评价函数的进一步讨论,请参见4.5节。出于实际有效性考虑,得到的掩模版图 m(x,y)应该可以通过合理的方式被制造出来。
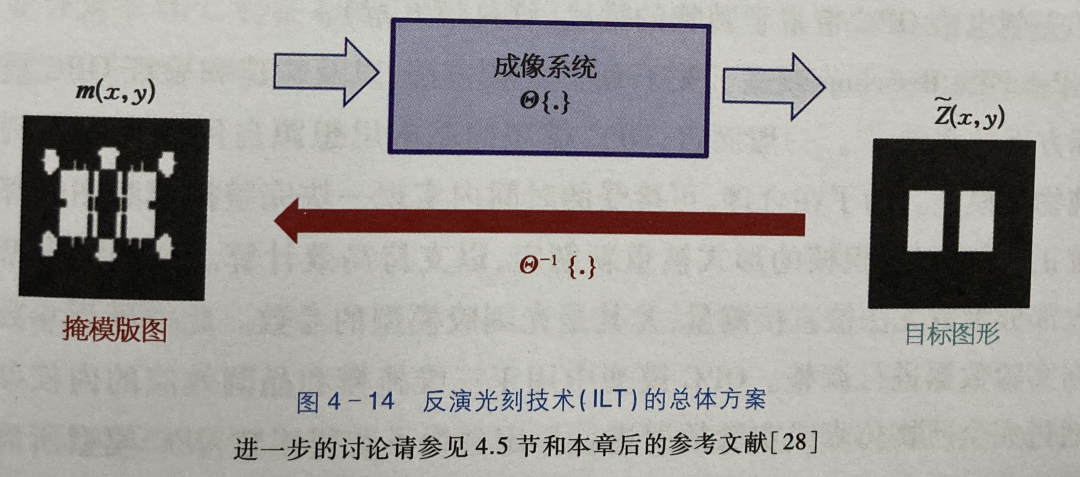
解决上述优化问题的早期尝试包括采用像素翻转、模拟退火和交替投影技术等。为了获得可制造的掩模,在掩模版图优化中采用了不同的正则化方案。Granik 给出了用于解决反演光刻掩模问题的最新方法的全面概述和分类。最先进的反演光刻技术(ILT) 应用高效的成像(和光刻胶)模型,并结合各种先进的优化技术来确定基于目标设计图形的最佳掩模版图。掩模版图和照明形态的优化采用了类似的技术,这些技术经常在SMO 中被结合使用。4.5节将对此类技术进行概述,并讨论其各个重要方面,还将列出相关文献和所选示例的参考资料。
尽管ILT提供了(理论上)最佳解决方案,但它很少被应用于整个掩模版图。在实际应用中,ILT经常用于优化热点( hotspots)区域的掩模版图,这些是整个掩模版图中非常容易出现图形错误的位置。此外,ILT 也被用于生成辅助图形的放置规则。
-
OPC模型和其工艺流程的简单介绍2026-01-28 1200
-
最全最详尽的半导体制造技术资料,涵盖晶圆工艺到后端封测2025-04-15 1889
-
浙大、微信提出精确反演采样器新范式,彻底解决扩散模型反演问题2024-11-27 1508
-
突破!打破国外垄断,中国首款自主可控芯片光刻OPC软件2023-10-20 3819
-
面向光刻的设计规则建立及优化2023-06-14 1009
-
模型添加与规则设置.zip2022-12-30 474
-
来帮帮孩子吧,关于磁传感器测电流反演得出幅值和电位。2022-12-04 8020
-
计算光刻技术的发展2022-10-26 4617
-
OPC UA SDK for Java通过OPC基金会认证2022-06-08 11543
-
嵌入式OPC网关的相关资料推荐2021-12-23 996
-
半导体光刻技术基本原理2021-07-26 2899
-
AltaRica3.0模型到NuSMVP模型的转换规则和算法2021-04-23 1369
-
光刻机工艺的原理及设备2020-07-07 17566
-
光刻技术原理及应用2012-01-12 10855
全部0条评论

快来发表一下你的评论吧 !

