

芯片封装工艺流程介绍
描述
封装(packaging,PKG):主要是在半导体制造的后道工程中完成的。即利用膜技术及微细连接技术,将半导体元器件及其他构成要素在框架或基板上布置、固定及连接,引出接线端子,并通过塑性绝缘介质灌封固定,构成整体主体结构的工艺。
芯片封装工艺流程
芯片封装工艺流程主要可以分为以下几步:
一、芯片切割
先在芯片背面贴上蓝膜并置于铁环之上,之后再送至芯片切割机上进行切割,目的是用切割机将晶圆上的芯片切割分离成单个晶粒。
二、晶粒黏贴
先将晶粒黏着在导线架上,也叫作晶粒座,预设有延伸IC晶粒电路的延伸脚,用银胶对晶粒进行黏着固定。
三、焊线
将晶粒上之接点为第一个焊点,内部引脚上接点为第二焊点,先把金线之端点烧成小球,再将小球压焊在第一焊点上。接着依设计好的路径拉金线,把金线压焊在第二点上完成一条金线之焊线动作。焊线的目的是将晶粒上的接点用金线或者铝线铜线连接到导线架上之内的引脚,从而将ic晶粒之电路讯号传输到外界。
四、封胶
将导线架预热,再将框架置于压铸机上的封装模具上,再以半溶化后的树脂挤入模中,树脂硬化后便可开模取出成品。封胶的目的是防止湿气等由外部侵入,有效地将内部产生的热量排出外部,提供能够手持的形体。
五、切脚成型
封胶之后,需要先将导线架上多余的残胶去除,经过电镀以增加外引脚的导电性及抗氧化性,而后再进行切脚成型。将导线架上已封装完成的晶粒,剪切分离并将不需要的连接用材料切除。
切脚成型之后,一个芯片的封装过程基本就完成了,后续还需要一些处理才能让芯片能够稳定高效的工作,包括去胶、去纬、去框等等,最后再测试检验,所有流程走完之后,确保芯片没有问题,这个时候芯片就能够正常的工作了。
因应市场需求,年产能亿颗的摩尔精英无锡SiP先进封测中心于2022年正式量产,为客户提供系统级封装(SiP)从设计到量产的完整解决方案,同时与一线封装基板厂深度合作,提供灵活高效的Flip-chip1封装解决方案(FCCSP/FCBGA工程批和量产)。无锡SiP先进封测中心测试车间配置数十套以自主机台为基础的CP/FT测试产能,目前已为20家客户50余款芯片产品完成工程开发和数亿颗芯片的量产测试。
摩尔精英封测协同解决方案
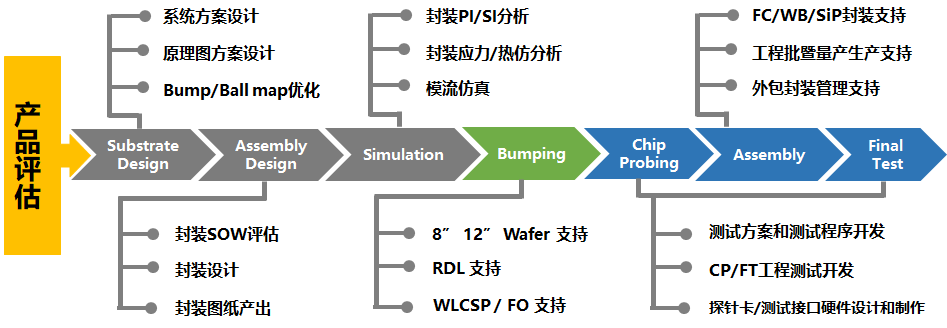
01系统级封装SiP
摩尔精英SiP一站式解决方案,贯穿电路设计到封装量产的产品生命周期,让客户最大化省心省力。客户仅需输入产品功能需求,例如现有PCB原理图,后续的设计和生产可完全交由摩尔来完成,统筹完成原理图设计、芯片选型、元器件选型、SiP设计、生产和测试。目前摩尔精英已服务了包括TCL、中车、长虹在内的多家头部系统厂商,和面向多样化市场的中小方案/模组厂商。
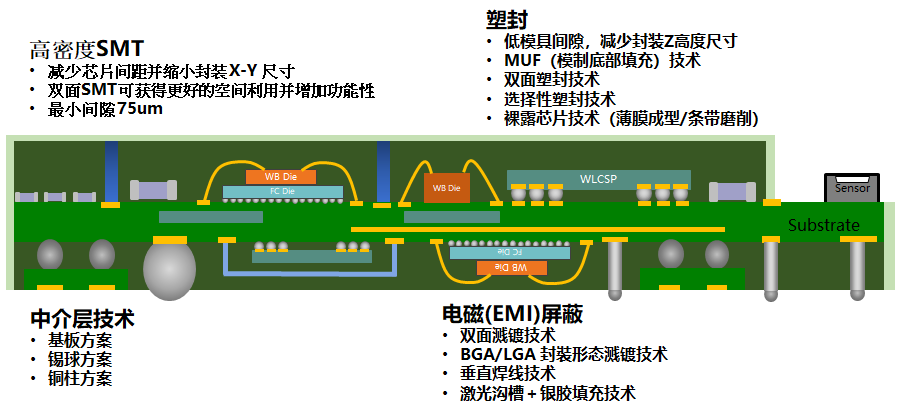
02Flip-chip倒装封装
摩尔精英无锡SiP先进封测中心提供面向DPU、HPC、CPU、GPU、高端服务器、高性能ASSP、FPGA等产品的Flip-Chip封装完整解决方案,包括封装设计、仿真、工程批和量产。SiP/FCCSP/FCBGA整体产能可达5KK每月。

审核编辑:汤梓红
-
半导体封装工艺流程的主要步骤2025-05-08 6146
-
传统封装工艺流程简介2024-01-05 3382
-
SMT组装工艺流程的应用场景2023-10-20 1263
-
半导体芯片封装工艺流程,芯片定制封装技术2023-06-26 3562
-
封装工艺流程--芯片互连技术2022-12-05 2496
-
芯片封装工艺流程讲解2022-10-31 13024
-
芯片封装工艺流程是什么2021-08-09 73487
-
集成电路芯片封装工艺流程2021-07-28 14260
-
倒装晶片的组装工艺流程2018-11-23 4940
-
板上芯片封装的焊接方法及工艺流程简述2012-08-20 2795
-
ic封装工艺流程2010-07-18 3667
-
LAMP-LED封装工艺流程图2010-03-29 3844
-
BGA的封装工艺流程基本知识简介2010-03-04 7089
-
IC芯片的封装工艺流程2008-05-26 29512
全部0条评论

快来发表一下你的评论吧 !

