

半导体封装技术演进路线图
制造/封装
描述
本文参考“先进封装关键技术:TSV 研究框架(2023)”。摩尔定律放缓,芯片特征尺寸已接近物理极限,先进封装成为提升芯片性能,延续摩尔定律的重要途径。先进封装是指处于前沿的封装形式和技术,通过优化连接、在同一个封装内集成不同材料、线宽的半导体集成电路和器件等方式,提升集成电路的连接密度和集成度。目前,带有倒装芯片(FC)结构的封装、晶圆级封装(WLP)、系统级封装(SiP)、2.5D/3D 封装等均被认为属于先进封装范畴。 先进封装增速高于整体封装,2.5D/3D封装增速居先进封装之首。根据 Yole,2021 年,先进封装市场规模约 375 亿美元,占整体封装市场规模的 44%,预计到 2027 年将提升至占比 53%,约 650 亿美元,CAGR21-27为 9.6%,高于整体封装市场规模 CAGR21-276.3%。先进封装中的2.5D/3D 封装多应用于(x)PU, ASIC, FPGA, 3D NAND, HBM, CIS 等。 先进封装处于晶圆制造与封测制程中的交叉区域,涉及 IDM、晶圆代工、封测厂商,市场格局较为集中,前 6 大厂商份额合计超过80%。全球主要的 6 家厂商,包括 2 家 IDM 厂商(英特尔、三星),一家代工厂商(台积电),以及全球排名前三的封测厂商(日月光、Amkor、JCET),合计处理了超过 80%的先进封装晶圆。

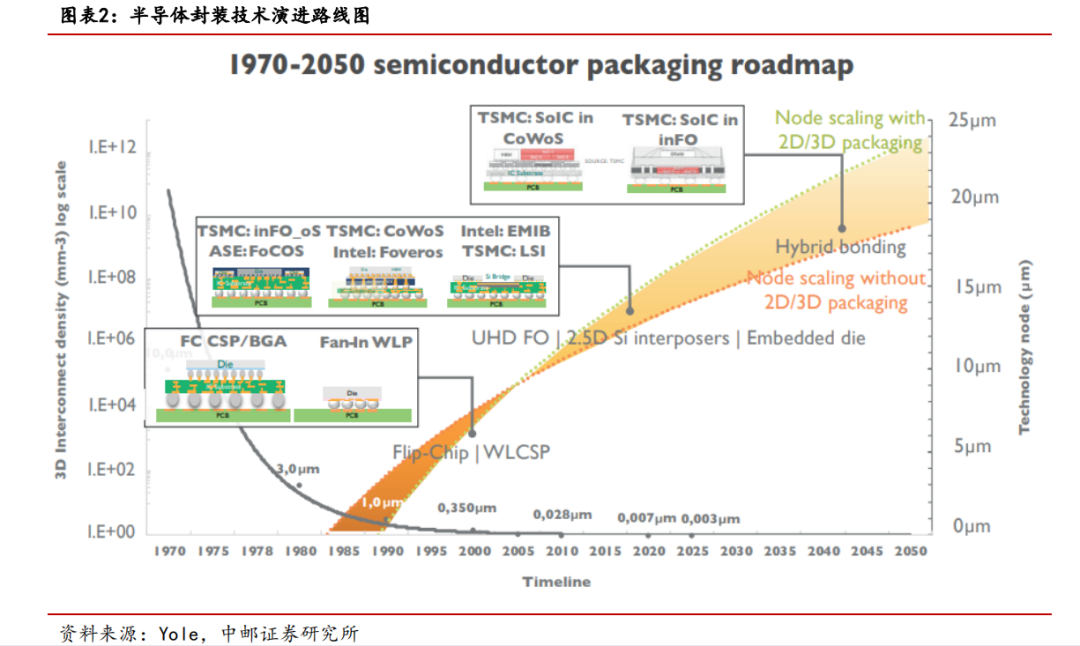
TSV 指 Through Silicon Via,硅通孔技术,是通过硅通道垂直穿过组成堆栈的不同芯片或不同层实现不同功能芯片集成的先进封装技术。TSV 主要通过铜等导电物质的填充完成硅通孔的垂直电气互连,减小信号延迟,降低电容、电感,实现芯片的低功耗、高速通信,增加带宽和实现器件集成的小型化需求。此前,芯片之间的连接大多都是水平的,TSV 的诞生让垂直堆叠多个芯片成为可能。 TSV 用途大致分为 3 种:背面连接、2.5D 封装、3D 封装TSV 有多种用途,可大致分为 3 种(如图表 8): (a) 垂直的背面连接,无芯片堆叠,如“简单的背面连接”。TSV 位于有源晶粒(active die)中,用于连接至晶圆背面的焊盘(bond pad); (b) 2.5D 封装。晶粒(die)连接至硅中介层(interposer),TSV 在中介层中; (c) 3D 封装。TSV 位于有源晶粒中,用于实现芯片堆叠。 目前,国内头部封测企业如长电科技、通富微电、华天科技、晶方科技等都在 TSV 有所布局。目前国内封测厂进行的 TSV 工序多用于CIS 等封装,高深宽比要求的 TSV 仍多由晶圆厂来完成。

此前,芯片之间的大多数连接都是水平的,TSV 的诞生让垂直堆叠多个芯片成为可能。Wire bonding(引线键合)和 Flip-Chip(倒装焊)的 Bumping(凸点)提供了芯片对外部的电互连,RDL(再布线)提供了芯片内部水平方向的电互连,TSV 则提供了硅片内部垂直方向的电互连。
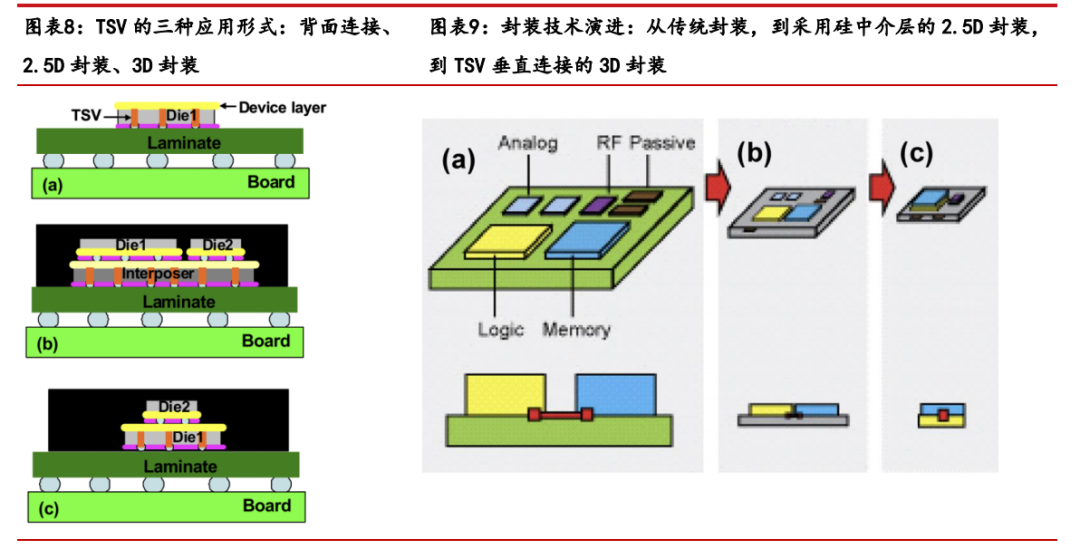
(a)TSV 作为简单背面连接:用于 CIS 和锗化硅(SiGe)功率放大器 TSV 三种主要应用方式中,简单的背面连接结构是技术难度最低的,也是 TSV技术首次大规模投入生产时的应用方向,如 CMOS 图像传感器(CIS)、SiGe 功率放大器两个产品就应用了 TSV 技术。 (b)TSV 应用于 2.5D 封装:FPGA 与简单的背面连接相比,2.5D 先进封装的硅中介层需要更小的 TSV 间距(≤50 μm),因此需要更先进的 TSV 工艺。
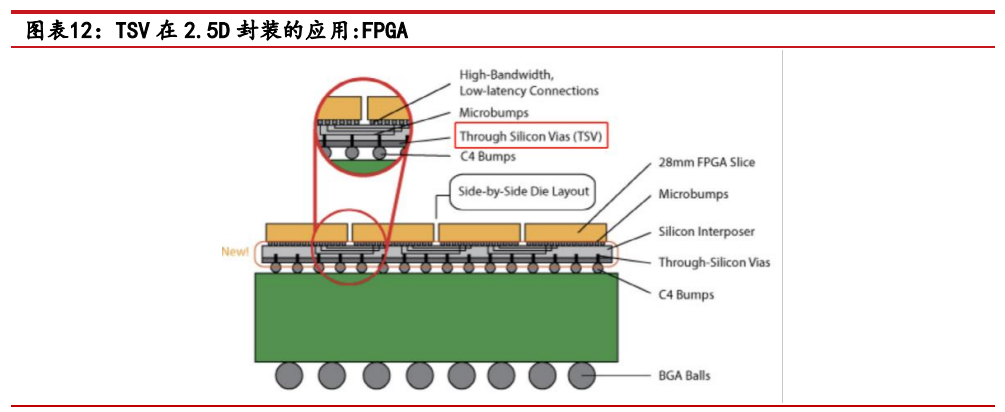
现场可编程门阵列(Field Programmable Gate Array,FPGA)器件是最早使用硅中介层的产品之一:硅中间层可以使芯片间密切连接,整合后的结构看起来像单个大尺寸的 FPGA 芯片,解决了早期直接构建单个大尺寸 FPGA 芯片的技术难题。 (c)TSV 应用于 3D 封装:存储器堆叠 储器堆叠是首批应用 3D 堆叠 TSV 结构的产品之一,和 2.5D 封装中硅中阶层对 TSV 间距的需求相似,但实际应用中难度更高,例如宽 I/O DRAM 设备。使用宽 I/O DRAM 和芯片堆叠的优势包括封装高度降低40%,功耗降低50%,带宽增加 6 倍。
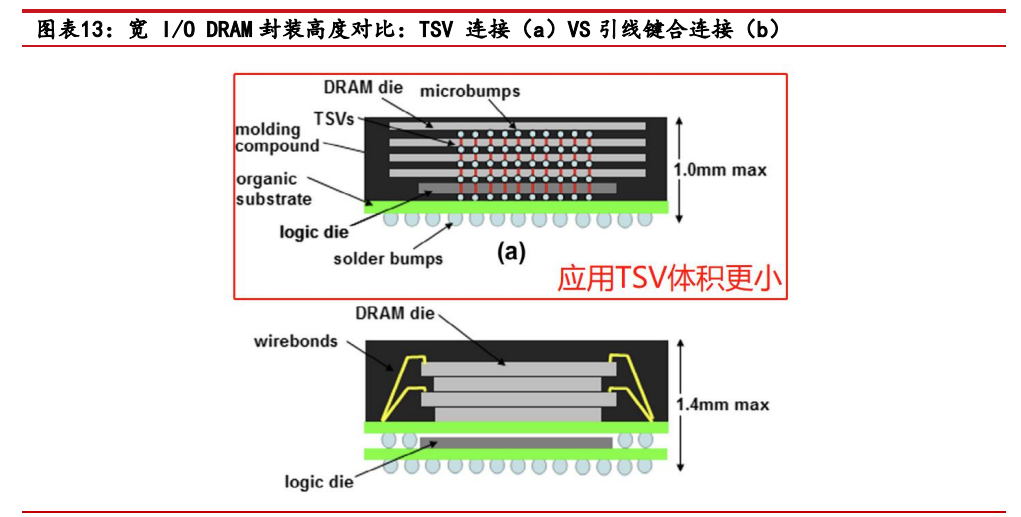
中国大陆封测市场目前主要以传统封装业务为主,经过多年的技术创新和市场积累,内资企业产品已由 DIP、SOP、SOT、QFP 等产品向 QFN/DFN、BGA、CSP、FC、TSV、LGA、WLP 等技术更先进的产品发展,并且在 WLCSP、FC、BGA 和 TSV 等技术上取得较为明显的突破,产量与规模不断提升,逐步缩小与外资厂商之间的技术差距。

在先进封装领域,北方华创客户定制的UBM/RDL 金属沉积设备、TSV 金属沉积设备、TSV 刻蚀设备及工艺已经实现了在国内主流先进封装企业的批量生产,并不断获得客户的重复采购订单;全新DESCUM 设备已完成研发并已正式投放市场。

TSV生产流程涉及到深孔刻蚀、PVD、CVD、铜填充、微凸点及电镀、清洗、减薄、键合等二十余种设备,其中深孔刻蚀、气相沉积、铜填充、清洗、CMP 去除多余的金属、晶圆减薄、晶圆键合等工序涉及的设备最为关键。
编辑:黄飞
-
博世碳化硅技术路线图持续演进2026-03-24 516
-
美国公布3D半导体路线图2024-03-25 1851
-
未来10年传感器怎么发展?美国半导体协会发布最新MEMS路线图2023-11-15 1740
-
浅谈半导体技术的未来发展路线图2022-12-26 2012
-
中国移动发布元宇宙MIGU演进路线图2021-11-05 6382
-
Intel公布2021年CPU架构路线图及封装技术2020-11-02 2562
-
物联网学习路线图2020-04-20 3874
-
IEEE发布半导体技术路线图,助力碳化硅和氮化镓材料发展2020-04-13 5992
-
意法半导体32位汽车单片机技术产品路线图资料合集免费下载2019-05-06 1328
-
在Tech Day活动中,三星阐释了下一步的闪存演进路线图2018-10-19 2271
-
嵌入式学习路线图分享2018-07-13 2928
-
嵌入式学习路线图2012-08-16 40407
-
2007年国际半导体技术发展路线图摘要介绍2009-12-14 1042
-
给大家共享:移动通信标准演进路线2009-09-18 3742
全部0条评论

快来发表一下你的评论吧 !

