
资料下载

电子封装材料与工艺的学习笔记详细资料免费下载
本文档的主要内容详细介绍的是电子封装材料与工艺的学习笔记详细资料免费下载包括了:第一章 集成电路芯片的发展与制造,第二章 塑料、橡胶和复合材料,第三章 陶瓷和玻璃,第四章 金属,第五章 电子封装与组装的软钎焊技术,第六章 电镀和沉积金属涂层,第七章 印制电路板的制造,第八章 混合微电路与多芯片模块的材料与工艺,第九章 电子组件中的粘接剂、 下填料和涂层,第十章 热管理材料及系统
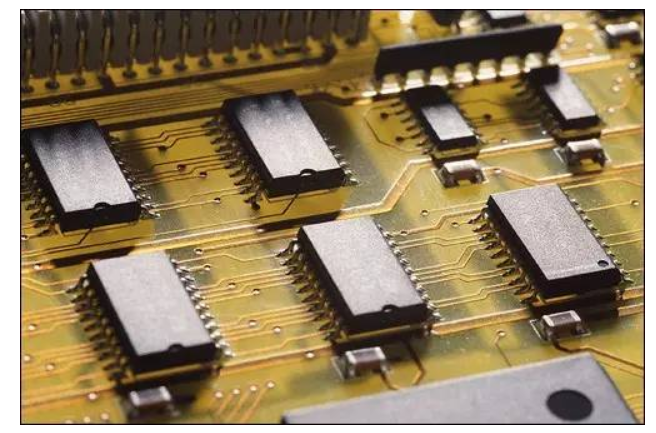
1、原子结构:原子是由高度密集的质子和中子组成的原子核以及围绕它在一定轨道(或能级)上旋转的荷负电的电子组成(Neils Bohr 于1913 年提出)。当原子彼此靠近时,它们之间发生交互作用的形成所谓的化学键,化学键可以分成离子键、共价键、分子键、氢键或金属键;
2、真空管(电子管):
a.真空管问世于1883 年Edison(爱迪生)发明白炽灯时,1903 年英格兰的J.A.Fleming 发现了真空管类似极管的作用。在爱迪生的真空管里,灯丝为阴极、金属板为阳极;
b.当电子管含有两个电极(阳极和阴极)时,这种电路被称为二极管,1906 年美国发明家LeeDeForest 在阴极和阳极之间加入了一个栅极(一个精细的金属丝网),此为最早的三极管,另外更多的电极如以致栅极和帘栅极也可以密封在电子管中,以扩大电子管的功能;
c.真空管尽管广泛应用于工业已有半个多世纪,但是有很多缺点,包括体积大,产生的热量大、容易烧坏而需要频繁地更换,固态器件的进展消除了真空管的缺点,真空管开始从许多电子产品的使用中退出;
3、半导体理论:
a.在IC 芯片制造中使用的典型半导体材料有元素半导体硅、鍺、硒,半导体化合物有砷化镓(GaAs)、磷砷化镓(GaAsP)、磷化铟(InP);
b.二极管(一个p-n 结),当结上为正向偏压时可以导通电流,当反向偏压时则电流停止;
c.结型双极晶体管:把两个或两个以上的p-n 结组合成一个器件,导致了晶体管的出现,晶体管是一种能够放大信号或每秒开关电流几十亿次的器件。最初的器件使用点接触穿入鍺半导体本体,随后的晶体管使用鍺作为半导体的结(双极)型晶体管,鍺这种半导体材料后来被硅所代替;(基极B发射极E 集电极C)
d.场效应晶体管(FET)(源区、漏区、栅区)
e.结型场效应晶体管(JFET):电子不穿过p-n 结,而是从两个p 型半导体之间形成所谓的n-沟道从源极向漏极流动,n-沟道作为晶体管的输出部分,而栅到源的p-n 结是输入部分;
f.金属氧化物半导体场效应晶体管(MOSFET),它是以JFET 晶体管同样的原理进行工作的,但使用施加在内建电容器两端的输入电压来控制源极到漏极的电子流动
g.互补型金属氧化物半导体场效应晶体管:当两个MOSFET 晶体管(一个是n-p-n 型,另一个是p-n-p 型)连接在一起时,这种组合结构叫做互补型MOSFET 或互补型金属氧化物半导体场效应晶体管(CMOSFET),其优点是使电路简化(不需要负载电阻)、很低的功率耗散以及产生一个与输入信号反向的输出信号的能力;
4、集成电路基础:
一个集成电路(IC)芯片是把元器件连在一起的集合体,在一个单片半导体材料上制造出一个完整的电子电路。第一块IC 的构思和建造应该归功于于Texas Instruments 公司的Jcak Kilby 在1958年的工作。每门的功率与特征尺寸呈线性变化,而每个芯片的功耗P 却主要受到与特征尺寸二次方成反比的影响,如下式所示: P=f(频率,C,V2,门数),其中频率为时钟频率、 C 为电容、V为电压、门数为芯片面积/特征尺寸的平方;
5、集成电路芯片制造:
a.晶锭的生长与晶圆片的制备:硅的熔点1415℃,切克劳斯基(Czochralski CZ)法是最常用的生长硅锭的方法,晶锭的形状包括在籽晶端形成的一个很细的圆形缩颈(直径约3.0mm),然后是大的圆柱体和带有一个钝尾的端部,晶锭的长度和直径取决于轴的旋转、籽晶的提拉速度、硅熔体的纯度与温度等,晶锭的尺寸有多种多样,直径从3in(75mm)到12in(300mm),最长的长度约为79in(2m),晶锭的生长速率约为2.5~3.0in/h(63.5~76.2mm/h)。然后将硅晶锭切成晶圆片并进行磨边、抛光、打标等处理;
b.洁净度:净化间是按照1ft3(0.0283m3)空气中允许有多少直径在0.5um 的颗粒物来分级的,一般可分为1 级~100000 级,例如1000 级净化间是在1ft3 空气中有1000 个尺寸为0.5um 的颗粒物,对于IC 制造来说,净化间的范围在1 级~1000 级,主要取决于工艺的需要;
c.集成电路制造:
氧化→光刻→扩散→外延→金属化→钝化→背面研磨→背面金属化→电性能测试→管芯分割(详细情况可参看《芯片制造工艺制程实用教程》内相关笔记)
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。 举报投诉
- 相关下载
- 相关文章






