

全球封装技术向先进封装迈进的转变
制造/封装
描述
半导体行业:先进封装关键技术
✓ 2021 年,先进封装市场规模约 375 亿美元,占整体封装市场规模的44%,预计到2027年将提升至占比53%,约 650亿美元,CAGR21-27为 9.6%
✓ 摩尔定律放缓,芯片特征尺寸已接近物理极限,先进封装成为提升芯片性能,延续摩尔定律的重要途径。
全球封装技术向先进封装迈进

先进封装是指处于前沿的封装形式和技术,通过优化连接、在同一个封装内集成不同材料、线宽的半导体集成电路和器件等方式,提升集成电路的连接密度和集成度。目前,带有倒装芯片(FC)结构的封装、晶圆级封装(WLP)、系统级封装(SiP)、2.5D/3D 封装等均被认为属于先进封装范畴。
封装技术演进:从传统封装,到采用硅中介层的2.5D 封装,到 TSV 垂直连接的3D 封装
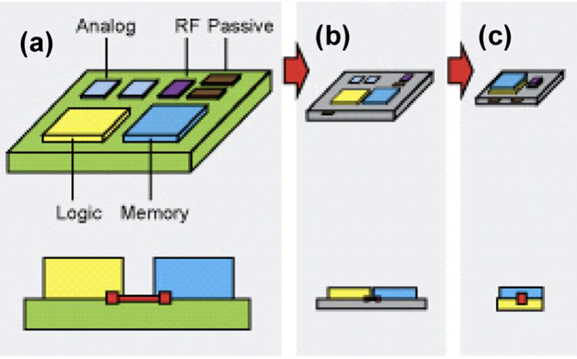
✓ 先进封装增速高于整体封装,2.5D/3D封装增速居先进封装之首。
根据Yole,2021年,先进封装市场规模约 375亿美元,占整体封装市场规模的44%,预计到2027年将提升至占比53%,约 650亿美元,CAGR21-27为 9.6%,高于整体封装市场规模CAGR21-276.3%。先进封装中的2.5D/3D封装多应用于(x)PU, ASIC, FPGA, 3D NAND, HBM, CIS等,受数据中心、高性能计算、自动驾驶等应用的驱动,2.5D/3D封装市场收入规模CAGR21-27高达 14%,在先进封装多个细分领域中位列第一。
✓ 先进封装处于晶圆制造与封测制程中的交叉区域,涉及IDM、晶圆代工、封测厂商,市场格局较为集中,前6 大厂商份额合计超过80%。全球主要的 6 家厂商,包括 2 家 IDM 厂商(英特尔、三星),一家代工厂商(台积电),以及全球排名前三的封测厂商(日月光、Amkor、JCET),合计处理了超过80%的先进封装晶圆。
✓ TSV 指Through Silicon Via,硅通孔技术,是通过硅通道垂直穿过组成堆栈的不同芯片或不同层实现不同功能芯片集成的先进封装技术。
TSV 主要通过铜等导电物质的填充完成硅通孔的垂直电气互连,减小信号延迟,降低电容、电感,实现芯片的低功耗、高速通信,增加带宽和实现器件集成的小型化需求。此前,芯片之间的连接大多都是水平的,TSV的诞生让垂直堆叠多个芯片成为可能。
相机模组尺寸对比:带引线键合的图像传感器(a)VS 带 TSV 的图像传感器(b)
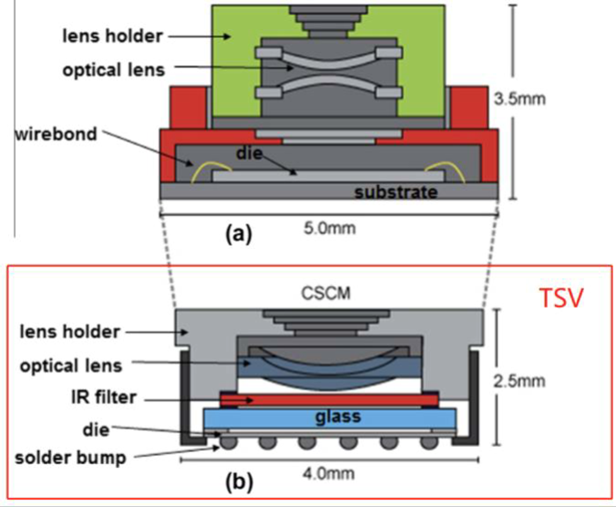
✓ TSV 用途大致分为 3 种:背面连接(应用于CIS 等)、2.5D封装(TSV在硅中介层)、3D封装(TSV位于有源晶粒中,用于实现芯片堆叠)。
目前,国内头部封测企业如长电科技、通富微电、华天科技、晶方科技等都在TSV有所布局。目前国内封测厂进行的TSV工序多用于CIS等封装,高深宽比要求的 TSV 仍多由晶圆厂来完成。
TSV 的三种应用形式:背面连接、2.5D封装、3D 封装
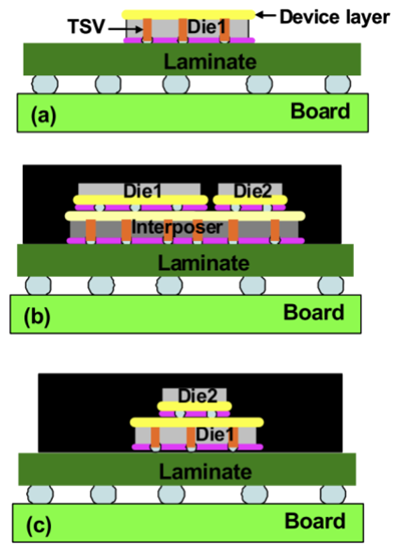
✓ TSV 制造涉及的相关设备种类繁多。
以2.5D interposer为例,其制造流程可以分为三大部分:TSV process-Via last or Via middle(TSV孔的制造)、Front side process-Dual Damascene process(正面制程-大马士革工艺)以及 Backside process-Cu Expose & RDL process(背面制程-露铜刻蚀和 RDL制程)。每个部分具体环节对应不同设备及不同指标。TSV生产流程涉及到深孔刻蚀、PVD、CVD、铜填充、微凸点及电镀、清洗、减薄、键合等二十余种设备,其中深孔刻蚀、气相沉积、铜填充、清洗、CMP去除多余的金属、晶圆减薄、晶圆键合等工序涉及的设备最为关键。
2.5D interposer 制造流程及所需设备
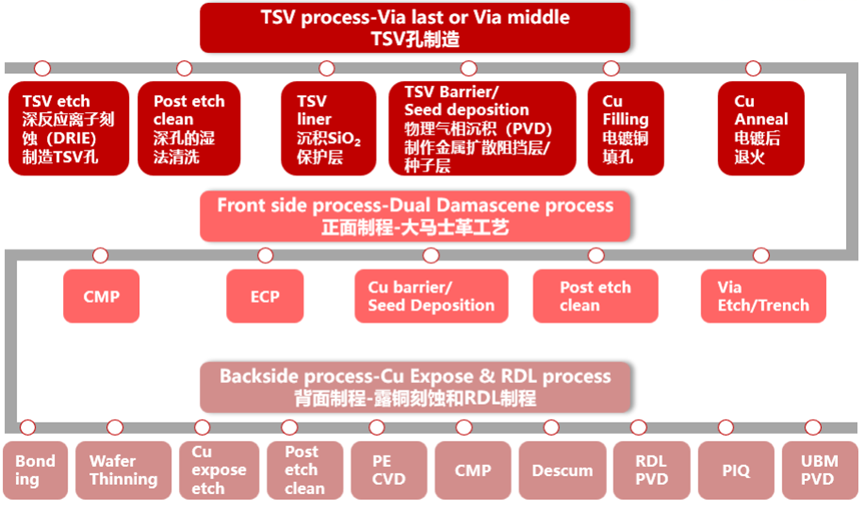
✓ 国内封测厂TSV 布局情况:多家头部厂商已有布局
内资封测厂商向TSV等先进封装领域突破。全球半导体产业经历二次产业转移,目前处于第三次产业转移的进程之中,作为半导体领域壁垒相对较低的领域,封测产业目前主要转移至亚洲区域,主要包括中国大陆、中国台湾、东南亚等。
封测是中国大陆集成电路发展最为完善的板块,技术能力与国际先进水平比较接近,我国封测市场已形成内资企业为主的竞争格局。中国大陆封测市场目前主要以传统封装业务为主,经过多年的技术创新和市场积累,内资企业产品已由DIP、SOP、SOT、QFP等产品向QFN/DFN、BGA、CSP、FC、TSV、LGA、WLP等技术更先进的产品发展,并且在WLCSP、FC、BGA 和 TSV 等技术上取得较为明显的突破,产量与规模不断提升,逐步缩小与外资厂商之间的技术差距,极大地带动我国封装测试行业的发展。
国内封测企业三梯队中,第一梯队企业在先进封装领域在TSV 已有布局

我国头部封测企业,如长电科技、通富微电、华天科技、晶方科技已有采用TSV技术封装的产品批量出货。2.5D/3D封装所需的晶圆内部的加工如TSV加工,硅转接板加工等工序属于晶圆厂擅长制程,而晶圆,裸芯片(Die)之间的高密度互联和堆叠,以及和基板,接点的互联技术属于芯片后道成品制造环节的优势。
应用于CoWoS等2.5D/3D先进封装中的TSV技术对深宽比等有更高要求,需要用到诸多前道设备,仍多由晶圆厂来完成。国内封测厂则在先进封装平台、CIS封装等领域对 TSV技术有所布局。长电科技的XDFOI技术平台有 TSV less和TSV方案。通富微电 2021 年在高性能计算领域建成了 2.5D/3D 封装平台(VISionS)及超大尺寸 FCBGA研发平台,并完成高层数再布线技术开发,可为客户提供晶圆级和基板级Chiplet 封测解决方案;在存储器领域,多层堆叠NAND Flash 及LPDDR封装实现稳定量产,并在国内首家完成基于TSV 技术的3DS DRAM 封装开发。华天科技工业级12 吋 TSV-CIS 产品已实现量产。晶方科技应用晶圆级硅通孔(TSV)封装技术,聚焦以影像传感芯片为代表的智能传感器市场,封装的产品主要包括CIS芯片、TOF芯片、生物身份识别芯片、MEMS 芯片等,应用于智能手机、安防监控数码、汽车电子等市场领域。
头部封测企业量产主要封装形式
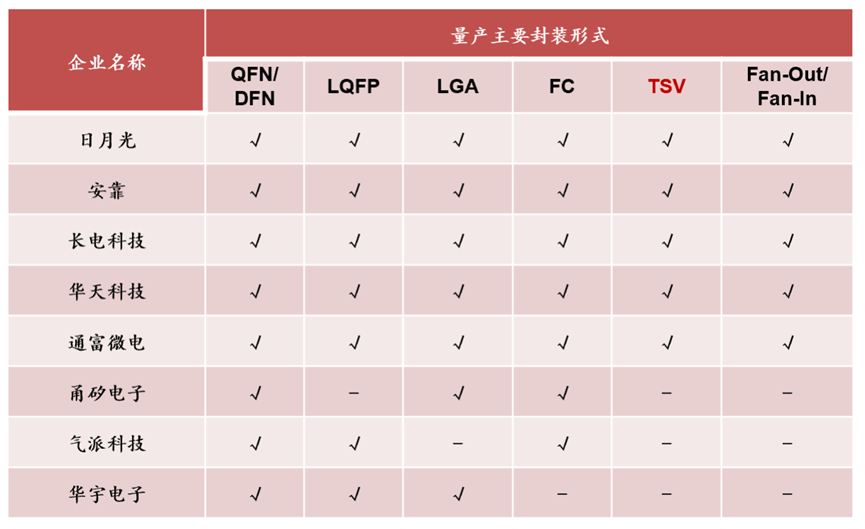
编辑:黄飞
-
先进封装不是选择题,而是成题北京中科同志科技股份有限公司 2026-03-09
-
先进封装技术-19 HBM与3D封装仿真2025-01-08 3760
-
先进封装技术-17硅桥技术(下)2024-12-24 3682
-
CoWoS先进封装技术介绍2024-12-17 6533
-
先进封装技术的类型简述2024-10-28 3671
-
先进封装技术综述2024-06-23 3958
-
半导体先进封装技术2024-02-21 1962
-
什么是先进封装?先进封装技术包括哪些技术2023-10-31 4282
-
先进封装技术科普2023-08-14 1425
-
什么是先进封装技术的核心2023-08-05 1166
-
先进封装技术的发展与机遇2022-12-28 6684
-
#硬声创作季 先进封装技术详解——什么是良率?什么是晶圆级封装?什么是2.5D封装?Mr_haohao 2022-10-21
-
先进封装技术及发展趋势2020-10-12 19973
-
先进封装技术的发展趋势2018-11-23 3812
全部0条评论

快来发表一下你的评论吧 !

