
资料下载

×
用于倒装芯片设计的重新布线层布线技术解析
消耗积分:1 |
格式:rar |
大小:0.8 MB |
2017-12-01
工程师在倒装芯片设计中经常使用重新布线层(RDL)将I/O焊盘重新分配到凸点焊盘,整个过程不会改变I/O焊盘布局。然而,传统布线能力可能不足以处理大规模的设计,因为在这些设计中重新布线层可能非常拥挤,特别是在使用不是最优化的I/O凸点分配方法情况下。这种情况下即使采用人工布线,在一个层内也不可能完成所有布线。
随着对更多输入/输出(I/O)要求的提高,传统线绑定封装将不能有效支持上千的I/O。倒装芯片装配技术被广泛用于代替线绑定技术,因为它不仅能减小芯片面积,而且支持多得多的I/O。倒装芯片还能极大地减小电感,从而支持高速信号,并拥有更好的热传导性能。倒装芯片球栅阵列(FCBGA)也被越来越多地用于高I/O数量的芯片。
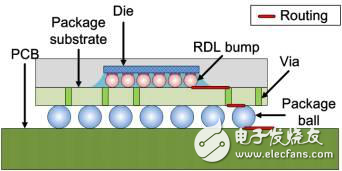
图1:倒装芯片横截面:信号线经过包括重新布线层在内的三个面。
重新布线层(RDL)是倒装芯片组件中芯片与封装之间的接口界面(图1)。重新布线层是一个额外的金属层,由核心金属顶部走线组成,用于将裸片的I/O焊盘向外绑定到诸如凸点焊盘等其它位置。凸点通常以栅格图案布置,每个凸点都浇铸有两个焊盘(一个在顶部,一个在底部),它们分别连接重新布线层和封装基板。因此重新布线层被用作连接I/O焊盘和凸点焊盘的层。

图2:自由分配(FA)和预分配(PA)是两种焊盘分配方法。外围I/O(PI/O)和区域I/O(AI/O)是两种倒装芯片结构。
倒装芯片结构与焊盘分配
以往研究已经明确了两种倒装芯片结构和两种焊盘分配方法,如图2所示。自由分配(FA)和预分配(PA)是两种焊盘分配方法,而外围I/O(PI/O)和区域I/O(AI/O)是两种倒装芯片结构。
两种焊盘分配方法的区别在于凸点焊盘和I/O焊盘之间的映射是否定义为输入。自由分配的问题是,每个I/O焊盘都可以自由分配到任意凸点焊盘,因此分配与布线需要一起考虑。而对预分配来说,每个I/O焊盘必须连接指定的凸点焊盘,因此需要解决复杂的交叉连接问题。预分配问题的解决比自动分配要难,但对设计师来说则更加方便。
两种倒装芯片结构分别代表不同的I/O布局图案。AI/O和PI/O的挑战分别在于将I/O放在中心区域和将I/O放在裸片外围。目前PI/O更加流行,因为它简单,设计成本低,虽然AI/O理论上可以提供更好的性能。
随着对更多输入/输出(I/O)要求的提高,传统线绑定封装将不能有效支持上千的I/O。倒装芯片装配技术被广泛用于代替线绑定技术,因为它不仅能减小芯片面积,而且支持多得多的I/O。倒装芯片还能极大地减小电感,从而支持高速信号,并拥有更好的热传导性能。倒装芯片球栅阵列(FCBGA)也被越来越多地用于高I/O数量的芯片。
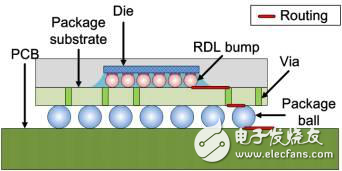
图1:倒装芯片横截面:信号线经过包括重新布线层在内的三个面。
重新布线层(RDL)是倒装芯片组件中芯片与封装之间的接口界面(图1)。重新布线层是一个额外的金属层,由核心金属顶部走线组成,用于将裸片的I/O焊盘向外绑定到诸如凸点焊盘等其它位置。凸点通常以栅格图案布置,每个凸点都浇铸有两个焊盘(一个在顶部,一个在底部),它们分别连接重新布线层和封装基板。因此重新布线层被用作连接I/O焊盘和凸点焊盘的层。

图2:自由分配(FA)和预分配(PA)是两种焊盘分配方法。外围I/O(PI/O)和区域I/O(AI/O)是两种倒装芯片结构。
倒装芯片结构与焊盘分配
以往研究已经明确了两种倒装芯片结构和两种焊盘分配方法,如图2所示。自由分配(FA)和预分配(PA)是两种焊盘分配方法,而外围I/O(PI/O)和区域I/O(AI/O)是两种倒装芯片结构。
两种焊盘分配方法的区别在于凸点焊盘和I/O焊盘之间的映射是否定义为输入。自由分配的问题是,每个I/O焊盘都可以自由分配到任意凸点焊盘,因此分配与布线需要一起考虑。而对预分配来说,每个I/O焊盘必须连接指定的凸点焊盘,因此需要解决复杂的交叉连接问题。预分配问题的解决比自动分配要难,但对设计师来说则更加方便。
两种倒装芯片结构分别代表不同的I/O布局图案。AI/O和PI/O的挑战分别在于将I/O放在中心区域和将I/O放在裸片外围。目前PI/O更加流行,因为它简单,设计成本低,虽然AI/O理论上可以提供更好的性能。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。 举报投诉
评论(0)
发评论
- 相关下载
- 相关文章






