
资料下载

×
3D封装对电源管理器件性能及功率密度的提升
消耗积分:0 |
格式:rar |
大小:0.52 MB |
2017-06-07
叠层放置MOSFET 的好处
为了克服分立方案的不足,TI 发明了Powerstack™封装技术。不局限于两个维度,Powerstack™封装方案利用三个维度,把MOSFET 堆叠在一个创新的封装里。和其他封装技术类似,堆叠的主要好处是充分利用了3D 的集成度。堆叠技术减小了芯片的2D 面积,并节省了板空间。当然,Powerstack™封装除了节省空间,在其他方面也有一定的优势。
Powerstack™封装的额外优势是增强了电性能和热性能。如上所述,堆叠方式通过公共点的直接连接消除了一些电寄生参数。Powerstack™封装中的铜片连接是一种非常有效的技术,它可以充分的利用封装技术并提供非常低的阻抗。同时,TI 的NexFET™也很适用于堆叠技术,因为其地端可以和封装的散热片连在一起,更有效的把热传递给印制板。Powerstack™充分利用了各种封装技术和材料,可以实现更多的集成。
TI NexFET™同步BUCK 功率模块是一个典型的堆叠封装实例,它把两个MOSFET 集成在一个小外形封装内。再在同样的封装内加入一个控制器就构成了完整的功率控制部分。
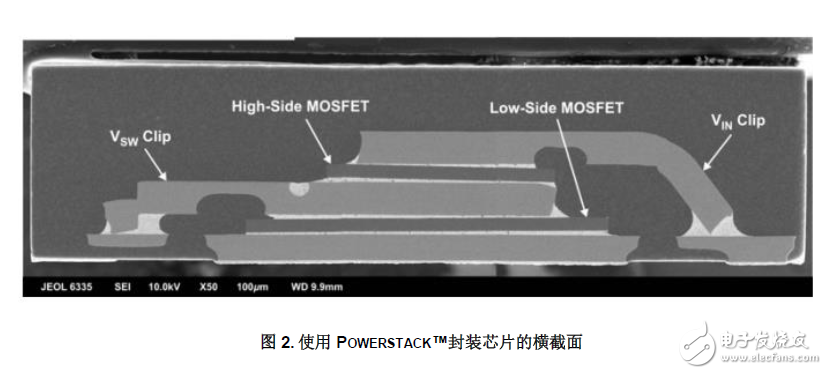
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。 举报投诉
评论(0)
发评论
- 相关下载
- 相关文章






