
资料下载

×
基于集成无源器件和硅转接板集成方案
消耗积分:1 |
格式:rar |
大小:0.77 MB |
2017-10-30
无源器件是智能消费电子等手持设备的重要组成部分,但也是占据较大空间的设备,在某些情况下占据70%以上的可用的电路板空间“。无源元器件小型化和高性能问题一直是研究的热点。集成无源器件,一般指共享同一基板或封装的多个无源器件,包括与互连基板同时制作的埋置无源器件,或者制作在单独的基板表面然后封装或表贴到互连基板上的无源整列或无源网络。而此时,穿硅通孔(Through Silicon Via,TSV )封装方案进人了研究者的视野。TSV 是由日本东北大学教授小柳光正等人|提出的一种3D 集成的制造方法。这是通过在芯片和芯片之间,晶圆和晶圆之间制造垂直通孔,实现芯片之间互连的最新技术。与以往的IC 封装键合和使用凸点的叠加技术不同,TSV能够在三维方向使得堆叠密度最大,而外形尺寸最小,大大改善了芯片速度和低功耗性能。集成无源器件和硅转接板的集成开启了一扇新的大门,优良的外形(系统体积,重量和占地面积)和更高的性能( 更高的传输速度,更低的功耗和RF 的寄生效应降低)是其显著的优点。
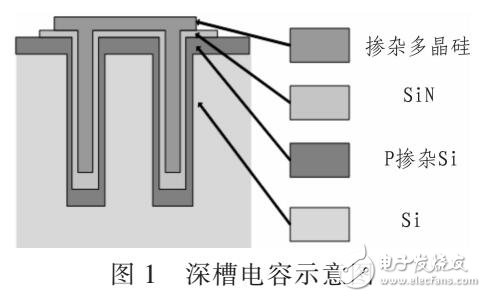
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。 举报投诉
评论(0)
发评论
- 相关下载
- 相关文章




