
热压键合工艺的技术原理和流程详解

半导体封装“倒装芯片(Flip Chip)”工艺技术的详解
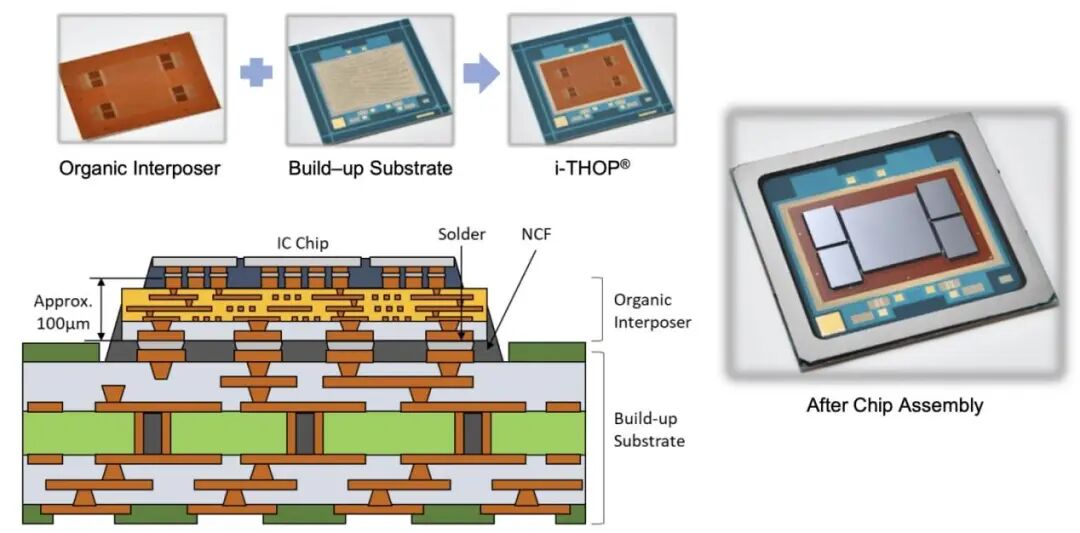
芯片封装方式终极指南(下)

系统级立体封装技术的发展与应用

TPSM336xx-Q1系列汽车级同步降压电源模块技术文档总结
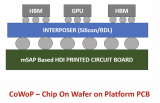
简单认识CoWoP封装技术

汉思新材料:底部填充胶可靠性不足如开裂脱落原因分析及解决方案

聊聊倒装芯片凸点(Bump)制作的发展史

系统级封装技术解析
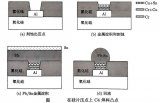
集成电路封装类型介绍

详解CSP封装的类型与工艺

汉思新材料:底部填充胶二次回炉的注意事项

锡膏在晶圆级封装中容易出现什么问题?从工艺到设备全解析

一文了解先进封装之倒装芯片技术
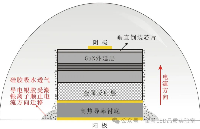
用硅胶封装、导电银胶粘贴的垂直倒装芯片易出现漏电现象

引线键合替代技术有哪些

倒装芯片键合技术的特点和实现过程

锡膏使用50问之(35-36):BGA 封装焊点空洞率超标、 倒装封装锡膏印刷偏移导致短路怎么解决?短路

LED 封装固晶全流程揭秘:锡膏如何撑起芯片“安家”的关键一步?

倒装 LED 芯片焊点总 “冒泡”?无铅锡膏空洞难题如此破!
