
资料下载

MOS器件的发展及各项技术的分析与介绍
随着集成电路工艺制程技术的不断发展,为了提高集成电路的集成度,同时提升器件的工作速度和降低它的功耗,MOS器件的特征尺寸不断缩小,MOS器件面临一系列的挑战。例如短沟道效应(Short Channel Effect - SCE),热载流子注入效应(Hot Carrier Inject - HCI)和栅氧化层漏电等问题。为了克服这些挑战,半导体业界不断开发出一系列的先进工艺技术,例如多晶硅栅、源漏离子注入自对准、LDD离子注入、polycide、Salicide、SRD、应变硅和HKMG技术。另外,晶体管也从MOSFET演变为FD-SOI、Bulk FinFET和SOI FinFET。
1.1铝栅MOS管
MOS诞生之初,栅极材料采用金属导体材料铝,因为铝具有非常低的电阻,它不会与氧化物发生反应,并且它的稳定性非常好。栅介质材料采用SiO2,因为SiO2可以与硅衬底形成非常理想的Si-SiO2界面。如图1.13(a)所示,是最初铝栅的MOS管结构图。
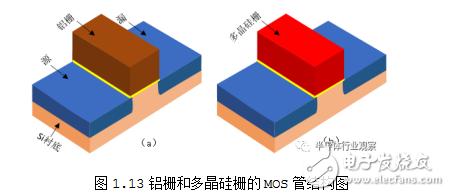
1.2多晶硅栅MOS管
随着MOS器件的特征尺寸不断缩小,铝栅与源漏扩散区的套刻不准问题变得越来越严重,源漏与栅重叠设计导致,源漏与栅之间的寄生电容越来越严重,半导体业界利用多晶硅栅代替铝栅。多晶硅栅具有三方面的优点:第一个优点是不但多晶硅与硅工艺兼容,而且多晶硅可以耐高温退火,高温退火是离子注入的要求;第二个优点是多晶硅栅是在源漏离子注入之前形成的,源漏离子注入时,多晶硅栅可以作为遮蔽层,所以离子只会注入多晶硅栅两侧,所以源漏扩散区与多晶硅栅是自对准的;第三个优点是可以通过掺杂N型和P型杂质来改变其功函数,从而调节器件的阈值电压。因为MOS器件的阈值电压由衬底材料和栅材料功函数的差异决定的,多晶硅很好地解决了CMOS技术中的NMOS和PMOS阈值电压的调节问题。如图1.13(b)所示,是多晶硅栅的MOS管结构图。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。 举报投诉
- 相关下载
- 相关文章





