
资料下载

IC测试原理与ATE测试向量的生成
集成电路测试(IC测试)主要的目的是将合格的芯片与不合格的芯片区分开,保证产品的质量与可靠性。随着集成电路的飞速发展,其规模越来越大,对电路的质量与可靠性要求进一步提高,集成电路的测试方法也变得越来越困难。因此,研究和发展IC测试,有着重要的意义。而测试向量作为IC测试中的重要部分,研究其生成方法也日渐重要。
1、IC测试
1.1、IC测试原理
IC测试是指依据被测器件(DUT)特点和功能,给DUT提供测试激励(X),通过测量DUT输出响应(Y)与期望输出做比较,从而判断DUT是否符合格。图1所示为IC测试的基本原理模型。
根据器件类型,IC测试可以分为数字电路测试、模拟电路测试和混合电路测试。数字电路测试是IC测试的基础,除少数纯模拟IC如运算放大器、电压比较器、模拟开关等之外,现代电子系统中使用的大部分IC都包含有数字信号。
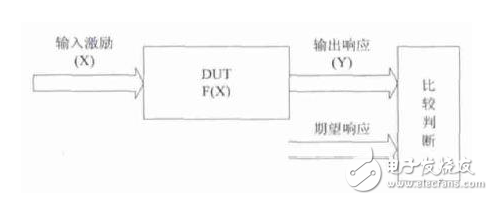
图1 IC测试基本原理模型
数字IC测试一般有直流测试、交流测试和功能测试。
1.2、功能测试
功能测试用于验证IC是否能完成设计所预期的工作或功能。功能测试是数字电路测试的根本,它模拟IC的实际工作状态,输入一系列有序或随机组合的测试图形,以电路规定的速率作用于被测器件,再在电路输出端检测输出信号是否与预期图形数据相符,以此判别电路功能是否正常。其关注的重点是图形产生的速率、边沿定时控制、输入/输出控制及屏蔽选择等。
功能测试分静态功能测试和动态功能测试。静态功能测试一般是按真值表的方法,发现固定型(Stuckat)故障。动态功能测试则以接近电路工作频率的速度进行测试,其目的是在接近或高于器件实际工作频率的情况下,验证器件的功能和性能。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。 举报投诉
- 相关下载
- 相关文章







