
资料下载

AlGaN和GaN界面陷阱对AlGaN与GaN及HEMT负阈值电压漂移的影响说明
本文报道了algan/gan高电子迁移率晶体管(hemt)在反向栅偏压作用下阈值电压的负漂移。该器件在强pinch-off和低漏源电压条件下偏置一定时间(反向栅极偏置应力),然后测量传输特性。施加反向栅极偏置应力后的负阈值电压漂移表明,与非应力条件相比,信道中存在更多的载流子。我们提出algan/gan界面态的存在是导致负阈值电压漂移的原因,并发展了一种对algan/gan界面态进行电学表征的方法。通过技术计算机辅助设计(tcad)atlas仿真验证了结果,并与实验测量结果吻合良好。
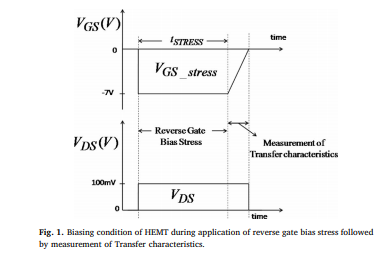
阱态对algan/gan hemt器件的性能有重要影响。类施主表面态被认为是algan/gan界面二维电子气形成的原因,即使没有有意掺杂[1,2],hemt结构中不同类型的陷阱也有许多缺点。射频色散、栅极滞后、漏极滞后、扭结效应是陷阱的一些不利影响[3-5],因此识别器件中陷阱的位置和类型及其对器件特性的影响非常重要。algan/gan hemt中的陷阱也会影响器件的阈值电压[6],阈值电压的稳定性对hemt器件的可靠性和安全性有着重要的影响[7],因此了解阈值电压的漂移和导致阈值电压漂移的陷阱是非常重要的。在mis-hemt中,绝缘体层和半导体的界面态是产生反向栅偏压后阈值电压漂移的原因[6–9],据我们所知,目前还没有关于algan/gan-hemt中反向栅偏压引起阈值电压负漂移及其关系的研究。algan/gan界面态。本文报道了在一定时间内施加反向栅偏压后,阈值电压向较高负电压变化的实验研究。这种阈值电压的负漂移被认为是由于反向栅偏压过程中电子从algan/gan界面态到沟道的去俘获引起的。提出了一种从测量的电特性中提取algan/gan界面态密度及其特征时间常数的简单方法。tcad-atlas模拟研究证实了这一假设,与实验结果吻合较好。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。 举报投诉
- 相关下载
- 相关文章





