
资料下载

晶圆表面形貌及台阶高度测量方法
晶圆在加工过程中的形貌及关键尺寸对器件的性能有着重要的影响,而形貌和关键尺寸测量如表面粗糙度、台阶高度、应力及线宽测量等就成为加工前后的步骤。以下总结了从宏观到微观的不同表面测量方法:单种测量手段往往都有着自身的局限性,实际是往往是多种测量方法配合使用。此外,除表面形貌和台阶测量外,在晶圆制程中需要进行其他测量如缺陷量测、电性量测和线宽量测。通过多种测量方式的配合,才能保证器件的良率和性能。
半导体晶圆表面形貌的测量可以直接反映晶圆的质量和性能。通过对晶圆表面形貌的测量,可以及时发现晶圆制造中的问题,比如晶圆的形貌和关键尺寸测量如表面粗糙度、台阶高度、应力及线宽测量等,这些因素都会直接影响晶圆制造和电子元器件的质量。以下是几种晶圆表面形貌及台阶高度的测量方法:
1、光学3D表面轮廓仪
SuperViewW系列光学3D表面轮廓仪以白光干涉扫描技术为基础研制而成,以光学非接触的扫描方式对样品表面微观形貌进行检测。其轮廓尺寸测量功能支持纳米级别的台阶高和微米级别的平面尺寸测量,包含角度、曲率等参数;可用于半导体减薄片、镀膜片晶圆IC的粗糙度、微观轮廓测量。


针对半导体领域大尺寸测量需求,SuperViewW3型号配备兼容型12英寸真空吸盘,一键测量大尺寸微观三维形貌。
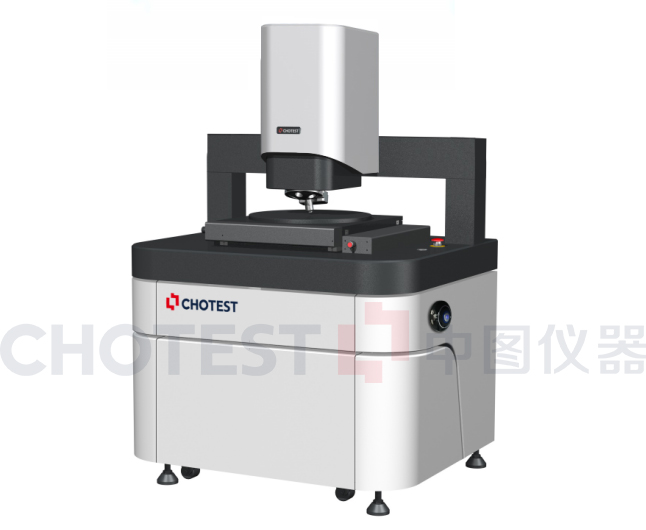
半导体领域专项功能
1.同步支持6、8、12英寸三种规格的晶圆片测量,并可一键实现三种规格的真空吸盘的自动切换以适配不同尺寸晶圆;
2.具备研磨工艺后减薄片的粗糙度自动测量功能,能够一键测量数十个小区域的粗糙度求取均值;
3.具备晶圆制造工艺中镀膜台阶高度的测量,覆盖从1nm~1mm的测量范围,实现高精度测量;
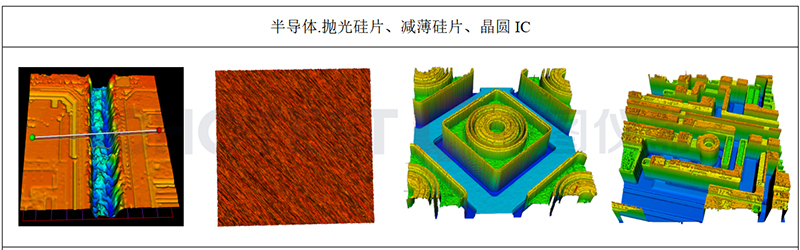
2、共聚焦显微镜
VT6000共聚焦显微镜以转盘共聚焦光学系统为基础,是以共聚焦技术为原理的光学3D表面形貌检测仪。不同的是,SuperViewW系列光学3D表面轮廓仪擅长亚纳米级超光滑表面的检测,追求检测数值的准确;VT6000共聚焦显微镜更擅长微纳级粗糙轮廓的检测,能够提供色彩斑斓的真彩图像便于观察。

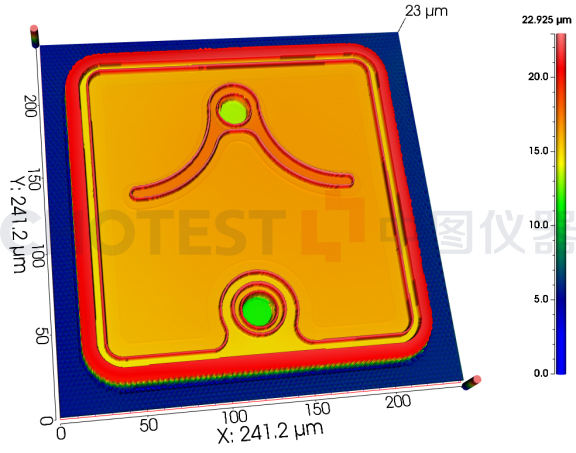
3、CP系列台阶仪
CP系列台阶仪是一款超精密接触式微观轮廓测量仪器。它采用了线性可变差动电容传感器LVDC,具备超微力调节的能力和亚埃级的分辨率,同时,其集成了超低噪声信号采集、超精细运动控制、标定算法等核心技术,使得仪器具备超高的测量精度和测量重复性。

在半导体晶圆制造过程中,能够测量样品表面的2D形状或翘曲:因多层沉积层结构中层间不匹配所产生的翘曲或形状变化,或者类似透镜在内的结构高度和曲率半径。

4、无图晶圆几何量测系统
WD4000无图晶圆几何量测系统采用高精度光谱共焦传感技术、光干涉双向扫描技术,完成非接触式扫描并建立3D Mapping图,实现晶圆厚度、TTV、LTV、Bow、Warp、TIR、SORI、等反应表面形貌的参数。
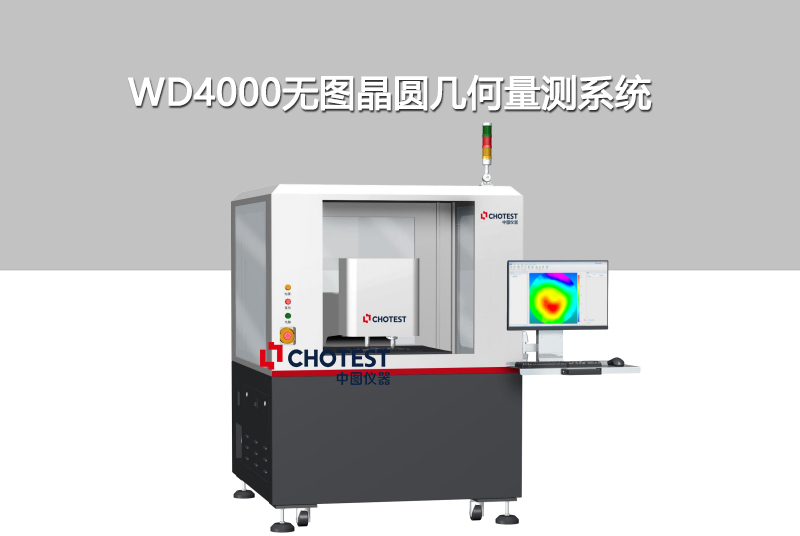
WD4000无图晶圆几何量测系统采用白光光谱共焦多传感器和白光干涉显微测量双向扫描技术,完成非接触式扫描并建立表面3D层析图像。通过非接触测量,将晶圆的三维形貌进行重建,强大的测量分析软件稳定计算晶圆厚度,TTV,BOW、WARP、在高效测量测同时有效防止晶圆产生划痕缺陷,实现Wafer厚度、翘曲度、平面度、线粗糙度、总体厚度变化(TTV)及分析反映表面质量的2D、3D参数。

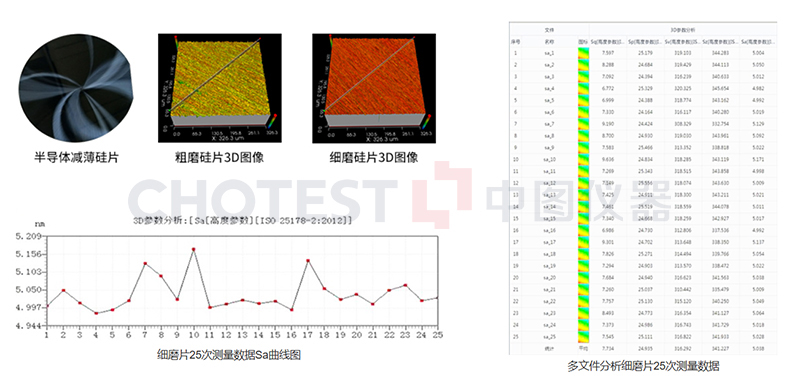
单种测量手段往往都有着自身的局限性,实际是往往是多种测量方法配合使用。除表面形貌和台阶测量外,在晶圆制程中需要进行其他测量如缺陷量测、电性量测和线宽量测。通过多种测量方式的配合,才能保证器件的良率和性能。
在半导体制造过程中,晶圆的制备和加工是一个复杂的过程,其中很多参数和条件都会对晶圆的表面形貌产生影响。通过合理运用专业检测设备对晶圆表面形貌进行测量,可以了解到这些参数和条件的变化对晶圆的影响程度,从而优化制造过程,提高晶圆制备的稳定性和一致性,减少晶圆的不良品率。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。 举报投诉
- 相关下载
- 相关文章






